Departamento de F´ısica
Programa de P´
os-Graduac
¸˜
ao em F´ısica
Efeito da Modula¸
c˜
ao da Topologia do
Confinamento em Sistemas Quase
Zero-Dimensionais Induzida por
Campo El´
etrico
Edson Rafael Cardozo de Oliveira
Orientador:
Prof. Dr. Marcio Daldin Teodoro
Co-orientador:
Dr. Jos´e Benito Al´en Mill´an
EFEITO DA MODULAC
¸ ˜
AO DA TOPOLOGIA DO
CONFINAMENTO EM SISTEMAS QUASE
ZERO-DIMENSIONAIS INDUZIDA POR CAMPO
EL´
ETRICO
Disserta¸c˜ao de Mestrado apresentada ao Programa de P´os-Gradua¸c˜ao em F´ısica da Universidade Federal de S˜ao Carlos como re-quisito parcial para obten¸c˜ao do t´ıtulo de Mestre.
Orientador: Prof. Dr. Marcio Daldin Teodoro
Co-orientador: Dr. Jos´e Benito Al´en Mill´an
S˜ao Carlos - SP
Ficha catalográfica elaborada pelo DePT da Biblioteca Comunitária da UFSCar
O48em
Oliveira, Edson Rafael Cardozo de.
Efeito da modulação da topologia do confinamento em sistemas quase zero-dimensionais induzida por campo elétrico / Edson Rafael Cardozo de Oliveira. -- São Carlos : UFSCar, 2015.
99 f.
Dissertação (Mestrado) -- Universidade Federal de São Carlos, 2015.
1. Física da matéria condensada. 2. Aharonov-Bohm, Teoria de. 3. Pontos quânticos. 4. InAs/GaAsSb. I. Título.
em frente de qualquer maneira.”
Resumo
Programa de P´os-Gradua¸c˜ao em F´ısica - Departamento de F´ısica
Efeito da Modula¸c˜ao da Topologia do Confinamento em Sistemas Quase
Zero-Dimensionais Induzida por Campo El´etrico
por Edson Rafael Cardozo de Oliveira
Pontos quˆanticos crescidos por t´ecnicas epitaxiais para estudos ´opticos e de transporte
s˜ao comumente cobertos com uma camada do mesmo material sobre o qual os pontos
fo-ram crescidos. Recentemente diversos estudos tˆem demonstrado como os parˆametros de
crescimento e materiais utilizados nesta camada afetam significativamente as propriedades
morfol´ogicas, ´opticas e el´etricas destas nanoestruturas. Neste trabalho s˜ao estudados pontos
quˆanticos tradicionais de Arseneto de ´Indio cobertos com uma camada de Arseneto de G´alio
e Antimˆonio. Ap´os o crescimento foi realizado um tratamento t´ermico r´apido que melhorou
significativamente a distribui¸c˜ao de tamanhos dos pontos, com um aumento na eficiˆencia
´optica e uma indu¸c˜ao na estrutura de bandas do Tipo-I para Tipo-II. As investiga¸c˜oes
por magnetofotoluminescˆencia revelaram que os efeitos da topologia de confinamento na
estrutura de bandas deste sistema quase zero-dimensional s˜ao fortemente modulados pela
aplica¸c˜ao de um campo el´etrico externo paralelo `a orienta¸c˜ao do campo magn´etico. Efeitos
de car´ater puramente quˆantico como a interferˆencia Aharonov-Bohm e a invers˜ao do fator-g
de Land´e excitˆonico foram observados a baixas temperaturas e para valores espec´ıficos de
campo el´etrico, demonstrando assim que a escolha do material e condi¸c˜oes de deposi¸c˜ao da
camada de cobertura de pontos quˆanticos levam a efeitos e resultados controlados
experimen-talmente que n˜ao poderiam ser observados utilizando m´etodos convencionais de crescimento
de pontos quˆanticos semicondutores.
Modulation Effect on Confinement Topology in Quasi Zero-Dimensional
Systems Induced by Electric Field
by Edson Rafael Cardozo de Oliveira
Quantum dots grown by epitaxial techniques for optical and transport studies are
usu-ally capped by a layer of the same material on which the QDs were grown. Recently, several
studies have shown how the growth parameters and materials used in this layer significantly
affect the morphological, optical and electrical properties of these nanostructures. In this
work Indium Arsenide quantum dots capped with a layer of Gallium Arsenide and Antimony
are studied. After the growth, a rapid thermal annealing was performed, which improved
significantly the size distribution of the quantum dots, increasing the optical efficiency, and
inducing a change in the band structure from a Type-I to Type-II. The investigations
perfor-med by magnetophotoluminescence have shown that the effects of the topology confinement
on the band structure of these quasi zero-dimensional systems are strongly modulated by
an external electric field applied parallel to the magnetic field orientation. Purely
quan-tum effects such as Aharonov-Bohm interference and the inversion of the excitonic Land´e
g-factor were observed at low temperatures and for specific values of electric fields, showing
that the choice of the material and growth conditions of quantum dots capping layer leads
to controlled experimental results which could not be achieved using conventional growth
methods of semiconductor quantum dots.
Ao Prof. Dr. Marcio Daldin Teodoro pela orienta¸c˜ao justa e objetiva, pelas oportu-nidades, pela amizade, pelos preciosos ensinamentos, sem os quais este trabalho n˜ao seria poss´ıvel, pela paciˆencia e apoio em todos os momentos, pela confian¸ca depositada em mim e, finalmente, pelo entusiasmo e motiva¸c˜ao.
Ao Dr. Jos´e Benito Al´en Mill´an pela co-orienta¸c˜ao, por ter me acolhido no Instituto de Microeletrˆonica de Madrid (IMM) onde tive a oportunidade de conhecer novos labo-rat´orios e expandir meus conhecimentos, pela paciˆencia, e pelas valiosas discuss˜oes sempre construtivas.
Ao Prof. Dr. Victor L´opez-Richard pelas discuss˜oes que certamente contribu´ıram para a realiza¸c˜ao deste trabalho, e pela disposi¸c˜ao em esclarecer minhas d´uvidas. Ao Prof. Dr. Gilmar Eugenio Marques pelo suporte fornecido, pelo apoio, aux´ılio no trabalho e disposi¸c˜ao. Tamb´em ao Dr. Jos´e M. Llorens pela colabora¸c˜ao com os c´alculos te´oricos e pelas discuss˜oes pertinentes ao trabalho.
Ao Prof. Dr. Pedro Pablo Gonz´alez Borrero pela inicia¸c˜ao `a pesquisa cient´ıfica que faz com tanto comprometimento e respeito, pelos ensinamentos que carrego comigo por toda minha caminhada, e tamb´em pelo incentivo e amizade. E a todos os professores que, de alguma forma, contribu´ıram com conhecimentos valiosos e imensa dedica¸c˜ao para eu estar aqui hoje.
`
A minha m˜ae Maria Ioni Cardozo pela vida, pelo carinho, incentivo, dedica¸c˜ao e pelos ensinamentos de car´ater e respeito ao pr´oximo que fizeram a pessoa que sou hoje.
`
A minha namorada Camila Galar¸ca pelo apoio imensur´avel, carinho e confian¸ca em todos os momentos, dos mais felizes aos mais dif´ıceis, e que certamente foi fundamental para eu estar aqui hoje.
Aos meus amigos de longa data pelo apoio, pelos momentos de alegria e descontra¸c˜ao e que sei que sempre posso contar. E aos colegas que fiz nesta jornada cient´ıfica pela amizade e importantes discuss˜oes.
Ao CNPq pela bolsa e apoio financeiro do projeto n➸471191/2013-2; e `a FAPESP pelo apoio financeiro dos processos n➸ 2013/187192-1 e n➸ 2014-07375-2.
A todos vocˆes que de alguma maneira tiveram algo a acrescentar em minha vida, um sincero muito obrigado!
Resumo iii
Abstract iv
Agradecimentos v
Sum´ario vi
Lista de Figuras viii
Siglas e Abreviaturas xii
1 Introdu¸c˜ao 13
2 Fundamentos Te´oricos 18
2.1 Propriedades Estruturais e Eletrˆonicas dos Semicondutores . . . 18
2.2 Heteroestruturas Semicondutoras . . . 22
2.3 Pontos Quˆanticos e sua Forma¸c˜ao . . . 24
2.4 Propriedades ´Opticas dos Semicondutores . . . 25
2.4.1 Espectros de Energia . . . 26
2.4.2 Efeitos da Temperatura . . . 31
2.4.3 Efeitos de Campo magn´etico . . . 33
2.4.4 Polariza¸c˜ao . . . 35
2.5 Pontos Quˆanticos de InAs cobertos com GaAsSb . . . 37
3 Efeito Aharonov-Bohm 45 3.1 Descri¸c˜ao do Efeito Aharonov-Bohm . . . 45
3.2 Efeito Aharonov-Bohm em Semicondutores . . . 47
4 T´ecnicas Experimentais 56 4.1 T´ecnica de Crescimento . . . 56
4.1.1 Epitaxia por Feixe Molecular . . . 56
4.1.2 Prepara¸c˜ao das Amostras . . . 58
4.2 Montagem do Laborat´orio . . . 59
4.2.1 Instala¸c˜ao de Equipamentos . . . 59
4.2.2 Alinhamento ´Optico . . . 60
4.3 A t´ecnica de Fotoluminescˆencia . . . 62
4.3.1 Fotoluminescˆencia em Fun¸c˜ao da Temperatura . . . 64
4.3.2 Fotoluminescˆencia em Fun¸c˜ao da Potˆencia de Excita¸c˜ao . . . 65
4.4 Magnetofotoluminescˆencia . . . 65
5 Estudos Pr´evios da Amostra de Pontos Quˆanticos de GaAs/InAs/GaAsSb 70 6 Resultados e Discuss˜ao 77 6.1 Efeitos de Potˆencia de Excita¸c˜ao e Temperatura . . . 77
6.2 Efeitos de Campos El´etrico e Magn´etico . . . 81
2.1 Distribui¸c˜ao espacial dos ´atomos em uma estrutura cristalina de blenda de zinco, caracter´ıstica de semicondutores III-V. [1] . . . 19 2.2 Primeira zona de Brillouin da rede CFC. Pontos de alta simetria est˜ao
de-notados por Γ, X e L, enquanto que as linhas de alta simetria, ligando estes pontos, est˜ao rotuladas por Λ e ∆. [1] . . . 20 2.3 Estrutura de bandas dos portadores de carga no espa¸co dos momentos para
(a) GaAs e (b) InAs. [3] . . . 21 2.4 Estrutura de bandas do GaSb. [4] . . . 21 2.5 Transi¸c˜oes ´opticas permitidas entre a banda de condu¸c˜ao e valˆencia
conside-rando os spins dos portadores de carga e suas respectivas regras de sele¸c˜ao. [5] 22 2.6 (a) Ordem de crescimento de uma heteroestrutura semicondutora.(b) Perfil de
potencial de um po¸co quˆantico formado por dois materiais semicondutores de gaps de energia diferentes. Se a larguraLW da camada de InAs ´e da ordem do
comprimento de onda de de Broglie dos portadores, n´ıveis discretos de energia s˜ao formados. As energias ∆Ec e ∆Ev s˜ao os band offsets da heteroestrutura. 23
2.7 Alinhamento de bandas (a) Tipo-I, e (b) Tipo-II. . . 24 2.8 Perfil de um po¸co de potencial com largura LW e barreiras infinitas. [10] . . 28
2.9 Potencial do oscilador harmˆonico unidimensional com frequˆencia de oscila¸c˜ao ω e energias En = (n+
1
2)~ω e suas correspondentes autofun¸c˜oes. [13] . . . . 31 2.10 Polariza¸c˜ao linear da luz. O vetor E~ ´e a resultante da soma das componentes
Ex e Ey. [30] . . . 36
2.11 Polariza¸c˜ao circular da luz (a) `a direita, e (b) `a esquerda. A amplitude do vetor E~ ´e uma constante, e a diferen¸ca de fase deπ/2 entre as componentes Ex e Ey resulta no rotacionamento da dire¸c˜ao do vetor E~. [30] . . . 37
2.12 Efeito de curvatura das bandas em uma estrutura de bandas Tipo-II sob baixa (linhas s´olidas) e alta (linha pontilhada) densidade de potˆencia de excita¸c˜ao. [41] 39
3.1 Principais resultados de alguns trabalhos importantes envolvendo o Efeito Aharonov-Bohm em semicondutores. Para todas as figuras o que est´a repre-sentado s˜ao parˆametros envolvendo o pico de energia de fotoluminescˆencia, ou a ´area sob a curva desses espectros em fun¸c˜ao do campo magn´etico. (a) Es-pectro de µPL e (b) Posi¸c˜ao do pico para an´eis quˆanticos de InGaAs; [7] (c) Posi¸c˜ao do pico e (d) Energia do buraco para QDs Tipo-II de InP/-GaAs; [8] (e) Posi¸c˜ao do pico e (f) Intensidade integrada para QDs Tipo-II de ZnTe/ZnSe; [9] e (g) Intensidade integrada para an´eis quˆanticos Tipo-I de InAs. [10] . . . 48
3.2 (a) Imagem de microscopia eletrˆonica de transmiss˜ao da amostra h´ıbrida (QDs e QRs) de multicamadas. Os espectros de PL para as componentes σ+ e σ− est˜ao representadas em (b) a 0 T, e em (c) a 21 T. A intensidade integrada para cada uma das componentes da luz polarizada s˜ao mostradas em (d) para os an´eis quˆanticos, e em (e) para os pontos quˆanticos. A ´area sombreada em (e) indica o campo magn´etico cr´ıtico para a transi¸c˜ao de Tipo-I para Tipo-II induzida pelo campo magn´etico. [12] . . . 53
4.1 Ilustra¸c˜ao esquem´atica da t´ecnica de epitaxia por feixe molecular. [4] O subs-trato ´e colocado dentro da cˆamara de crescimento atrav´es de um m´odulo de transferˆencia. Os elementos a serem depositados s˜ao evaporados em c´elulas de efus˜ao direcionadas ao substrato. A dinˆamica de crescimento ´e monito-rada in situ pela t´ecnica de difra¸c˜ao de el´etrons de alta energia por reflex˜ao (RHEED, do inglˆes Reflection High Energy Electron Diffraction). [5, 6] . . . 57 4.2 (a) Representa¸c˜ao das camadas da heteroestrutura semicondutora, formando
a amostra Sb-RTA com jun¸c˜ao tipo p-i-n. (b) Imagem real da amostra de QDs de InAs cobertos com GaAsSb e com contatos el´etricos. . . 58 4.3 Configura¸c˜ao experimental do alinhamento ´optico para a t´ecnica da
fotolu-minescˆencia. . . 61 4.4 Representa¸c˜ao esquem´atica de uma estrutura de bandas de energia no espa¸co
dos momentos. [8] . . . 63 4.5 Espectro de emiss˜ao fotoluminescente de QDs Tipo-II de InAs/GaAsSb. No
gr´afico est˜ao destacadas a posi¸c˜ao do pico, largura de linha, e intensidade integrada. . . 64 4.6 Representa¸c˜ao esquem´atica do microsc´opio confocal e sistema criogˆenico com
campo magn´etico. . . 66
5.1 (a) Espectro de fotoluminescˆencia das amostras Sb, Sb-RTA, Ref, e Ref-RTA. Os espectros de linha cheia referem-se `as amostras sem tratamento t´ermico, e os de linha pontilhada `as amostras com tratamento t´ermico. (b) Medida de TRPL para as amostras Ref, Sb e Sb-RTA. No inset s˜ao apresentados os tempos de vida extra´ıdos do ajuste das curvas de decaimento. [1] . . . 71 5.2 Imagens de Microscopia eletrˆonica de transmiss˜ao obtidas das amostras (a)
Sb e (b) Sb-RTA. (c) Distribui¸c˜ao de altura dos pontos quˆanticos medida para as duas amostras. [1] . . . 73 5.3 (a) Energia da transi¸c˜ao do estado fundamental em fun¸c˜ao da concentra¸c˜ao de
G´alio dentro do ponto quˆantico. Osinsets mostram a densidade de probabili-dade do estado fundamental dos buracos no plano (1-10) para as amostras Sb e Sb-RTA. As Figuras (b) e (c) mostram a estrutura de bandas para as amos-tras Sb e Sb-RTA, respectivamente. As linhas pretas cont´ınuas representam os perfis de potencial atrav´es do centro do QD, e as linhas azuis pontilhadas referem-se ao perfil de potencial atrav´es de seu m´ınimo, onde o m´aximo da densidade de probabilidade da fun¸c˜ao de onda do buraco est´a localizada. [1] 74
6.2 Shift da energia do f´oton em fun¸c˜ao da ra´ız c´ubica da potˆencia de excita¸c˜ao do laser, onde o ponto inicial de 0 meV equivale a 1,055 meV. Nota-se um comportamento linear na regi˜ao verde, relacionado a alinhamento de bandas Tipo-II, com uma tendˆencia de satura¸c˜ao no regime de altas intensidades de excita¸c˜ao, caracter´ıstica de QDs Tipo-I. . . 78 6.3 Perfil de potencial para as bandas de energia para (a) baixa e (b) alta potˆencia
de excita¸c˜ao. . . 79 6.4 Evolu¸c˜ao dos espectros de PL em fun¸c˜ao da temperatura. . . 80 6.5 (a) Energia do pico em fun¸c˜ao da temperatura, e (b) Intensidade integrada
em fun¸c˜ao do inverso da temperatura, onde ´e tamb´em apresentada a energia de ativa¸c˜ao E1, determinada pela equa¸c˜ao de Arrhenius. . . 81 6.6 Espectro de PL sem campos aplicados. Os dados experimentais est˜ao
indica-dos pelos quadraindica-dos pretos, e o ajuste do espectro ´e dado pela linha vermelha, que ´e formado pela soma de dois ajustes gaussianos, um referente ao estado fundamental (pico de menor energia) e outro ao primeiro estado excitado (pico de maior energia), ambos descritos pela linha verde. . . 82 6.7 (a) Espectros de fotoluminescˆencia a T = 4 K, para diferentes valores do
campo el´etrico aplicado, entre os valores de voltagem de -3 V e 1,35 V. (b) Posi¸c˜ao do pico (em vermelho) e Intensidade Integrada (em azul) em fun¸c˜ao da voltagem aplicada, e o inset representa a largura de linha. . . 83 6.8 Distribui¸c˜ao da fun¸c˜ao de onda do par el´etron-buraco em QDs Tipo-II de
InAs/GaAsSb para diferentes valores de campo el´etrico vertical aplicado. As setas `a direita indicam a dire¸c˜ao do campo el´etrico. . . 85 6.9 Valores esperados para a separa¸c˜ao dos portadores, tanto vertical (<ze−h >)
quanto planar (< ρe−h >). . . 86
6.10 Espectros fotoluminescentes a 0 T (em preto) e as componentes σ+ (em ver-melho) e σ− (em azul) a 9 T, a 0 V. . . 88
6.11 Intensidade integrada em fun¸c˜ao do campo magn´etico externo para as volta-gens aplicadas de (a) -3 V, (b) -2 V, (c) -1 V, (d) 0 V, (e) 1 V, e (f) 1,35 V. Pontos vermelhos representam polariza¸c˜ao circular `a direita σ+, e pontos pretos, `a esquerda σ−. . . 89
6.12 Valor m´edio da intensidade integrada (Iσ+ + Iσ−)/2 em fun¸c˜ao do campo magn´etico externo para (a) -3 V, (b) -2 V, (c) -1 V, (d) 0 V, (e) 1 V, e (f) 1,35 V. . . 89 6.13 C´alculo da energia de confinamento dos el´etrons dentro dos QDs de InAs
e dos buracos na camada de GaAsSb em fun¸c˜ao do campo magn´etico para (a) -4,5 V, (b) -3 V, (c) 0 V, e (d) 2 V. Os gr´aficos superiores referem-se `as energias dos el´etrons, e os inferiores, `as energias dos buracos. Setas vermelhas representam a componente σ−, azuis, σ+, do estado fundamental
e primeiro estado excitado, e as pretas indicam o anti-cruzamento entre o estado fundamental e primeiro estado excitado da componenteσ−. . . 91
BC Banda de Condu¸c˜ao
BV Banda de Valˆencia
CFC C´ubica de Face Centrada
EAB Efeito Aharonov-Bohm
ETR Expans˜ao T´ermica daRede
HH Buraco Pesado (do inglˆes, Heavy Hole) IEF Intera¸c˜aoEl´etron-Fˆonon
IMM Instituto deMicroeletrˆonica de Madrid
LEDs Diodos Emissores de Luz (do inglˆes, Light Emitting Diodes) LH Buraco Leve (do inglˆes,Light Hole)
MBE Epitaxia por Feixe Molecular (do inglˆes, Molecular Beam Epitaxy) MET Microscopia Eletrˆonica deTransmiss˜ao
ML Monocamada (do inglˆes, MonoLayer)
PL Fotoluminescˆencia (do inglˆes, PhotoLuminescence) PMT Fotomultiplicadora (do inglˆes, PhotoMultiplier Tube)
QCSE Efeito Stark de Confinamento Quˆantico (do inglˆes,Quantum-Confined
Stark Effect)
QDs Pontos Quˆanticos (do inglˆes,Quantum Dots) QWs Po¸cos Quˆanticos (do inglˆes, Quantum Wells)
RTA Tratamento T´ermico R´apido (do inglˆes, Rapid Thermal Annealing) SRL Camada Redutora de Tens˜ao (do inglˆes, Strain Reducing Layer) TRPL Fotoluminescˆencia Resolvida no Tempo (do inglˆes,Time Resolved
PhotoLuminescence)
Introdu¸c˜
ao
Atualmente quase todas as pessoas j´a tiveram, em parte, algum contato, ao menos
indi-reto, com a Mecˆanica Quˆantica. Esta afirma¸c˜ao pode ser estabelecida gra¸cas `a descoberta de
materiais Semicondutores feita em 1874 por Karl Ferdinand Braun, que resultou na inven¸c˜ao
do diodo e tamb´em no desenvolvimento do r´adio, entre outros. [1] Logo desencadeou-se um
intenso estudo de suas propriedades por muitos anos, levando a um grande avan¸co tecnol´ogico
com a inven¸c˜ao do primeiro transistor semicondutor em 1947 por William Shockley, John
Bardeen e Walter Brattain, que ´e a componente chave para a fabrica¸c˜ao de
processado-res eletrˆonicos, e portanto, de computadoprocessado-res. Nos dias de hoje, com a miniaturiza¸c˜ao de
componentes, para a ordem de nanˆometros (1 / 1 000 000 000 m), toda a eletrˆonica
mo-derna utilizada para a fabrica¸c˜ao de celulares, computadores, e uma infinidade de outros
equipamentos, cont´em dispositivos semicondutores em seu interior, como mem´orias, lasers,
sensores, LEDs, armazenagem de dados com discos de estado s´olido formado por
semicon-dutores, etc. [2]
Basicamente, semicondutores s˜ao materiais que tornam-se prop´ıcios a conduzir
eletri-cidade quando sofrem algum tipo de excita¸c˜ao, por exemplo ´optica. Os el´etrons em um
semicondutor precisam de uma energia equivalente ao chamado gap do material para
se-rem excitados da banda de valˆencia para a banda de condu¸c˜ao. Os el´etrons excitados para
a banda de condu¸c˜ao deixam uma lacuna na banda de valˆencia, chamada de buraco com
mesma carga por´em sinal contr´ario ao do el´etron.
Apesar da posi¸c˜ao dos semicondutores j´a estar bem estabelecida na ind´ustria eletrˆonica,
tendo o sil´ıcio como a principal mat´eria prima, a comunidade cient´ıfica continua realizando
estudos com novos materiais, descobrindo novas propriedades e desenvolvendo novas t´ecnicas
de produ¸c˜ao, como a moderna e elegante epitaxia por feixe molecular (MBE, do inglˆes
Mole-cular Beam Epitaxy), portanto, esta ´e uma ´area da ciˆencia que est´a em constante renova¸c˜ao.
A t´ecnica da MBE permite crescer semicondutores com a precis˜ao de uma monocamada
atˆomica por vez, que abre espa¸co para a produ¸c˜ao de dispositivos com precis˜ao nanom´etrica
al´em de permitir a intercala¸c˜ao de diferentes materiais, formando heteroestruturas. Com as
devidas condi¸c˜oes de crescimento ´e poss´ıvel produzir heteroestruturas com uma camada de
material com gap de energia menor entre duas camadas de outro material com gap maior,
formando um perfil de potencial em forma de po¸co. Dependendo da largura das camadas,
surgem efeitos quˆanticos adicionais, com a forma¸c˜ao de n´ıveis discretos de energia e o
confi-namento dos portadores de carga dentro dos po¸cos. Estas estruturas s˜ao denominadas Po¸cos
Quˆanticos.
Tamb´em ´e poss´ıvel crescer estruturas em formato de Fios Quˆanticos ou Pontos
Quˆanti-cos (QDs, do inglˆes Quantum Dots), com o confinamento em duas ou trˆes dire¸c˜oes,
respec-tivamente. As camadas que cobrem estas nanoestruturas recentemente atra´ıram grande
interesse da comunidade cient´ıfica, uma vez que abrem a possibilidade para controlar com
grande precis˜ao propriedades importantes, al´em de modificar a topologia das estruturas. [3–
5] De fato, ao cobrir pontos quˆanticos muitos processos est˜ao envolvidos entre as camadas
adjacentes, como redu¸c˜ao de tens˜ao, cisalhamento, difus˜ao, mistura, etc., que podem
modi-ficar fortemente sua morfologia e composi¸c˜ao. [6] Por exemplo, ao cobrir um ponto quˆantico
at´e uma espessura menor que a altura dos pontos, h´a uma transi¸c˜ao de pontos para uma
estrutura com geometria anelar, com propriedades distintas. [7]
A cobertura de pontos quˆanticos com materiais diferentes do substrato resulta em
he-teroestruturas com perfis de potencial assim´etricos e que, dependendo das condi¸c˜oes em que
foram crescidas, el´etrons e buracos confinados dentro do ponto quˆantico separam-se
espaci-almente formando um alinhamento de bandas Tipo-II, com um dos portadores localizado na
regi˜ao da camada de cobertura, ao redor do ponto quˆantico. [8,9] Esta configura¸c˜ao tamb´em
apresenta uma geometria anelar, devido `a possibilidade de um dos portadores orbitar em
volta do ponto com a aplica¸c˜ao de um campo magn´etico externo perpendicular ao plano do
QD. Nesta dire¸c˜ao, uma estrutura de particular interesse ´e a de pontos quˆanticos de Arseneto
e tratados t´ermicamente, que resulta na otimiza¸c˜ao de suas propriedades ´opticas, al´em de
apresentar uma estrutura Tipo-II, com o el´etron confinado dentro do ponto e o buraco em
sua ´orbita, na camada de cobertura. [5] A aplica¸c˜ao de um campo el´etrico perpendicular
ao plano dos pontos quˆanticos pode governar a posi¸c˜ao vertical dos buracos na camada de
GaAsSb, desde o topo dos QDs at´e sua base, que afeta diretamente na correla¸c˜ao do par
el´etron-buraco.
O controle da localiza¸c˜ao vertical do buraco e a geometria anelar do sistema formam um
ambiente favor´avel para a observa¸c˜ao de fenˆomenos de interferˆencia quˆantica com modula¸c˜ao
da topologia dos pontos que dependem fortemente da correla¸c˜ao do par el´etron-buraco, como
por exemplo o Efeito Aharonov-Bohm (EAB), que mostra que a fase da fun¸c˜ao de onda de
sistemas quˆanticos em um caminho fechado, quando submetidos a um campo magn´etico
perpendicular `a sua trajet´oria, oscila com per´ıodo igual a um parˆametro denominado fluxo
magn´etico quˆantico. [7, 10, 11] O EAB ´e um efeito de grande interesse uma vez que
des-creve o comportamento de um parˆametro quˆantico que n˜ao ´e um observ´avel. [11] Como j´a
foi comprovado a Mecˆanica Quˆantica ´e extremamente importante para o desenvolvimento
tecnol´ogico, portanto, al´em de estudos de fenˆomenos provenientes desta ´area, tanto te´oricos
quanto experimentais, surge a necessidade de controlar sistematicamente seus efeitos para
que exista a possibilidade de contribui¸c˜ao substancial no avan¸co da ciˆencia e da tecnologia.
O objetivo deste trabalho ent˜ao, com base nesta discuss˜ao sobre a importˆancia da
aplica¸c˜ao de efeitos quˆanticos no desenvolvimento tecnol´ogico e da necessidade de
desen-volver t´ecnicas para o controle sistem´atico de propriedades de interesse, ´e investigar as
os-cila¸c˜oes Aharonov-Bohm em pontos quˆanticos de InAs cobertos com GaAsSb com o controle
da correla¸c˜ao entre o el´etron e o buraco induzida por campo el´etrico, assim como estudar
a relevˆancia da topologia de confinamento na resposta ´optica dos efeitos quˆanticos destes
sistemas.
Esta disserta¸c˜ao de mestrado est´a organizada da seguinte maneira: no Cap´ıtulo2 s˜ao
apresentados os fundamentos te´oricos dos semicondutores, desde a estrutura cristalina at´e
as propriedades ´opticas e efeitos de parˆametros externos, e com uma revis˜ao bibliogr´afica da
amostra estudada neste trabalho; na sequˆencia, o Cap´ıtulo 3 trata da descri¸c˜ao do Efeito
Aharonov-Bohm e da apresenta¸c˜ao dos principais trabalhos sobre o efeito em
utilizadas neste trabalho; o Cap´ıtulo 5 ´e dedicado `a uma revis˜ao detalhada da amostra e
apresenta¸c˜ao de alguns estudos pr´evios sobre a mesma, a fim de justificar a escolha do
ma-terial estudado; no Cap´ıtulo 6 s˜ao mostrados ent˜ao os principais resultados deste trabalho
com suas devidas discuss˜oes e; por fim, no Cap´ıtulo 7 s˜ao feitas as considera¸c˜oes finais do
[1] L. Lukasiak and A. Jakubowski. J. Telecommunications and Information Technology,
page 3, 2010.
[2] R. C. Shellard and Chaves A. Pensando o Futuro. O desenvolvimento da f´ısica e sua
inser¸c˜ao na vida social e econˆomica do pa´ıs. Ed. Sociedade Brasileira de F´ısica, 2005.
[3] J. M. Ulloa, R. Gargallo-Caballero, M. Bozkurt, M. Del Moral, A. Guzm´an, P. M.
Koenraad, and A. Hierro. Phys. Rev. B,81:165305, 2010.
[4] J. M. Ulloa, J. M. Llorens, M. del Moral, M. Bozkurt, P. M. Koenraad, and A. Hierro.
J. Appl. Phys., 112:074311, 2012.
[5] J. M. Ulloa, J. M. Llorens, B. Al´en, D. F. Reyes, D. L. Sales, D. Gonz´alez, and A. Hierro.
Appl. Phys. Lett.,101:253112, 2012.
[6] G. Costantini, A. Rastelli, C. Manzano, P. Acosta-Diaz, R. Songmuang, G. Katsaros,
O. G. Schmidt, and K. Kern. Phys. Rev. Lett., 96:226106, 2006.
[7] M´arcio Daldin Teodoro. Efeito Aharonov-Bohm em Part´ıculas Neutras. Doutorado,
Universidade Federal de S˜ao Carlos, 2011.
[8] K. Akahane, N. Yamamoto, and N. Ohtani. Physica E: Low-Dimensional Systems and
Nanostructures, 21:295, 2004.
[9] Y. D. Jang, T. J. Badcock, D. J. Mowbray, M. S. Skolnick, J. Park, D. Lee, H. Y. Liu,
M. J. Steer, and M. Hopkinson. Appl. Phys. Lett.,92:20, 2008.
[10] Y. Aharonov and D. Bohm. Phys. Rev.,115:485, 1959.
[11] A. O. Govorov, S. E. Ulloa, K. Karrai, and R. J. Warburton. Phys. Rev. B,66:081309,
2002.
Fundamentos Te´
oricos
Este cap´ıtulo inicial ´e dedicado `a explora¸c˜ao dos princ´ıpios f´ısicos de materiais
se-micondutores, tais como estrutura de banda e eletrˆonica, recombina¸c˜ao ´optica e efeito do
campo magn´etico e da temperatura, e uma revis˜ao geral sobre os materiais utilizados neste
trabalho.
2.1
Propriedades Estruturais e Eletrˆ
onicas dos
Semi-condutores
Dispositivos semicondutores de alta performance s˜ao em geral baseados em materiais
cristalinos, que s˜ao caracterizados por repeti¸c˜oes peri´odicas de um ´atomo ou um conjunto
de ´atomos nas trˆes dire¸c˜oes espaciais. Materiais semicondutores das fam´ılias III-V da tabela
peri´odica, como Arseneto de G´alio (GaAs) ou Arseneto de ´Indio (InAs), cristalizam-se na
estrutura de banda conhecida como blenda de zinco, que ´e formada por duas redes c´ubicas
de face centrada (CFC) deslocadas em um quarto entre si ao longo da diagonal principal do
cubo. Na Figura2.1 est´a representada a c´elula convencional desta estrutura, com uma base
formada por dois ´atomos, um localizado na origem (0,0,0) e outro em (a/4,a/4,a/4), onde
a ´e o parˆametro de rede da c´elula unit´aria. [1]
Conhecer o parˆametro de rede dos materiais semicondutores ´e essencial para o controle
do crescimento epitaxial de heteroestruturas, que possibilita a explora¸c˜ao de propriedades
importantes dependentes da espessura dos materiais. A t´ecnica de crescimento de epitaxia
Figura 2.1: Distribui¸c˜ao espacial dos ´atomos em uma estrutura cristalina de blenda de zinco, caracter´ıstica de semicondutores III-V. [1]
por feixe molecular, que ser´a detalhada no Cap´ıtulo4, permite a deposi¸c˜ao precisa e
contro-lada de uma ´unica monocamada (ML, do inglˆes monolayer) de ´atomos por vez. Uma ML
´e determinada como a metade do parˆametro de rede da c´elula unit´aria, onde, na dire¸c˜ao
de crescimento [100] do GaAs, ´e composta por uma camada de g´alio mais uma camada de
arsˆenio. Para o GaAs e o InAs os valores dos parˆametros de rede das c´elulas convencionais
s˜ao 5,653 e 6,058 ˚A, respectivamente, uma diferen¸ca de aproximadamente 7% entre eles. [2]
A ML, portanto, equivale a 2,83 ˚A para o GaAs e 3,04 ˚A para o InAs.
A rede rec´ıproca da rede c´ubica de face centrada ´e uma rede c´ubica de corpo centrado,
e sua primeira zona de Brillouin ´e representada por um octaedro truncado. Na Figura 2.2
est´a representada esta zona de Brillouin, al´em dos pontos de alta simetria nela contidos,
identificados por nota¸c˜oes espec´ıficas, como vales Γ, X eL.
Em um material semicondutor uma das principais caracter´ısticas ´e sua estrutura de
bandas, oriunda dos n´ıveis atˆomicos discretos, separados em bandas permitidas e proibidas
de energia quando ´atomos isolados aproximam-se para formar um cristal. As bandas de
energia podem ser calculadas a partir da zona de Brillouin em cada uma das dire¸c˜oes dos
pontos de alta simetria. No equil´ıbrio, os el´etrons menos ligados aos s´olidos cristalinos
preenchem completamente a chamada banda de valˆencia (BV), e quando sofrem algum tipo
de excita¸c˜ao s˜ao promovidos para a banda de condu¸c˜ao (BC), deixando uma lacuna na BV,
tamb´em chamada de buraco, com mesma carga e sinal contr´ario ao do el´etron. A diferen¸ca
de energia entre o m´ınimo da BC (de momento angular orbital L = 0) e o m´aximo da BV
(L = 1) representa o gap de energia dos portadores de carga, indicando a energia m´ınima
Figura 2.2: Primeira zona de Brillouin da rede CFC. Pontos de alta simetria est˜ao denotados por Γ, X e L, enquanto que as linhas de alta simetria, ligando estes pontos,
est˜ao rotuladas por Λ e ∆. [1]
ser considerado como a impress˜ao digital dos materiais semicondutores, metais e isolantes.
Cada material possui um valor espec´ıfico em dependˆencia dos elementos que o comp˜oem,
suas concentra¸c˜oes e condi¸c˜oes externas, como temperatura por exemplo.
As Figuras2.3 (a) e (b) mostram a estrutura de bandas do GaAs e InAs,
respectiva-mente. [3] A curvatura das bandas de energia determina a massa efetiva dos portadores, que
´e definida nos pontos de alta simetria por 1 m∗ =
1 ~
d2E(~k)
d~k2 . Na Figura ´e poss´ıvel observar dois ramos no topo da banda de valˆencia degenerados no ponto Γ, por´em com curvaturas
diferentes, indicando dois tipos de buracos com massas distintas, sendo os de maior massa
efetiva denominados de buracos pesados (HH, do inglˆes Heavy Holes), e os de menor massa
efetiva chamados buracos leves (LH, do inglˆes Light Holes). A transi¸c˜ao fundamental para
semicondutores III-V ´e de gap direto, pois o topo da BV e o fundo da BC localizam-se no
mesmo ponto.
Ogap de energia para o GaAs, a uma temperatura de 2 K, ´eEgΓ = 1,519 eV, enquanto
que para o InAs o valor ´eEgΓ = 0,417 eV. [2] Materiais com gaps de energia distintos, com as devidas propriedades estruturais, s˜ao importantes para o crescimento de
heteroestrutu-ras, abrindo espa¸co para a constru¸c˜ao de dispositivos com controle mais preciso em suas
propriedades, e um estudo completo de fenˆomenos quˆanticos.
Figura 2.3: Estrutura de bandas dos portadores de carga no espa¸co dos momentos para (a) GaAs e (b) InAs. [3]
alternˆancia entre ´atomos de arsˆenio e de antimˆonio, por constitu´ırem a mesma fam´ılia na
ta-bela peri´odica, e portanto, esta liga tern´aria ´e muitas vezes representada como GaAs1−xSbx,
onde x ´e a concentra¸c˜ao de Sb. A Figura 2.4 mostra a estrutura de bandas do GaSb, em
que o gap de energia a temperatura ambiente ´e Eg = 0,726 eV. [4]
Figura 2.4: Estrutura de bandas do GaSb. [4]
A estrutura de bandas do GaAsSb ´e uma intermedia¸c˜ao entre a estrutura do GaAs
temperatura ambiente pode ser calculado por: [4]
Eg = 1,42−1,9x+ 1,2x2, para 0< x <0,3. (2.1)
De maneira geral, levando em considera¸c˜ao o spin, S = 1/2, os estados contidos nas
bandas de condu¸c˜ao e de valˆencia apresentam trˆes multipletos com momento angular total,
J = L+S. Na banda de condu¸c˜ao h´a um dupleto com J = 1/2, MJ =±1/2, e na banda
de valˆencia um multipleto com J = 3/2, MJ = ±3/2,±1/2 e J = 1/2, MJ = ±1/2, como
ilustrado na Figura 2.5. Na ausˆencia de acoplamento spin-´orbita, as seis bandas de valˆencia
s˜ao degeneradas no ponto Γ (~k = 0). A inclus˜ao do acoplamento spin-´orbita levanta a
dege-nerescˆencia dos n´ıveis e originam o quadrupleto simetria Γ8 e J = 3/2, e o dupleto simetria Γ7 e J = 1/2. [1] El´etrons, quando excitados para a banda de condu¸c˜ao, tendem a retornar
para o estado de menor energia, na banda de valˆencia, atrav´es da emiss˜ao de um f´oton. Na
Figura2.5 tamb´em s˜ao apresentadas as regras de sele¸c˜ao para as poss´ıveis transi¸c˜oes ´opticas
fundamentais △J = 1, MJ = ±1, que representam as polariza¸c˜oes circulares da luz σ
±
, e
ser˜ao discutidas nas pr´oximas se¸c˜oes.
Figura 2.5: Transi¸c˜oes ´opticas permitidas entre a banda de condu¸c˜ao e valˆencia consi-derando os spins dos portadores de carga e suas respectivas regras de sele¸c˜ao. [5]
2.2
Heteroestruturas Semicondutoras
Heteroestruturas semicondutoras s˜ao caracterizadas pelo crescimento de camadas
transi¸c˜ao dos materiais s˜ao diferentes, h´a forma¸c˜ao de perfis de potencial dependentes do
gap de energia e da espessura das camadas semicondutoras.
A Figura 2.6(a) ilustra um exemplo onde foi crescida uma camada de um material
de gap de energia menor (por exemplo InAs) entre duas camadas de outro com gap maior
(GaAs), formando um perfil de potencial em formato de po¸co devido `a descontinuidade
dos gaps, como mostra a Figura 2.6(b). Efeitos de confinamento quˆantico na dire¸c˜ao de
crescimento da amostra aparecem quando a espessura da camada do meio for da ordem do
comprimento de onda de de Broglie com o surgimento de n´ıveis discretos.
Figura 2.6: (a) Ordem de crescimento de uma heteroestrutura semicondutora.(b) Perfil de potencial de um po¸co quˆantico formado por dois materiais semicondutores degaps de energia diferentes. Se a largura LW da camada de InAs ´e da ordem do comprimento de
onda de de Broglie dos portadores, n´ıveis discretos de energia s˜ao formados. As energias ∆Ec e ∆Ev s˜ao osband offsets da heteroestrutura.
Dependendo da forma de crescimento das heteroestruturas ´e poss´ıvel restringir o
mo-vimento livre dos el´etrons e buracos a bidimensional (2D), unidimensional (1D) e
zero-dimensional (0D), caso as dimens˜oes do confinamento sejam compar´aveis ao comprimento
de onda de de Broglie dos portadores em uma, duas ou trˆes dimens˜oes, respectivamente.
Heteroestruturas semicondutoras com potenciais de confinamento em uma dire¸c˜ao, como o
o movimento a uma dimens˜ao obt´em-se os chamados fios quˆanticos, e, restringindo a
ne-nhuma dimens˜ao, s˜ao obtidas as estruturas denominadas pontos quˆanticos (QDs, do inglˆes
Quantum Dots).
Al´em das dimens˜oes de confinamento dos portadores, ´e poss´ıvel crescer
heteroestru-turas com diferentes alinhamentos das bandas de condu¸c˜ao e de valˆencia, resultando em
diferentes localiza¸c˜oes dos el´etrons e buracos. Na Figura 2.7 est˜ao ilustrados os dois grupos
de alinhamentos, que s˜ao de Tipo-I e Tipo-II. No alinhamento de bandas Tipo-I ambos os
portadores s˜ao confinados no mesmo material, ou seja, na mesma regi˜ao espacial. No caso
do Tipo-II, um dos portadores ´e confinado na regi˜ao do po¸co, enquanto o portador de carga
oposta localiza-se na regi˜ao da barreira.
Figura 2.7: Alinhamento de bandas (a) Tipo-I, e (b) Tipo-II.
2.3
Pontos Quˆ
anticos e sua Forma¸c˜
ao
Pontos quˆanticos, ou QDs, s˜ao estruturas nanom´etricas tridimensionais caracterizadas
por ilhas de material semicondutor sobre uma matriz bidimensional, e confinam el´etrons e
buracos nas trˆes dire¸c˜oes, formando assim, n´ıveis discretos de energia nas trˆes dire¸c˜oes
es-paciais. [6] Em virtude desta natureza de confinamento quantizado similar a de um ´atomo,
QDs s˜ao tamb´em chamados de “´atomos artificiais”, e o estudo desta estrutura est´a
al-tamente difundido na comunidade cient´ıfica devido `as diversas propriedades relacionadas
justamente ao confinamento tridimensional, al´em de aplica¸c˜oes tecnol´ogicas, incluindo
crip-tografia quˆantica, computa¸c˜ao quˆantica, ´optica e opto-eletrˆonica. [7]
Atualmente pontos quˆanticos s˜ao desenvolvidos de diversas formas, como
de interface, e crescimento epitaxial, ou seja, camada por camada. Esta ´ultima ganha
des-taque por permitir o controle preciso do tamanho, forma e composi¸c˜ao dos pontos crescidos
epitaxialmente, [6, 7] e entre as heteroestruturas formadas por esta t´ecnica, est˜ao os
pon-tos quˆanticos de InAs crescidos sobre uma matriz de GaAs (InAs/GaAs), que s˜ao um dos
sistemas de QDs mais estudados atualmente.
Existem trˆes modos de crescimento epitaxial quando os parˆametros de rede dos
materi-ais s˜ao diferentes: Volmer-Weber, Frank-van der Merve, e Stranski-Krastanow. No primeiro
caso a deposi¸c˜ao de ´atomos forma ilhas na superf´ıcie do substrato, at´e que elas juntam-se
en-tre si para formar uma monocamada; no segundo, o crescimento ocorre camada por camada.
Agora, no terceiro modo, h´a a forma¸c˜ao de uma monocamada sobre a qual s˜ao formadas as
ilhas, ou seja, ´e um caso intermedi´ario entre o primeiro e o segundo. Este ´ultimo ´e o modo
em que pontos de InAs/GaAs s˜ao auto-organizados.
No m´etodo Stranski-Krastanow para crescimento de pontos de InAs/GaAs, valores
espec´ıficos da espessura de InAs s˜ao essenciais para que seja vi´avel a forma¸c˜ao dos QDs,
que geralmente varia entre 1,7 e 2,2 ML. Neste processo ´e iniciado o crescimento de uma
camada bidimensional de InAs chamada de wetting layer, at´e atingir uma espessura limite
onde inicia-se a organiza¸c˜ao das ilhas. O processo de forma¸c˜ao dos pontos quˆanticos por
meio do crescimento epitaxial se deve pelo descasamento do parˆametro de rede das ligas
envolvidas no processo. A tens˜ao (strain) gerada na superf´ıcie entre as ligas devido a este
descasamento provoca uma reorganiza¸c˜ao estrutural dos materiais na tentativa de combinar
localmente as redes de GaAs e InAs, a fim de minimizar a energia do sistema, dando origem
a ilhas tridimensionais comstrain minimizado. [6] Para que exista confinamento quˆantico as
ilhas s˜ao ent˜ao cobertas por uma espessa camada de GaAs ou outro material degap maior
que InAs, formando assim o perfil tridimensional energ´etico dos pontos quˆanticos.
2.4
Propriedades ´
Opticas dos Semicondutores
O principal modo de caracteriza¸c˜ao ´optica de materiais semicondutores ´e feito atrav´es
do estudo de sua luminescˆencia emitida quando s˜ao submetidos a algum tipo de excita¸c˜ao,
geralmente ´optica. Materiais semicondutores do tipobulk, ou seja, uma matriz formada por
correspondente ao gap, entretanto, heteroestruturas com potenciais de confinamento tˆem os
n´ıveis quantizados e as emiss˜oes ´opticas s˜ao diferentes dos materiais que a constituem. `A
vista disso faz-se necess´ario um estudo mais detalhado dos n´ıveis de energia de
heteroestru-turas semicondutoras.
2.4.1
Espectros de Energia
O potencial de confinamento das heteroestruturas leva `a forma¸c˜ao de n´ıveis de energia
discretos tanto para el´etrons como para buracos. Analisando primeiramente o caso do po¸co
quˆantico, no qual os portadores de carga est˜ao confinados na dire¸c˜ao de crescimento da
heteroestrutura (considera-se aqui a dire¸c˜ao z), e movem-se livremente no plano
perpendi-cular `a dire¸c˜ao de crescimento (plano x-y), a fun¸c˜ao de onda e os estados quantizados dos
portadores nas bandas de condu¸c˜ao e valˆencia podem ser calculados atrav´es da equa¸c˜ao de
Schr¨odinger independente do tempo: [1]
− ~ 2 2m∗∇
2+V(x, y, z)
Ψ(x, y, z) = EΨ(x, y, z), (2.2)
onde Ψ(x, y, z) ´e a fun¸c˜ao de onda dos portadores, ~´e a constante de Planck divido por 2π,
m∗
´e a massa efetiva dos portadores em suas respectivas bandas, e V(x, y, z) ´e o potencial
de confinamento. A fun¸c˜ao de onda Ψ(x, y, z) ´e separada em dois termos, um referente ao
movimento livre (ψ(x, y)) e outro ao movimento quantizado (ϕ(z)), e, portanto, pode ser
escrita como:
Ψ(x, y, z) =ψ(x, y)ϕ(z). (2.3)
Analisando primeiramente a parte referente ao movimento livre, leva-se em considera¸c˜ao que
o potencial de confinamento (V(x, y)) ´e nulo. Assim, uma solu¸c˜ao poss´ıvel para a equa¸c˜ao
de Schr¨odinger ´e dada por ondas planas:
ψ(x, y) = Aexpi(~k·~r)
ondeA´e uma constante de normaliza¸c˜ao, e~k´e um vetor de onda representando as dimens˜oes
da primeira zona de Brillouin do material no plano x-y. A energia correspondente a este
movimento ´e justamente a energia cin´etica:
E(~k) = ~ 2~k2
2m∗. (2.5)
Agora, na dire¸c˜ao de confinamento (z) considera-se um potencial com barreira infinita,
em que a largura do po¸co quˆantico ´e LW. Ent˜ao o potencial pode ser escrito como:
U(z) =
0 para 0< z < LW
∞ para z ≤0 ou z ≥LW
(2.6)
A equa¸c˜ao de Schr¨odinger independente do tempo, unidimensional, para a regi˜ao do po¸co,
onde U(z) = 0, ´e ent˜ao escrita na forma:
− ~ 2 2m∗
d2ϕ(z)
dz2 =Eϕ(z). (2.7)
Como a barreira ´e infinita pode-se aplicar, na eq.(2.7), a condi¸c˜ao de contorno em que ϕ= 0
nas interfaces, com isso, a solu¸c˜ao ´e da forma:
ϕn(z) =
r
2 LW
sen(knz),para n=1, 2, 3,..., (2.8)
onde n ´e o n´umero quˆantico principal que determina os n´ıveis de energia na dire¸c˜ao z, e
kn =
nπ LW
. ´E interessante notar que se n ´e ´ımpar, a autofun¸c˜ao com respeito a z no centro
do po¸co ´e par, e vice-versa. Propriedades de simetrias como esta s˜ao importantes para as
regras de sele¸c˜ao, em casos como para a absor¸c˜ao ´optica, por exemplo. [8]
A energia referente ao n-´esimo n´ıvel ´e dada por: [9]
En=
~2k2n 2m∗ =
~2n2π2 2m∗
L2
W
(2.9)
Etotal(n, ~k) = ~ 2n2π2 2m∗
L2
W
+~ 2(k2
x+k2y)
2m∗ (2.10)
Nesta equa¸c˜ao ´e poss´ıvel simplificar o segundo termo do lado direito, considerando
que emiss˜oes fotoluminescentes de semicondutores degap direto ocorrem apenas parak = 0.
Portanto as energias dos estados quantizados s˜ao inversamente proporcionais `a massa efetiva
e ao quadrado da largura do po¸co, e n˜ao dependem do vetor de onda. As fun¸c˜oes de onda
dos trˆes primeiros n´ıveis s˜ao mostradas na Figura2.8. O estado com n´umero quˆanticon = 1
´e chamado de estado fundamental e os demais, estados excitados.
Figura 2.8: Perfil de um po¸co de potencial com largura LW e barreiras infinitas. [10]
Ainda existe outro elemento a ser levado em considera¸c˜ao quando se estuda os n´ıveis
de energia em heteroestruturas semicondutoras: a intera¸c˜ao coulombiana entre o el´etron
e o buraco. Esta intera¸c˜ao leva `a forma¸c˜ao de novas excita¸c˜oes no cristal, chamadas de
´excitons. [10] O car´ater de cargas opostas dos portadores leva a uma atra¸c˜ao eletrost´atica
m´utua, formando o chamado par el´etron-buraco, que aumenta a probabilidade de que uma
transi¸c˜ao ´optica ocorra. O ´exciton pode ser considerado como um sistema hidrogen´oide em
um meio com uma constante diel´etricaεe descrito pelo modelo de Bohr. A energia potencial
do sistema ´e dada por:
V(r) =− 1 4πε0
e2
εr, (2.11)
onde r ´e a distˆancia m´edia que separa as cargas. A massa do sistema el´etron-buraco ´e
descrita em termos da massa reduzida:
µ= m
∗
em
∗
h
m∗
e+m
∗
h
onde m∗
e em
∗
h s˜ao as massas efetivas dos el´etrons e buracos, respectivamente. Resolvendo a
eq. de Schr¨odinger com o potencial e a massa definidos acima, encontra-se que a energia de
liga¸c˜ao (Eexc) e o raio do ´exciton (an) s˜ao dados por:
Eexc=−
1 n2
µ 2~2
e4
ε2 (2.13)
e
an=n2
ε~2
e2µ (2.14)
Ao ocorrer a recombina¸c˜ao do ´exciton em um material bulk, um f´oton ´e emitido com
energia:
hν =Egbulk−Eexc, (2.15)
onde Egbulk ´e o gap de energia do material e Eexc´e a energia de liga¸c˜ao do ´exciton. [11]
Tratando-se de nanoestruturas quˆanticas, o ´exciton sofre o efeito do confinamento com
a redu¸c˜ao do seu raio de Bohr, levando a um aumento na energia de liga¸c˜ao em rela¸c˜ao ao
material volum´etrico. Nestas estruturas a emiss˜ao fotoluminescente concernente `a
recom-bina¸c˜ao excitˆonica ´e dada por:
hν =Eg+En+Ehm+Eexc (2.16)
hν=Eg+
~2n2π2 2m∗
eL2W
+ ~ 2m2π2 2m∗
hL2W
− n122µ~2e 4 ε2,
ondeEn´e a energia do n-´esimo n´ıvel de confinamento do el´etron,Ehms˜ao os m-´esimos n´ıveis
de energia do buraco (pesado ou leve), e Eexc´e a energia de liga¸c˜ao do ´exciton formado pelo
el´etron e buraco pesado HH ou leve LH. Para baixas intensidades de excita¸c˜ao e baixas
temperaturas, s´o s˜ao poss´ıveis transi¸c˜oes envolvendo o primeiro n´ıvel de el´etron e o primeiro
n´ıvel de buraco pesado, desde que n˜ao haja energia t´ermica suficiente para excitar o n´ıvel
de buraco leve. Eventuais buracos que ocupem o n´ıvel de LH relaxam n˜ao radiativamente
(processos envolvendo emiss˜ao de fˆonons) para o n´ıvel de buraco pesado e ent˜ao ocorre a
recombina¸c˜ao el´etron-buraco pesado.
De maneira an´aloga ao confinamento unidimensional de po¸cos quˆanticos, ´e poss´ıvel
na eq. (2.2) o novo potencial de confinamento ´e da forma V(x, y, z) =Vx(x) +Vy(y) +Vz(z),
e os autovalores da energia s˜ao dados porE =Ex+Ey+Ez. A fun¸c˜ao de onda para el´etrons
ou buracos tamb´em ´e reescrita levando em considera¸c˜ao o confinamento tridimensional, [12]
ou seja, Ψ(x, y, z) = ϕ(x)·ϕ(y)·ϕ(z). Um modelo real´ıstico de um potencial de QDs leva
em considera¸c˜ao efeitos de composi¸c˜ao e strain na estrutura de bandas dos pontos, assim ´e
necess´ario um modelo complicado. Entretanto, muito da F´ısica de pontos quˆanticos pode ser
compreendida ao utilizar o potencial de um oscilador harmˆonico como modelo de potencial
dos QDs, dado por: [13]
VQD =
1 2m
∗
(ωx2x2+ωy2y2+ωz2z2), (2.17)
onde m∗
´e a massa efetiva do el´etron ou buraco, e ωx, ωy e ωz s˜ao as correspondentes
frequˆencias do oscilador no plano x-y, e na dire¸c˜ao de crescimento z. Resolvendo a equa¸c˜ao
de Schr¨odinger com este potencial, encontra-se que as autoenergias Ei e suas respectivas
fun¸c˜oes de onda s˜ao:
Ei =
nx+
1 2
~ωx+
ny+
1 2
~ωy +
nz+
1 2
~ωz, (2.18)
Ψi(~r) = ϕnxx(x)ϕyny(y)ϕnzz(z), (2.19)
onde i ´e um ´ındice contendo os n´umeros quˆanticos nx = 0,1,2..., ny = 0,1,2..., e nz =
0,1,2...,~r´e o vetor das coordenadas espaciais, e
ϕnα
α (α) =
m∗ ωα ~π 14 1 √
2nαn
α!
exp
−21~m∗
ωαα2
Hnα α √ m∗ ωα ~ , (2.20)
Hnα(ξ) = (−1)
nαexp(ξ2) d
nα
dξnαexp(−ξ
2), (2.21)
onde α=x, y, ouz, eHnα(ξ) s˜ao os polinˆomios de Hermite de ordem nα. [13]
Um potencial harmˆonico unidimensional com frequˆencia de oscila¸c˜aoω e suas
corres-pondentes autoenergias e fun¸c˜oes de onda s˜ao mostrados na Figura 2.9. As energias s˜ao
equidistantes com separa¸c˜ao ~ω. Pontos quˆanticos geralmente tˆem uma altura (z) muito
menor comparada `a sua t´ıpica extens˜ao lateral (plano x−y). Assim, a energia de
Figura 2.9: Potencial do oscilador harmˆonico unidimensional com frequˆencia de oscila¸c˜ao
ω e energiasEn= (n+
1
2)~ω e suas correspondentes autofun¸c˜oes. [13]
Lα para o estado fundamental (n = 0) s˜ao dadas por:
Lα =
r
2~ m∗
ωα
. (2.22)
Quanto menor Lα, maiores ser˜ao as frequˆencias de oscila¸c˜ao e tamb´em as energias de
confi-namento associadas.
2.4.2
Efeitos da Temperatura
Em materiais semicondutores excitados opticamente, os estudos te´oricos s˜ao
desenvol-vidos a baixas temperaturas, pr´oximas de 0 K. Com o aumento da temperatura trˆes
prin-cipais fenˆomenos geralmente ocorrem em seu espectro de emiss˜ao: transi¸c˜oes excitˆonicas
apresentam deslocamentos para menores energias, h´a um aumento na largura de linha e
uma redu¸c˜ao na intensidade de emiss˜ao. A varia¸c˜ao do gap de energia e/ou da energia de
liga¸c˜ao excitˆonica em fun¸c˜ao da temperatura ocorre devido `a contribui¸c˜ao de dois principais
mecanismos: a intera¸c˜ao el´etron-fˆonon (IEF) e a expans˜ao t´ermica da rede (ETR). [14–17]
Em materiais e heteroestruturas semicondutoras os efeitos de temperatura nas transi¸c˜oes
´opticas s˜ao geralmente descritos por modelos emp´ıricos como o proposto por Varshni [18], e
semi-emp´ıricos como os de Vi˜na e P¨assler. [19, 20]
O modelo de Varshni ´e descrito pela equa¸c˜ao:
Eg(T) =Eg(0)−αvar
T2
ondeEg(T) ´e ogap de energia, T ´e a temperatura eαvar eβ s˜ao parˆametros para ajuste dos
dados experimentais. Outro modelo mais recente, proposto por Vi˜na, faz uso de um modelo
semi-emp´ırico fundamentado na distribui¸c˜ao estat´ıstica de Bose-Einstein, e ´e descrito por:
Eg(T) =EB−aB
1 + 2
exp(ΘB/T)−1
, (2.24)
onde aB representa a intensidade da intera¸c˜ao el´etron-fˆonon, ΘB ≡~w/kB ´e a temperatura
caracter´ıstica que representa a energia m´edia dos fˆonons na escala de temperatura eEg(0) =
EB−aB ´e a energia dogap aT = 0 K. [19,21,22] O mais recente dos modelos, de P¨assler,
apresenta um car´ater mais anal´ıtico:
Eg(T) = Eg(0)−
αTΘ
2 " p s 1 + 2T Θ p# , (2.25)
onde αT ≡ −(dE(T)/dT)T→∞ ´e o valor a altas temperaturas no limite da entropia do gap
de energia, [20,23] ep´e um parˆametro emp´ırico relacionado `a forma das fun¸c˜oes espectrais
da intera¸c˜ao el´etron-fˆonon. [20, 24]
Um comportamento t´ıpico de Eg(T) observado na literatura para a grande maioria
dos materiais semicondutores ´e de uma evolu¸c˜ao n˜ao-linear (geralmente quadr´atica) para
baixas temperaturas (T < 40K) e linear para altas temperaturas (T > 100K). Enquanto
os modelos de Varshni e Vi˜na apresentam trˆes parˆametros para ajustar as curvas
experi-mentais, o modelo de P¨assler leva em considera¸c˜ao quatro. Estudos comparativos entre os
trˆes modelos indicam que este ´ultimo ´e o que melhor ajusta curvas experimentais de Eg(T)
para materiais semicondutores a baixas temperaturas, pois o modelo de Varshni subestima
os dados experimentais e o de Vi˜na os superestima, agora o modelo de P¨assler ajusta os
dados experimentais com mais precis˜ao. [25] A altas temperaturas os trˆes modelos ajustam
bem os dados.
O principal efeito do aumento da temperatura sobre heteroestruturas semicondutoras ´e
a quebra do estado ligado, chamada tamb´em de energia de ativa¸c˜ao t´ermica, e pode ser
clas-sificada de acordo com diferentes regimes de temperatura. Em pontos quˆanticos no regime
de baixas temperaturas (T < 40K), a energia de ativa¸c˜ao representa a energia necess´aria
para excitar os portadores presos em estados localizados nawetting layer devido a flutua¸c˜oes
na intensidade de emiss˜ao. Al´em disso h´a um efeito de diminui¸c˜ao do gap de energia do
material, e nesta configura¸c˜ao a energia ainda n˜ao ´e suficiente para provocar a dissocia¸c˜ao
excitˆonica. No regime intermedi´ario a energia t´ermica ´e suficiente para dissociar os ´excitons,
que escapam dos QDs e podem migrar para a wetting layer novamente, e eventualmente
se-rem capturados por pontos maiores com energias de confinamento menores. O resultado
neste regime depende da distribui¸c˜ao de tamanho dos pontos, e seu efeito ´e mais
acentu-ado em rela¸c˜ao ao regime anterior. A dissocia¸c˜ao excitˆonica provocada pelo aumento da
temperatura abre espa¸co para transi¸c˜oes n˜ao-radiativas, representadas pelo relaxamento dos
portadores atrav´es da emiss˜ao de fˆonons. Estas transi¸c˜oes refletem diretamente na redu¸c˜ao
na intensidade de emiss˜ao luminescente (I). As energias de ativa¸c˜ao podem ser calculadas
a partir de uma equa¸c˜ao do tipo Arrhenius:
I(T) = I0
1 +A1exp
−Ea1
KBT
+A2exp
−Ea2
KBT
, (2.26)
ondeI0representa a intensidade de emiss˜ao aT = 0K,Ea1 eEa2 s˜ao as energias de ativa¸c˜ao t´ermicas relacionadas aos diferentes regimes de temperatura, e A1 e A2 s˜ao os coeficientes
pr´e-exponenciais, que tˆem rela¸c˜ao com a taxa de recombina¸c˜ao dos portadores.
2.4.3
Efeitos de Campo magn´
etico
Em F´ısica cl´assica uma corrente I~ em uma trajet´oria fechada de ´area S~ tem um
mo-mento magn´etico dado por~µ=I~×S~. [26] Na presen¸ca de um campo magn´etico externoB~ o
momento magn´etico pode acoplar-se paralela ou anti-paralelamente `a dire¸c˜ao deB~ a fim de
minimizar a energia magn´etica do sistema. Na aproxima¸c˜ao quˆantica, um el´etron orbitando
em um cristal acopla-se com o campo magn´etico atrav´es de seu momento angular orbital.
O movimento orbital do el´etron resulta em um comportamento tipicamente diamagn´etico.
Al´em do mais, o spin do el´etron ´e o seu momento magn´etico intr´ınseco, e tamb´em acopla-se
ao campo externo resultando na separa¸c˜ao Zeeman entre o spinup e o spin down. [13] Estes
O movimento dos portadores de carga, em uma heteroestrutura semicondutora, sob
efeito de campo magn´etico externo ´e descrito de maneira simplificada pelo Hamiltoniano:
H = 1
2m∗(~p−q ~A)
2+V, (2.27)
onde ~p ´e o operador momento, q ´e a carga el´etrica, A~ ´e o potencial vetor correspondente
ao campo magn´etico B~ descrito por B~ = ∇ ×~ A~, e V ´e o potencial de confinamento.
A solu¸c˜ao para os n´ıveis de energia para portadores confinados no potencial de oscilador
harmˆonico na prescen¸ca de um campo magn´etico (na dire¸c˜ao z) ´e dada pela equa¸c˜ao de
Fock-Darwin: [27, 28]
El,mz,n= (2l+ 1 +|mz|)~ r
ωc
2
2
+ω2
x,y+
mz
2 ~ωc+
n+ 1 2
~ωz, (2.28)
onde ωc =
qB
m∗ ´e a frequˆencia ciclotrˆonica, l ´e o n´umero quˆantico do momento angular,
mz ´e sua proje¸c˜ao ao longo do eixo z e n representa a quantiza¸c˜ao no potencial do
os-cilador harmˆonico na dire¸c˜ao z. Analisando o caso para o estado fundamental E0,0,0 = ~
r ωc
2
2
+ω2
x,y +
1
2~ωz, em geral, para B pequeno tem-se ωc < ωx,y. Expandido essa equa¸c˜ao em s´erie de Taylor, tem-se:
E0,0,0 =~ωx,y+
~ω2
c
4ωx,y
+1
2~ωz. (2.29)
Desta equa¸c˜ao percebe-se que a contribui¸c˜ao do campo magn´etico nos n´ıveis de energia ´e
um confinamento adicional no plano, resultando em um acr´escimo na energia do estado
fundamental proporcional a ωc2 ∼ B2. Esta dependˆencia quadr´atica do campo magn´etico ´e conhecida como o deslocamento diamagn´etico. Combinando a eq. (2.22) com esta ´ultima, a
energia do estado fundamental em fun¸c˜ao de B pode ser escrita como:
E0,0,0(B) =E0 +
e2B2L2
x,y
8m∗ =E0+αdB
2, (2.30)
onde E0 ´e a energia do estado fundamental comB = 0 T eαd ´e o coeficiente diamagn´etico,
que ´e proporcional a L 2
x,y
m∗ . Assim, QDs com dimens˜oes laterais Lx,y ter˜ao maior acr´escimo
At´e agora foi considerado o acoplamento do campo magn´etico ao movimento orbital
dos portadores de carga. Por´em, os portadores tamb´em possuem um spin~s, resultando em
um momento magn´etico adicional que acopla-se comB~. Este acoplamento ´e conhecido como
intera¸c˜ao Zeeman. O momento magn´etico µ~s de uma part´ıcula carregada livre tem rela¸c˜ao
com o spin da forma: [29]
~
µs=g0( q
2m~s), (2.31)
ondeg0 ´e o fator g de Land´e. Para um el´etron livreg0 = +2,0023. [29] O Hamiltoniano que relaciona o acoplamento do spin com o campo magn´etico para o el´etron livre ´e dado por:
HZeeman=µ~s·B~ =g0µB~s·B,~ (2.32)
onde µB=
e
2m = 0,0579 meV/T ´e o magneton de Bohr.
Para este Hamiltoniano foram considerados apenas el´etrons livres. Entretanto, para
el´etrons em uma estrutura semicondutora o fator g ´e substitu´ıdo por um fator g efetivo ge
levando em considera¸c˜ao a estrutura de bandas. A separa¸c˜ao Zeeman (do inglˆes, Zeeman
splitting) da energia referente ao spin s=±1/2 evolui linearmente com B e ´e dada por:
∆EZeeman =geµBB. (2.33)
2.4.4
Polariza¸c˜
ao
Um modo simples para compreender a propaga¸c˜ao da luz ´e por meio do conceito
de propaga¸c˜ao de ondas planas. Em uma onda plana as dire¸c˜oes dos campos el´etrico e
magn´etico s˜ao sempre perpendiculares `a sua dire¸c˜ao de propaga¸c˜ao. A polariza¸c˜ao da luz
´e definida pela orienta¸c˜ao do vetor campo el´etrico no plano, que pode ser decomposto em
duas componentes, chamados por conven¸c˜ao de Ex e Ey, como mostra a Figura 2.10.
As duas componentes ortogonais consideradas acima podem ser representadas como:
~
Ex(z, t) = ˆiE0xcos(kz−ωt) (2.34)
~
Ey(z, t) = ˆjE0ycos(kz−ωt+γ)
Figura 2.10: Polariza¸c˜ao linear da luz. O vetorE~´e a resultante da soma das componentes Ex eEy. [30]
a oscila¸c˜ao das componentes Ex e Ey est´a em fase (γ = 0) ou defasada em um m´ultiplo
inteiro de 2π, e a amplitude de cada onda ´e a mesma, o vetor resultante da soma das duas
componentes oscilar´a em uma ´unica dire¸c˜ao, portanto, a luz ´e dita linearmente polarizada.
Se a diferen¸ca de fase relativa ´e π, a onda resultante ser´a tamb´em linearmente polarizada,
por´em, com plano de oscila¸c˜ao invertido.
Outro caso de interesse surge quando as amplitudes das ondas s˜ao iguais (E0x=E0y =
E0), e a diferen¸ca de fase ´eγ =π/2 +m
′
2π, ondem′
= 0,±1,±2, .... Isto resulta em:
~
Ex(z, t) = ˆiE0xcos(kz−ωt) (2.35)
~
Ey(z, t) = ˆjE0ysen(kz−ωt)
e a onda resultante ´e igual a:
~
E =E0[ˆicos(kz−ωt) + ˆjsen(kz−ωt)] (2.36)
Portanto, a amplitude da onda resultante E~ ser´a uma constante ((E~ ·E~)12 = E
0), com a dire¸c˜ao do vetor rotacionando no sentido hor´ario, e neste caso, a luz ´e dita circularmente
polarizada `a direita, e est´a representada na Figura2.11(a). No caso em queγ =−π/2−m′
a dire¸c˜ao de rota¸c˜ao do vetor ser´a anti-hor´ario, e a luz ´e circularmente polarizada `a esquerda
(Figura 2.11(b)). Para os demais casos em que a amplitude das componentes s˜ao diferentes,
as ondas s˜ao elipticamente polarizadas. [30]
Figura 2.11: Polariza¸c˜ao circular da luz (a) `a direita, e (b) `a esquerda. A amplitude do vetor E~ ´e uma constante, e a diferen¸ca de fase de π/2 entre as componentes Ex e Ey
resulta no rotacionamento da dire¸c˜ao do vetor E. [~ 30]
Polariza¸c˜oes circulares de campos eletromagn´eticos ocorrem devido `a polariza¸c˜ao de
spin de seus f´otons constituintes. Assim como part´ıculas, ondas eletromagn´eticas tamb´em
tˆem momento angular. F´otons com polariza¸c˜ao circular `a direita (σ+) ou `a esquerda (σ−) tˆem uma proje¸c˜ao do momento angular na dire¸c˜ao de sua propaga¸c˜ao igual a +1 ou -1,
respectivamente. [31] Quando um el´etron recombina com um buraco, o f´oton emitido ter´a
momento angular de acordo com as regras de sele¸c˜ao determinadas pela estrutura de bandas
do semicondutor.
2.5
Pontos Quˆ
anticos de InAs cobertos com GaAsSb
Um aspecto fundamental na forma¸c˜ao de pontos quˆanticos tem atra´ıdo recentemente a
aten¸c˜ao da comunidade cient´ıfica. Descobriu-se por exemplo, que se a camada de cobertura
possui espessura inferior `a altura total dos pontos quˆanticos, h´a uma transi¸c˜ao da forma
esf´erica para anelar destas nanoestruturas, com propriedades completamente distintas. De
fato, o procedimento de cobrir por si s´o ´e um processo de descasamento heteroepitaxial de
parˆametros de rede e ´e, portanto, associado `a segrega¸c˜ao, diminui¸c˜ao de tens˜ao,
cisalha-mento, mistura, difus˜ao aprimorada destrain, etc. Estes fenˆomenos acontecem na superf´ıcie
propriedades ´opticas e eletrˆonicas dos QDs dependem fortemente de seus tamanhos, formas,
e estequiometria, torna-se necess´ario um entendimento microsc´opico detalhado do processo
de cobertura, que propicia um ajuste fino das caracter´ısticas optoeletrˆonicas. [32] Outro
as-pecto interessante tem sido a incorpora¸c˜ao de antimˆonio (Sb) como dopante na liga de GaAs
cobrindo pontos quˆanticos de InAs, formando assim um perfil de potencial assim´etrico. [33]
Muitos estudos foram realizados nesta configura¸c˜ao e muito j´a se conhece a respeito dos
efeitos do antimˆonio sobre pontos quˆanticos. [33–39]
Pontos quˆanticos de InAs/GaAs geralmente exibem emiss˜ao pr´oximo a 1,2µm quando
cobertos com apenas GaAs, e dificilmente emitem na regi˜ao de comprimentos de onda para
telecomunica¸c˜ao (entre 1,3 e 1,55 µm), pois durante a cobertura com GaAs ´atomos de In
tendem a migrar para fora do topo dos QDs, reduzindo sua altura. [32] Estudos mais recentes
mostraram que cobrindo pontos quˆanticos de InAs com uma camada de GaAsSb, a migra¸c˜ao
do In ´e suprimida e a altura dos pontos conservada. [34] A camada de GaAsSb atua como
uma camada redutora de tens˜ao (SRL, do inglˆes Strain Reducing Layer), ou seja, devido
`a grande diferen¸ca entre os parˆametros de rede do GaAsSb e do GaAs, o strain entre eles
leva a uma minimiza¸c˜ao da energia interna no QD inibindo sua dissolu¸c˜ao e preservando
sua altura e forma, modificando assim o potencial de confinamento, que resulta em um
deslocamento na emiss˜ao fotoluminescente para menores energias. Emiss˜ao em menores
energias, mais precisamente entre 1,3µm e 1,55 µm, s˜ao de grande interesse na ind´ustria de
telecomunica¸c˜oes pela sua alta eficiˆencia na transmiss˜ao de informa¸c˜oes a longas distˆancias.
Al´em do mais, por preservar as dimens˜oes dos QDs, para baixas concentra¸c˜oes de Sb na
SRL, dados na literatura apontam um aumento significativo na intensidade da emiss˜ao
fotoluminescente. [33, 35]
Al´em deste desvio para o vermelho, variando-se a concentra¸c˜ao de Sb na SRL a
estru-tura de bandas do QD ´e modificada de tal maneira que, a partir de uma concentra¸c˜ao limite
(aproximadamente 14%), a heteroestrutura passa de QD Tipo-I, no qual ambos os
portado-res encontram-se dentro do ponto, para Tipo-II, onde, neste caso, o el´etron localiza-se dentro
do ponto e o buraco na camada de GaAsSb. [34] Esta forma¸c˜ao de um sistema Tipo-II para
os pontos quˆanticos foi comprovada ao estudar o tempo de vida dos portadores, cujos
princi-pais resultados ser˜ao discutidos no Cap´ıtulo5. [36] Por um lado, em heteroestruturas Tipo-I
uma recombina¸c˜ao mais r´apida, mas por outro lado, em materiais com alinhamento
Tipo-II a separa¸c˜ao espacial torna o processo de recombina¸c˜ao muito mais lento. De fato, em
2008, Jang e colaboradores observaram o tempo de vida dos portadores de uma estrutura
Tipo-II de QDs de InAs cobertos com GaAsSb aumentar por um fator de aproximadamente
cinquenta e quatro vezes em compara¸c˜ao com uma estrutura Tipo-I do mesmo material. [36]
Apesar de o longo tempo de vida ser uma importante caracter´ıstica de estruturas
Tipo-II, esta n˜ao ´e uma informa¸c˜ao suficiente para diferenciar entre bandas do Tipo-I e
II. Deste modo, outro comportamento relevante a ser analisado ´e a varia¸c˜ao da energia de
recombina¸c˜ao em fun¸c˜ao da potˆencia de excita¸c˜ao, que apresenta um intensoblueshift
(des-locamento do pico para maiores energias) com o aumento da potˆencia em estruturas Tipo-II,
a impress˜ao digital deste alinhamento de bandas. Em 2002, Chiu et al. [40] demonstraram
que este deslocamento na energia tem rela¸c˜ao com um forte campo el´etrico, proveniente
da separa¸c˜ao espacial dos el´etrons e buracos, [40] que distorce as bandas de valˆencia e de
condu¸c˜ao, formando curvaturas nas estruturas de potencial. Na Figura 2.12 ´e ilustrada a
distor¸c˜ao das bandas de condu¸c˜ao e de valˆencia neste tipo de estrutura. Com o aumento da
potˆencia de excita¸c˜ao estas curvaturas tornam-se mais pronunciadas de tal maneira que os
el´etrons e buracos acumulados ficam confinados na regi˜ao mais estreita pr´oximo `a interface,
e, consequentemente a energia de quantiza¸c˜ao aumenta. [40,41]
Figura 2.12: Efeito de curvatura das bandas em uma estrutura de bandas Tipo-II sob baixa (linhas s´olidas) e alta (linha pontilhada) densidade de potˆencia de excita¸c˜ao. [41]
A energia de quantiza¸c˜ao por sua vez aumenta proporcionalmente com a ra´ız c´ubica
da potˆencia de excita¸c˜ao. Para analisar esteblueshift quantitativamente considera-se que os
portadores localizados na interface formam um plano carregado que correspondentemente






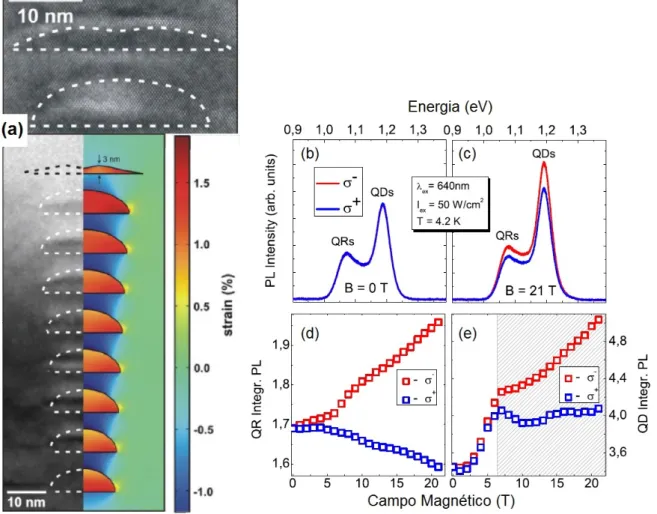
![Figura 4.1: Ilustra¸c˜ao esquem´atica da t´ecnica de epitaxia por feixe molecular. [4] O subs- subs-trato ´e colocado dentro da cˆamara de crescimento atrav´es de um m´ odulo de transferˆencia.](https://thumb-eu.123doks.com/thumbv2/123dok_br/15713601.631153/60.893.307.648.418.777/figura-ilustra-epitaxia-molecular-colocado-cˆamara-crescimento-transferˆencia.webp)