Universidade Federal do Cear´a Centro de Ciˆencias
Departamento de F´ısica
Curso de P´os-Graduac¸˜ao em F´ısica
Confinamento Diel´
etrico versus Quˆ
antico
em Nanoestruturas
Teldo Anderson da Silva Pereira
Tese de Doutorado
Orientador:
Prof. Dr. Gil de Aquino Farias
Fortaleza
Universidade Federal do Cear´a Centro de Ciˆencias
Departamento de F´ısica
Curso de P´os-Graduac¸˜ao em F´ısica
Teldo Anderson da Silva Pereira
Confinamento Diel´
etrico versus Quˆ
antico
em Nanoestruturas
Tese apresentada ao Curso de
P´os-Gradua¸c˜ao em F´ısica da Universidade Federal do Cear´a como parte dos requisitos para a obten¸c˜ao do t´ıtulo de Doutor em F´ısica.
Orientador:
Prof. Dr. Gil de Aquino Farias
Fortaleza
`
A minha fam´ılia:
Agradecimentos
Ningu´em consegue muita coisa sem a contribui¸c˜ao dos outros, e a cria¸c˜ao desta tese n˜ao foi uma exce¸c˜ao. Fui aben¸coado com o incentivo e a ajuda de muitas pessoas maravilhosas e talentosas, desde o momento em que decidi trilhar o caminho dos estudos, passando por
v´arios processos de forma¸c˜ao, que nunca poderei agradecer a todos. Mas gostaria de agradecer a algumas pessoas a quem devo muito, e antes de tudo agrade¸co a Deus pela ben¸c˜ao de tˆe-las em meu caminho.
Esta tese nunca poderia ser escrita sem a orienta¸c˜ao do professor Dr. Gil de Aquino
Farias, a quem sou muito grato pela paciˆencia, e pela valiosa amizade e confian¸ca. Agrade¸co ao professor Jos´e Alexander de King Freire, pela co-orienta¸c˜ao no trabalho e pela amizade dedicada ao longo destes anos.
Sou grato tamb´em ao professor Valder Nogueira Freire, pelas constantes discuss˜oes e
cr´ıticas construtivas do trabalho e pela confian¸ca.
Agrade¸co ao professor Jeanlex Soares de Sousa, pela contribui¸c˜ao no trabalho, e prin-cipalmente pelo conv´ıvio e amizade ao longo destes anos.
Ao professor Jos´e Soares Andrade Jr., coordenador da p´os gradua¸c˜ao do Departamento
de F´ısica.
Ao professor Josu´e Mendes Filho, pela admira¸c˜ao e o exemplo de dedica¸c˜ao ao meio acadˆemico.
Ao professor e amigo Alberto Sebasti˜ao de Arruda, pela forma¸c˜ao na gradua¸c˜ao e
principalmente pela confian¸ca e amizade adquiridas ao longo dos anos.
As secret´arias Rejane e Ana Cleide por serem sempre prestativas e amigas.
Agrade¸co em especial aos amigos que aqui em Fortaleza me ajudaram a conter a saudade que sinto de minha cidade natal.
Aos amigos do grupo, Ewerton Wagner, Ricardo Pires, Francisco Francin´e, Marilza Gusm˜ao, Marcelo Zimmer, Erlania, Luciana Magalh˜aes, Erivelton Fa¸canha, Andrei, pelos cinco anos e meio de boa convivˆencia, respeito e principalmente pelos bons momentos compartilhados no meio acadˆemico.
Aparecida, Tamara, Milene, Juliana e C´ıntia; aos amigos de S˜ao Luis: Rivelino Cunha e fam´ılia, Lucilene Pereira; aos amigos de Teresina: Tayroni Francisco e Sandra Alves; aos amigos do Par´a: Roberval e Fabricio Potiguar; `a amiga paraibana Joelma; ao amigo
sergipano Cristiano; e `as paulistas Daniela Maionchi e Sofia Helena.
Meu agradecimento mais que especial vai para minha fam´ılia e minha doce Rosinha, por tudo que sou nesta vida.
Ao CNPq pelo apoio financeiro.
E finalmente a Deus por me fazer perseverar em todos os desafios, por ter me dado a certeza de que Nele posso todas as coisas, mesmo sendo pequeno diante das dificuldades e dos inimigos. Eu e Deus no cora¸c˜ao, somos a maioria absoluta. Agrade¸co por ter dado prop´osito `a minha existˆencia, por tudo o que tenho e tudo o que sou, por saciar a minha
Resumo
Esse trabalho tem por objetivo estudar sistemas quˆanticos de baixa dimensionali-dade do tipo po¸cos quˆanticos GaN/Hf O2 e Si/High− k. Investigamos propriedades
eletrˆonicas, ´opticas e estados de impurezas em po¸cos quˆanticos GaN/Hf O2, levando em
considera¸c˜ao efeito de cargas imagem devido `a descontinuidade das constantes diel´etricas dos materiais do po¸co (εw) e da barreira (εb) destas estruturas. Primeiramente estudamos
os efeitos do potencial imagem de auto-energia sobre as propriedades ´opticas e eletrˆonicas de po¸cos quˆanticos abruptos e n˜ao abruptos. Nossos resultados mostram que o efeito do
potencial imagem de auto-energia modifica fortemente as estruturas eletrˆonicas de po¸cos quˆanticos, podendo variar a energia de recombina¸c˜ao dos portadores em at´e 100 meV. Al´em disso, o modelo ideal (En ∼ n2/L2) de po¸cos quˆanticos n˜ao ´e v´alido para algumas
estruturas comεw < εb, devido ao confinamento de portadores na regi˜ao da interface. A
energia de liga¸c˜ao e a energia total do exciton s˜ao estudadas em po¸cos quˆanticos abruptos com εw < εb e εw > εb, dando ˆenfase a efeitos causados por cargas imagem: potencial
de auto-energia e intera¸c˜ao do el´etron (buraco) com as imagens do buraco (el´etron). Os resultados mostram que, considerando os parˆametros dos materiais usados neste trabalho,
modelos simples (que n˜ao consideram efeito de cargas imagem) para c´alculos de excitons s˜ao inadequados para estudar sistemas com εw < εb, visto que modelos mais precisos
(que incluem todas as contribui¸c˜oes devido `as cargas imagem) apresentam resultados com diferen¸cas significativas, em torno de ∼ 80 meV, entre modelos simples e modelos mais
precisos. Finalmente, estudamos a intera¸c˜ao entre el´etron-impureza em po¸cos quˆanticos GaN/Hf O2 abruptos. Os c´alculos consideram simultaneamente todas as contribui¸c˜oes
de energias causadas pela diferen¸ca entre as constantes diel´etricas de GaN (εGaN =9.5)
e Hf O2 (εHf O2 =25). Os resultados mostram que, considerando os parˆametros dos
ma-teriais usados neste trabalho, `a medida que a posi¸c˜ao da impureza afasta-se do centro do po¸co, no sentido positivo do eixo z, a fun¸c˜ao de onda do el´etron ´e atra´ıda no mesmo sentido de deslocamento da impureza. A intensidade da atra¸c˜ao diminui quando a posi¸c˜ao da impureza afasta-se da interface, no sentido positivo dez, dentro da regi˜ao da barreira
Abstract
We study in this work the low dimensional quantum well systems (QW) ofGaN/Hf O2 and Si/High−k. In GaN/Hf O2 QW, we analyze not only the electronic and optic properties but also impurity states of this system. Moreover, we consider the image charge effects. This is due to discontinuity of materials dielectric constant of well (εw) and barriers (εb) of this structures. At first, we analyze the image potential effects of self-energy in electronic and optic proprieties of abrupt and non-abrupt QWs. We observed that the electronic structure of QW is strongly modified by the image potential effect of self-energy. It is found that the recombination energy of carriers can change up to 100 meV. Moreover, we observed that the ideal model (En ∼ n2/L2) of QWs is not
valid for some structures with εw < εb due to confinement of carries in the interface. Second, exciton binding and exciton total energy in εw < εb and εw > εb abrupt QWs are studied giving more importance on effect caused by image charges, for example, self energy potential and interactions among electron (hole) and the image charges of hole (electron). Considering the materials and parameters used in this work, we observed that simple models used to evaluate exciton, which do not consider image charge effects, are not appropriated to study systems withεw < εb since appropriated models, which consider all image charge effects, present results with significative changes, around 80 meV, with regard to the simplest models. Finally, impurity states are studied in abruptGaN/Hf O2 QWs. We considered all the energy contributions caused by the change between the dielectric constant of GaN (εGaN =9.5) and Hf O2 (εHf O2 =25) simultaneously. The
Os que confiam no Senhor ser˜ao como o monte de Si˜ao, que n˜ao se abala, mas permanece para sempre.
Sum´
ario
Lista de Figuras iv
Lista de Tabelas 1
1 Introdu¸c˜ao 2
1.1 Dispositivos semicondutores: uma vis˜ao no contexto hist´orico . . . 2
1.2 Nanotecnologia . . . 5
1.2.1 Importˆancias e aplica¸c˜oes . . . 7
1.3 Dispositivos semicondutores: nanoestruturas . . . 8
1.3.1 Bandas de energia . . . 9
1.3.2 Teoria da massa efetiva . . . 11
1.3.3 Confinamento de portadores . . . 12
1.4 Excitons em nanoestruturas . . . 18
1.5 Impurezas em nanoestruturas . . . 20
1.6 Diel´etricos em nanoestruturas . . . 23
1.6.1 Potencial eletrost´atico em meio diel´etrico . . . 26
1.7 Escopo da tese . . . 28
2 Propriedades eletrˆonicas e ´opticas de po¸cos quˆanticos GaN/Hf O2 e Si/High−k 30 2.1 Introdu¸c˜ao . . . 31
2.2 Modelo Te´orico . . . 32
2.2.1 Po¸cos abruptos . . . 36
2.2.2 Po¸cos n˜ao abruptos . . . 36
2.2.3 Adi¸c˜ao de campo el´etrico . . . 38
2.3 Po¸cos quˆanticos GaN/Hf O2 . . . 39
2.4 Po¸cos quˆanticos Si/High−k . . . 45
3 Excitons: Confinamento Diel´etrico versus Quˆantico 55 3.1 Introdu¸c˜ao . . . 56
3.2.1 Potencial Imagem e Energia de Liga¸c˜ao do Exciton . . . 61
3.2.2 M´etodo do Potencial Efetivo . . . 68
3.3 Resultados num´ericos . . . 70
4 Intera¸c˜ao El´etron-impureza em po¸cos quˆanticos GaN/Hf O2 77 4.1 Introdu¸c˜ao . . . 78
4.2 Modelo Te´orico . . . 79
4.2.1 Potencial de confinamento V(r) . . . 81
4.3 Resultados num´ericos . . . 85
Conclus˜oes Gerais e Perspectivas 91 Apˆendice A 94 Solu¸c˜ao da Equa¸c˜ao de Schr¨odinger Dependente do Tempo . . . 94
Apˆendice B 100 Artigos publicados . . . 100
Trabalhos apresentados em Congressos Internacionais . . . 100
Trabalhos apresentados em Congressos Nacionais . . . 101
Lista de Figuras
1.1 Fotografia do primeiro transistor bipolar de contato criado em dezembro de 1947,
por pesquisadores da Bell Labs. Foto retirada da Referˆencia [9].. . . 3 1.2 Fotografia do primeiro circuito integrado desenvolvido por J. Kilby, em 1958.
Foto retirada do site: http://www.uib.es/c-calculo/scimgs/fc/tc1/historia.html
(´ultimo acesso em junho de 2006). . . 3 1.3 Representa¸c˜ao gr´afica da lei de Moore para dupli¸c˜ao de transistor em um circuito
integrado a cada dois anos. Foto retirada do site: http://www.physics.udel.edu
(´ultimo acesso em junho de 2006). . . 4 1.4 Estrutura simples de um dispositivo eletrˆonico. Os trˆes terminais s˜ao
normal-mente indicados como G, S e D, seguindo a terminologia anglo-sax˜a de gate
(porta), source (fonte) e drain (dreno), respectivamente.. . . 5 1.5 (Esquerda) dimens˜oes representativas de algumas esp´ecies t´ıpicas, em suas v´arias
escalas. (Direita) regi˜ao de dom´ınio da nanotecnologia, comparada com uma
faixa que compreende desde macroestruturas at´e dimens˜oes subatˆomicas (escala
logar´ıtmica). Figuras retiradas das Referˆencias [8 e 9] . . . 7 1.6 Fotos de alguns dispositivos constitu´ıdos de nanoestruturas semicondutoras e
aplica¸c˜oes. Retirada do site http://www.intel.com (´ultimo acesso em junho de
2006).. . . 8 1.7 (a) Forma¸c˜ao de bandas de n´ıveis de energia devido `a aproxima¸c˜ao dos ´atomos
em um s´olido. (b) Bandas de valˆencia e condu¸c˜ao em semicondutores (as regi˜oes
hachuriadas representam a ocupa¸c˜ao de el´etrons emT >0 K). . . 10 1.8 Perfis de potenciais de confinamento de portadores em nanoestruturas. Em (a)
perfil de confinamento de um po¸co quˆantico e em (b) perfil do potencial de
confinamento de um fio ou ponto quˆantico. . . 13 1.9 Estrutura f´ısica de um po¸co quˆantico de GaN/Hf O2 e representa¸c˜ao do
mo-vimento de um portador no plano do po¸co. Figura reproduzida a partir da
Referˆencia [15]. . . 15 1.10 Diagrama esquem´atico das curvas de dispers˜ao (kx,y) no plano xy e estrutura
1.11 Representa¸c˜ao esquem´atica de gera¸c˜ao de excitons. Figura reproduzida a partir
da Referˆencia [15]. . . 19 1.12 (a) Representa¸c˜ao esquem´atica de um par el´etron-buraco, firmemente ligado,
formando um exciton de Frenkel. (b) Representa¸c˜ao esquem´atica de um par
el´etron-buraco, fracamente ligado, formando um exciton de Wannier-Mott.
Fi-gura reproduzida a partir da Referˆencia [19].. . . 20 1.13 Esquerda: modelo esquem´atico de um Cristal de Si dopado com impurezas
substitucionaisGa(aceitador) eAs(doador). Direita: representa¸c˜ao esquem´atica
dos n´ıveis de impurezas no gap de semicondutores dopados. EceEvrepresentam
as energias m´ınimas e m´aximas das bandas de condu¸c˜ao e valˆencia,
respectiva-mente. Figura reproduzida a partir da Referˆencia [10]. . . 21 1.14 (a) Representa¸c˜ao esquem´atica do efeito da largura do po¸co quˆantico sobre a
fun¸c˜ao de onda do portador. (b) Representa¸c˜ao esquem´atica do efeito da posi¸c˜ao
de impureza sobre a fun¸c˜ao de onda do portador. Figura reproduzida a partir
da Referˆencia [15]. . . 22 2.1 Perfil do po¸co quˆantico. Linha s´olida representa po¸co n˜ao abrupto, linha
trace-jada representa po¸co abrupto e as linhas pontilhadas s˜ao as fun¸c˜oes de onda do
portador (z1 =−a;z2 =−(a−σ);z3= (a−σ); z4 =a). . . 33
2.2 Po¸co quˆantico GaN/Hf O2. (a) Potencial de confinamento ∆Ee(ze) em eV; (b)
Representa¸c˜ao do potencial de auto-energia Σi(zi) em meV. Perfil do potencial
de confinamento para el´etrons e buracos, em (c) sem campo el´etricoVi
T = ∆Ei+ Σi(zi) e em (d) com campo el´etrico de 200kV /cm,VTi = ∆Ei+Σi(zi)±eF zi. As fun¸c˜oes de onda do el´etron e do buraco est˜ao representadas pela linha vermelha
no gr´afico (c) e (d) e a linha horizontal em azul representa o estado fundamental
de energia do portador.. . . 40 2.3 N´ıveis de energia dos portadores no estado fundamental em fun¸c˜ao da largura
do po¸co para (a) el´etrons, (b) buraco leve e (c) buraco pesado. Linhas preta,
vermelha e azul representam, respectivamente, interfaces com espessura de 0.0
nm (abrupta), 0.5 nm e 1.0 nm. . . 41 2.4 Fun¸c˜ao de onda dos portadores em unidades arbitr´arias: el´etron (linha preta),
buraco leve (linha vermelha) e buraco pesado (linha azul). As fun¸c˜oes de onda
dos gr´aficos acima, em (a) e (c), s˜ao de po¸cos estreitos com 5 nm; abaixo, em
2.5 Efeito Stark sobre a energia de recombina¸c˜ao ∆ER para po¸cos com largura de
(a)-(c) 5 nm e (b)-(d) 20 nm. (a)-(b) Energia de recombina¸c˜ao de el´etron-buraco
leve e (c)-(d) energia de recombina¸c˜ao de el´etron-buraco pesado. Linha preta
representa interface abrupta e linha vermelha interface de 1.0 nm. Para efeitos
de compara¸c˜ao, os s´ımbolos¤(σ = 0.0 nm) e◦(σ = 1.0 nm) s˜ao plotados para representar a energia de recombina¸c˜ao sem efeito do potencial de auto-energia. . 44 2.6 Superposi¸c˜ao das fun¸c˜oes de onda do el´etron e do buraco versus largura do
po¸co, (a)-(c) el´etron-buraco leve e (b)-(d) el´etron buraco pesado, para po¸cos n˜ao
polarizados (esquerda) e polarizados por um campo el´etrico de intensidade igual
a 200 kV/cm (direita). As interfaces consideradas s˜ao: abrupta (preto), 0.5 nm
(vermelho) e 1.0 nm (azul). Para efeito de compara¸c˜ao, resultados sem efeito
do potencial de auto-energia, para po¸cos n˜ao polarizados tamb´em s˜ao inclu´ıdos:
σ = 0.0 nm (¤),σ = 0.5 nm (△) andσ = 1.0 nm (×). . . . 44 2.7 Potencial de condu¸c˜ao ∆Ee(ze), potencial de auto-energia Σe(ze) e potencial de
confinamentoVT(z) sem efeito de campo el´etrico, para po¸cos abruptos GaAs/Al0.3Ga0.7As
(topo esquerda),Si/Hf O2(base esquerda),Si/SiO2(topo direita) eSi/SrT iO3
(base direita) com 5 nm de largura. Fun¸c˜oes de onda est˜ao plotadas com linha
vermelha. . . 46 2.8 Energia de recombina¸c˜ao em fun¸c˜ao da largura do po¸co, para po¸cos quˆanticos
ab-ruptos. (a) Energia de recombina¸c˜ao do portador el´etron-buraco pesadoER,(∆E)e−hh , calculada para os portadores confinados no potencial ∆Ei(zi). (b) Energia de
recombina¸c˜ao do portador el´etron-buraco pesadoEeR,(V−hh
T), calculada para os
por-tadores confinados no potencialVT = ∆Ei(zi) + Σi(zi). Ainda em (b), triˆangulo
e c´ırculos representam a energia de recombina¸c˜ao do el´etron-buraco pesado,
con-finados no po¸co Si/Hf O2 eSi/SrT iO3 respectivamente, com interface n˜ao
ab-rupta de 0.5 nm e sem o efeito do potencial Σi(zi). (c) Efeito efetivo do potencial
de auto-energia ∆ER = ER,(Ve−hhT) −ER,(∆E)e−hh . As cores preta, vermelha, azul e verde representam, respectivamente, os po¸cosSi/SrT iO3,Si/Hf O2,Si/SiO2 e
2.9 A esquerda, n´ıveis de energia dos portadores no estado fundamental em fun¸c˜` ao
da largura do po¸co Si/SrT iO3 para (a) el´etrons, (b) buraco leve e (c) buraco
pesado. Linhas preta, vermelha e azul representam, respectivamente, interface
com espessura de 0.0 nm (abrupta), 0.5 nm e 1.0 nm. Na direita, fun¸c˜ao de
onda dos portadores em unidades arbitr´arias: el´etron (linha preta), buraco leve
(linha vermelha) e buraco pesado (linha azul). Em (d) as fun¸c˜oes de onda est˜ao
confinadas em po¸cos estreitos com largura de 5 nm e interface de 1.0 nm. Em
(e) as fun¸c˜oes de onda est˜ao confinadas em po¸cos largos com largura de 20 nm
e interface de 1.0 nm.. . . 50 2.10 Perfis de potencial totalVT(z) com campo el´etrico de 200 kV/cm, para el´etron e
buraco confinados em po¸cos quˆanticos de 20 nm de largura: (a)GaAs/Al0.3Ga0.7As,
(b)Si/Hf O2, (c)Si/SiO2 e (d)Si/SrT iO3. Fun¸c˜oes de onda do estado
funda-mental est˜ao plotadas com linhas vermelhas. . . 50 2.11 Efeito Stark sobre a energia de recombina¸c˜ao ER para po¸cos Si/SiO2 (topo) e
Si/Hf O2 (base) com largura de (a)-(c) 5 nm e (b)-(d) 20 nm. Esquerda: energia
de recombina¸c˜ao de el´etron-buraco leve. Direita: energia de recombina¸c˜ao de
el´etron-buraco pesado. Linha preta representa interface abrupta e linha vermelha
interface de 1.0 nm. Para efeitos de compara¸c˜ao, os s´ımbolos ¤ (σ = 0.0 nm)
e ◦ (σ = 1.0 nm) s˜ao plotados para representar a energia de recombina¸c˜ao sem efeito do potencial de auto-energia. . . 52 2.12 Superposi¸c˜ao das fun¸c˜oes de onda do el´etron e do buraco versus largura do
po¸co, (a) el´etron-buraco leve e (b) el´etron-buraco pesado, confinados nos po¸cos
Si/SrT iO3 (topo), Si/Hf O2 (base esquerda) e Si/SiO2 (base direita). As
in-terfaces consideradas s˜ao: abrupta (preto), 0.5 nm (vermelho) e 1.0 nm (azul).
Para efeito de compara¸c˜ao, resultados sem efeito do potencial de auto-energia,
para po¸cos n˜ao polarizados, tamb´em s˜ao incluidos: σ= 0.0 nm (¤),σ= 0.5 nm
(△) and σ = 1.0 nm (×). . . . 53 3.1 (a) Diagrama esquem´atico de um exciton em um material cristalino
tridimensio-nal, com o buraco (c´ırculo cheio pr´oximo ao centro) e el´etron separados pelo raio
de Bohrλ, orbitando o centro de massa. (b) Diagrama de bandas de energia de
um exciton em material tridimensional. . . 57 3.2 (a) Representa¸c˜ao esquem´atica do confinamento de exciton por barreiras de um
po¸co quˆantico abrupto. (b) Diagrama de bandas de energia do po¸co quˆantico
3.3 Aspecto de confinamento de uma fun¸c˜ao de onda Ψe e o potencial φ em uma
estrutura de po¸co quˆantico. A parte cinza representa a penetra¸c˜ao da fun¸c˜ao de
onda e do potencial eletrost´atico. Figura reproduzida a partir da Referˆencia [35]. 62 3.4 (a) diagrama esquem´atico de uma estrutura quˆantica diel´etrica. (b) configura¸c˜ao
t´ıpica de uma carga real localizada no po¸co e as imagens geradas por ela. (c)
carga real localizada na barreira da direita e (d) na barreira da esquerda. Figura
reproduzida a partir da Referˆencia [35]. . . 63 3.5 Correla¸c˜ao em z das posi¸c˜oes do el´etron ze e do buracozh nas regi˜oes L, C e R
do po¸co quˆantico.. . . 67 3.6 Energia de liga¸c˜ao do exciton calculada por Kumagai e Takagahara (Referˆencia
[35]), representada pela linha s´olida. Os s´ımbolos (×) representam a energia de liga¸c˜ao do exciton, calculada neste trabalho, usando m´etodo do potencial efetivo,
com os mesmo parˆametros do po¸coGaAs/ZnSeusado por Kumagai e Takagahara. 70 3.7 Diferen¸ca na energia de recombina¸c˜ao ∆ERe−h(a) el´etron-buraco leve e (b) el´etron
buraco pesado para diferentes larguras de po¸co: (+) L=5 nm, (•) L=10 nm e (△) L=15 nm. . . . 72 3.8 Energia de recombina¸c˜ao el´etron buraco-leve (vermelho) e el´etron-buraco pesado
(preto) em fun¸c˜ao da largura do po¸co L e com efeito do potencial Σi(zi). Os
po¸cos abruptos considerados s˜ao: (a)GaN/Hf O2, (b)Si/Hf O2, (c)Si/SiO2 e
(d) Si/SrT iO3.. . . 72
3.9 Valor absoluto da energia de liga¸c˜ao |Eb|do exciton (a)-(b) el´etron-buraco leve e (c)-(d) el´etron buraco pesado, confinado em po¸cos com larguras de (a)-(c)L=
5 nm e (b)-(d) L= 20 nm. Trˆes diferentes aproxima¸c˜oes para o c´alculo de |Eb| s˜ao consideradas: AP0(¤),AP1(◦) eAP2(×). . . . 73 3.10 Diagrama esquem´atico das intera¸c˜oes entre os portadores e as cargas imagem.
Quando εb > εw as cargas imagem tˆem sinal oposto ao sinal do portador, que
sente um potencial atrativo na regi˜ao do po¸co devido `a intera¸c˜ao com as cargas
imagem que ele produz e um potencial repulsivo devido `a intera¸c˜ao com as cargas
imagem geradas pelo outro portador. Quandoεb< εw a situa¸c˜ao se inverte. . . 74
4.1 (a) Perfil do potencial devido `as bandas de energia ∆Ee(z) ao longo do eixo z.
(b) Perfil do potencial de auto-energia Σe(z) ao longo do eixo z. (c) Perfil do
potencial da impureza, com efeito da carga imagem, ao longo do eixo z. (d)
Perfil do potencial total de confinamento ao longo do eixo z. . . 83
4.2 Esquerda: Potencial da impurezaVe−im(ρe, ze, zim), com efeito da carga imagem.
4.3 Energia de liga¸c˜ao el´etron-impureza, calculada por Cen e Bajaj (Ref. [44]),
re-presentada pela linha s´olida. Os s´ımbolos (×), (△) e (•) representam a energia de liga¸c˜ao do estado fundamental, primeiro e segundo estados excitados,
respec-tivamente. . . 85 4.4 Proje¸c˜ao nos eixos y e z da fun¸c˜ao de onda do el´etron para (a) estado
funda-mental, (b) primeiro e (c) segundo estado excitado. Em (d) ´e plotado a proje¸c˜ao
do potencial de confinamento ao longo do eixo z. A impureza est´a localizada
no centro do po¸coGaN/Hf O2 de larguraL= 5 nm. A linha horizontal em (d)
representa o estado fundamental do el´etron. . . 86 4.5 Proje¸c˜ao nos eixos y e z da fun¸c˜ao de onda do el´etron para (a) estado
funda-mental, (b) primeiro e (c) segundo estado excitado. Em (d) ´e plotado a proje¸c˜ao
do potencial de confinamento ao longo do eixo z. A impureza est´a localizada
pr´oximo `a interface direita do po¸co GaN/Hf O2, de largura L = 5 nm, na
posi¸c˜ao zim= 2 nm. A linha horizontal em (d) representa o estado fundamental
do el´etron. . . 86 4.6 Proje¸c˜ao nos eixos y e z da fun¸c˜ao de onda do el´etron para (a) estado
funda-mental, (b) primeiro e (c) segundo estado excitado. Em (d) ´e plotado a proje¸c˜ao
do potencial de confinamento ao longo do eixoz. A impureza est´a localizada na
barreira do po¸coGaN/Hf O2, de larguraL= 5 nm, na posi¸c˜aozim= 10 nm. A
linha horizontal em (d) representa o estado fundamental do el´etron. . . 87
4.7 Esquerda: energia do el´etron para (preto) estado fundamental, (vermelho)
pri-meiro e (azul) segundo estado excitado, em fun¸c˜ao da posi¸c˜ao da impureza (zim).
Direita: energia de liga¸c˜ao para, (preto) estado fundamental, (vermelho)
pri-meiro e (azul) segundo estado excitado, em fun¸c˜ao da posi¸c˜ao da impureza (zim).
Em (a)-(c) o po¸co GaN/Hf O2 tem largura L = 5 nm, em (b)-(d) o po¸co tem
largura L= 10 nm. . . 88 4.8 Centro de massa do el´etron em fun¸c˜ao da posi¸c˜ao da impureza (zim). Em (a) o
po¸co GaN/Hf O2 tem largura L = 5 nm e em (b) o po¸co tem largura L = 10
nm. O estado fundamental, primeiro e segundo estado excitado s˜ao representados
Lista de Tabelas
1.1 Propriedades relevantes dos materiais candidatos. Referˆencia [7] . . . 26 2.1 Potencial de confinamento ∆Ei(zi) devido `as bandas de energia. Qi representa
o band-off-set de condu¸c˜ao (i=e) e valˆencia (i=h). . . 34 2.2 Interpola¸c˜ao linear entre a constante diel´etrica da barreiraεb e a constante
diel´etrica do po¸co εw. . . 37
2.3 Parˆametros dos materiais. Referˆencias [57, 59]. . . 40 2.4 Parˆametros dos materiais. Referˆencias [33, 38, 58, 62] . . . 47
3.1 Compara¸c˜ao da energia total do exciton el´etron-buraco leve, calculada com
dife-rentes aproxima¸c˜oes. AP0 n˜ao considera nenhuma contribui¸c˜ao devido a efeitos
de cargas imagem, AP1 considera apenas corre¸c˜ao devido ao potencial de
auto-energia,AP2 inclui todas as intera¸c˜oes relacionadas a cargas imagem. A energia
total do exciton ´e calculada para po¸cos estreitos (L= 5.0 nm) e largos (L= 20
nm). . . 75 3.2 Compara¸c˜ao da energia total do exciton el´etron-buraco pesado, calculada com
diferentes aproxima¸c˜oes. AP0 n˜ao considera nenhuma contribui¸c˜ao devido a
efeitos de cargas imagem, AP1 considera apenas corre¸c˜ao devido ao potencial
de auto-energia, AP2 inclui todas as intera¸c˜oes relacionadas `a cargas imagem.
A energia total do exciton ´e calculada para po¸cos estreitos (L= 5.0 nm) e largos
2
1
Introdu¸
c˜
ao
“...as pessoas me falam sobre miniaturiza¸c˜ao e o quanto ela tem progredido nos dias de hoje. Elas me falam de motores el´etricos com o tamanho de uma unha do seu dedo mindinho. E que h´a um dispositivo no mercado, dizem elas, com o qual se pode escrever o Pai Nosso na cabe¸ca de um alfinete. Mas isso n˜ao ´e nada: ´e o passo mais primitivo e hesitante na dire¸c˜ao que eu pretendo discutir. ´E um novo mundo surpreendentemente pequeno. No ano 2000, quando olharem para esta ´epoca, elas se perguntar˜ao por que antes de 1960 ningu´em come¸cou a se movimentar seriamente nessa dire¸c˜ao.” Richard Feynman Trecho de discurso proferido em 1960
1.1
Dispositivos semicondutores: uma vis˜
ao no
con-texto hist´
orico
O decurso hist´orico do desenvolvimento dos dispositivos eletrˆonicos teve in´ıcio em 1874, quando Karl Ferdinand Braun (1850-1918) construiu um retificador com um cris-tal de P bS [1], soldado com um fio met´alico (diodo de ponta de contato) e observou
uma altera¸c˜ao no fluxo de corrente total como fun¸c˜ao da polariza¸c˜ao da tens˜ao aplicada e das condi¸c˜oes da superf´ıcie do material, descobrindo assim o car´ater assim´etrico da condu¸c˜ao el´etrica entre metais e semicondutores. Desde ent˜ao, importantes avan¸cos em pesquisas relacionadas com a f´ısica da mat´eria condensada possibilitaram a constru¸c˜ao de
novos dispositivos que se tornavam cada vez mais eficientes e com not´aveis aplicabilidades tecnol´ogicas.
Durante todos estes anos destacaram-se algumas pesquisas que conduziram ao atual avan¸co tecnol´ogico que vivemos nos dias de hoje. O in´ıcio do s´eculo XX, por sua vez, foi
fundamental para o desenvolvimento da microeletrˆonica, pois houve um enorme progresso na teoria f´ısica, com o desenvolvimento da mecˆanica quˆantica, por Bohr, de Broglie, Heisenberg, Schr¨odinger e outros, notadamente durante os anos 20. Em paralelo a este fato, foi proposto um primeiro conceito de desenvolvimento de um transistor de efeito de
1.1 Dispositivos semicondutores: uma vis˜ao no contexto hist´orico 3
Figura 1.1: Fotografia do primeiro transistor bipolar de contato criado em dezembro de 1947, por pesquisadores da Bell Labs. Foto retirada da Referˆencia [9].
Figura 1.2: Fotografia do primeiro circuito integrado desenvolvido por J. Kilby, em 1958. Foto retirada do site: http://www.uib.es/c-calculo/scimgs/fc/tc1/historia.html (´ultimo acesso em junho de 2006).
de 1930. Durante a d´ecada de 40 a eletrˆonica tinha por base as v´alvulas termoiˆonicas e
rel´es eletro-mecˆanicos. Mas as v´alvulas termoiˆonicas eram fr´ageis, dispendiosas e de alto consumo de energia, enquanto os rel´es eletro-mecˆanicos tinham comuta¸c˜ao muito lenta. Estas limita¸c˜oes incentivaram novas pesquisas em torno dos semicondutores sil´ıcio (Si) e germˆanio (Ge).
Em 1940, R. Ohi identifica, pela primeira vez, semicondutores de Si tipo p e tipo n. No mesmo ano, J. Scaff e H. Theuerer mostram que o n´ıvel e o tipo de condutividade do Sise devem `a presen¸ca de tra¸cos de impurezas, e este resultado demonstrou a importˆancia da adi¸c˜ao de impurezas nas amostras semicondutoras para fabrica¸c˜ao de dispositivos
se-micondutores. Assim, as pesquisas baseadas nestes semicondutores conduziram `a cria¸c˜ao das primeiras jun¸c˜oesp−n e transistores bipolares no fim da d´ecada de 40 (Fig. 1.1).
Na d´ecada de 50, o efeito de resistˆencia negativa em jun¸c˜oes p−naltamente dopadas foi observado por Esaki [2], levando `a descoberta do efeito quˆantico de tunelamento. A
1.1 Dispositivos semicondutores: uma vis˜ao no contexto hist´orico 4
Figura 1.3: Representa¸c˜ao gr´afica da lei de Moore para dupli¸c˜ao de transistor em um circuito integrado a cada dois anos. Foto retirada do site: http://www.physics.udel.edu (´ultimo acesso em junho de 2006).
capacitor e um resistor, interconectados atrav´es de fios soldados nos contatos (Fig. 1.2), abrindo caminho para o desenvolvimento de circuitos integrados (CI). Outra contribui¸c˜ao
importante de Esaki (co-autoria de Tsu) [3, 4], foi a cria¸c˜ao de heteroestruturas, em 1969-70, que separavam el´etrons de impurezas ionizadas, de forma a reduzir o espalhamento Coulombiano e aumentar a mobilidade dos portadores.
Em 1965 Gordon Moore [5], um dos fundadores da Intel, percebeu que o n´umero de
transistores dos circuitos integrados cresceria exponencialmente, dobrando a cada dois anos (atualmente observa-se este crescimento a cada um ano e meio), e previu que esta tendˆencia deveria continuar. A esta tendˆencia denominou-se lei de Moore (Fig. 1.3).
O desenvolvimento e aperfei¸coamento de t´ecnicas de crescimento de filmes finos, com
alta qualidade, tais como deposi¸c˜ao por epitaxia do tipo MBE [6] (Molecular Beam Epitaxy) e deposi¸c˜ao por vapor qu´ımico do tipo MOCVD (Metalorganic Chemical Va-por Deposition), n˜ao s´o tornou poss´ıvel o grande avan¸co de dispositivos semicondutores a partir de meados da d´ecada de 70, com a fabrica¸c˜ao de estruturas de heterojun¸c˜oes de
semicondutores dos grupos III-V e outros, como tamb´em manteve a lei de Moore vigente at´e os dias atuais.
Os conhecimentos acumulados no decorrer destes anos possibilitaram integrar grandes quantidades de circuitos sobre um mesmo substrato semicondutor. A funcionalidade e o
benef´ıcio do dispositivo est˜ao diretamente relacionados ao n´umero de circuitos integrados no substrato semicondutor. A diminui¸c˜ao das dimens˜oes dos dispositivos aumenta o seu desempenho e reduz o consumo de energia, e esta equa¸c˜ao econˆomica explica a imensa evolu¸c˜ao registrada na eletrˆonica, nas ´ultimas quatro d´ecadas, valendo-se da tecnologia
1.2 Nanotecnologia 5
P - Si P - Si
N - Si Metal
Porta dielétrica: SiO2 Terminal
Dreno
Terminal Fonte Terminal
Porta
Figura 1.4: Estrutura simples de um dispositivo eletrˆonico. Os trˆes terminais s˜ao normalmente indicados como G, S e D, seguindo a terminologia anglo-sax˜a degate (porta), source (fonte) e drain (dreno), respectivamente.
dos dispositivos foram diminuindo, as portas diel´etricas precisaram ser mais finas, e o uso cont´ınuo do di´oxido de sil´ıcio SiO2, como material de porta diel´etrica nos dispositivos1,
come¸cou a ter limita¸c˜oes fundamentais devido a correntes de tunelamento atrav´es do ´oxido (Fig. 1.4). Este problema chamou a aten¸c˜ao dos pesquisadores, que estudaram
intensivamente novos materiais nos ´ultimos cinco anos com o objetivo de encontrar um substituto para SiO2 nas nanoestruturas, e com isto manter a miniaturiza¸c˜ao por mais
algum tempo.
1.2
Nanotecnologia
O entendimento do comportamento de materiais em escala nanom´etrica (10−9 metros)
ocasionou uma revolu¸c˜ao na ciˆencia e na tecnologia. Materiais em escala nanom´etrica
apresentam novos comportamentos e/ou propriedades diferentes daquelas que geralmente
apresentam em escala macrosc´opica2. Ao ramo da ciˆencia que estuda esses materiais/comportamentos
foi atribu´ıdo o nome de nanociˆencia, e sua aplica¸c˜ao de nanotecnologia.
O dom´ınio da nanotecnologia encontra-se compreendido entre 0.1 a 100 nm, regi˜ao
onde as propriedades dos materiais s˜ao determinadas e podem ser controladas. Embora as ciˆencias dos ´atomos, mol´eculas e da mat´eria, desde a micro at´e `a macroestrutura j´a estejam bem estabelecidas e fundamentadas, a nanotecnologia ainda se encontra na sua fase inicial, visto que h´a muito a ser compreendido sobre o comportamento dos materiais
1Um dispositivo t´ıpico consiste de um substrato de Sitipo-n, coberto por uma camada deSiO
2 que
serve como isolante entre a superf´ıcie deSi(100) e um eletrodo met´alico (porta).
1.2 Nanotecnologia 6
em escala nanom´etrica [8, 9] (ver Fig. 1.5). A nanotecnologia desponta claramente como uma ´area de pesquisa e desenvolvimento muito ampla e multidisciplinar, uma vez que se baseia nos mais diversificados tipos de materiais (pol´ımeros, cerˆamicas, metais,
semi-condutores, biomateriais), estruturados em escala nanom´etrica. A habilidade de medir, manipular e organizar a mat´eria em nanoescala, e os novos fenˆomenos apresentados pelos materiais nanoestruturados, como aqueles causados pelo confinamento de tamanho, s˜ao descobertas cient´ıficas importantes que come¸cam a apontar para os poss´ıveis avan¸cos que
ser˜ao alcan¸cados pela ciˆencia num futuro pr´oximo.
Nos dias atuais, a nanotecnologia vem atraindo interesse de in´umeros grupos de pes-quisas em todo o mundo, devido ao seu enorme potencial de aplica¸c˜ao nos mais varia-dos setores industriais e ao impacto que seus resultavaria-dos podem dar ao desenvolvimento
tecnol´ogico e econˆomico, podendo at´e servir de base para um desenvolvimento local inte-grado e sustent´avel, conforme previsto nas Agendas 21 global e locais3. Neste contexto,
existe uma infinidade de ´areas onde a nanotecnologia pode oferecer uma contribui¸c˜ao significativa, algumas das quais j´a possuem produtos sendo comercializados. O Brasil
tem procurado n˜ao ficar fora do cen´ario internacional deste desenvolvimento tecnol´ogico, e o governo come¸cou um esfor¸co conjunto nesta ´area, em 2001, conhecido como Iniciativa Brasileira em Nanotecnologia, formando redes de pesquisas cooperativas neste tema, que conta com a participa¸c˜ao de v´arias institui¸c˜oes de pesquisa e ensino em todo o Pa´ıs. Em
muitos casos, estas institui¸c˜oes tˆem expandido suas fronteiras para se integrar a centros de excelˆencia em nanotecnologia nos Estados Unidos, na Europa, China, Am´erica Latina e no Jap˜ao.
O presente trabalho ´e um esfor¸co do Grupo de Pesquisa em Semicondutores do
Depar-tamento de P´os-Gradua¸c˜ao em F´ısica da Universidade Federal do Cear´a, o qual fez parte de uma destas redes de pesquisa, a Rede Cooperativa para Pesquisa em Nanodispositivos Semicondutores e Materiais Nanoestruturados (NanoSemiMat). A rede NanoSemiMat faz parte de uma estrat´egia de fomento `a pesquisa cooperativa iniciada pelo CNPq desde 2000,
e que culminou, em novembro de 2001, com a forma¸c˜ao de 4 redes tem´aticas associadas `a ´area de Nanociˆencia e Nanotecnologia. Atualmente, o Grupo faz parte da Rede Nacional de NanoBiotecnologia e Sistemas Nanoestruturados (NanoBioEstruturas). Nesta rede, o Grupo integra atividades em pesquisa b´asica e aplica¸c˜oes em semicondutores 0-3D, dando
ˆenfase `a integra¸c˜ao de semicondutores com materiais bio-orgˆanicos e novos ´oxidos para o desenvolvimento de biosensores e dispositivos optoeletrˆonicos.
1.2 Nanotecnologia 7
Macroes
trutura
+3 +2 +1 0 -1 -3 -5 -7 -9 -11
mm
mm nm Å -13 -15
Subatômica
Nível de estrutura Escala
1.000 m 1 m 1/1.000 m 1/1.000.000 m 1/1.000.000.000 m Diâmetro do átomo 1/1.000.000.000.000 m Diâmetro do núcleo atômico 1/1.000.000.000.000.000 m
microes
trutura
atômica
/cris
talográfica
Domíniodananotecnologia
(0,1-100nm)
Figura 1.5: (Esquerda) dimens˜oes representativas de algumas esp´ecies t´ıpicas, em suas v´arias es-calas. (Direita) regi˜ao de dom´ınio da nanotecnologia, comparada com uma faixa que compreende desde macroestruturas at´e dimens˜oes subatˆomicas (escala logar´ıtmica). Figuras retiradas das Referˆencias [8 e 9]
1.2.1
Importˆ
ancias e aplica¸c˜
oes
O crescente desenvolvimento tecnol´ogico e industrial caracter´ıstico do mundo globa-lizado traz consigo alguns problemas dif´ıceis de serem resolvidos. Um deles ´e a procura de uma alternativa economicamente vi´avel, respeitando os limites naturais, para a produ¸c˜ao e consumo de energia el´etrica. O aumento das necessidades energ´eticas da sociedade atual
e a importˆancia do impacto da pol´ıtica adotada para a sociedade e o meio ambiente, levam a optar por uma fonte de energia que possa suprir as necessidades da humanidade de forma inesgot´avel e servir de base para um desenvolvimento local integrado e sustent´avel.
A produ¸c˜ao e consumo de energia el´etrica, especialmente no Brasil, n˜ao vem
acompa-nhando o ritmo de desenvolvimento econˆomico nos ´ultimos anos, tendo como conseq¨uˆencias recentes oblack-out (apag˜ao) que se tornou uma realidade vivida pela sociedade brasileira. Desta forma, a energia el´etrica tem-se mostrado altamente relevante para o desenvolvi-mento da na¸c˜ao, e um caminho para amenizar os problemas relacionados `a gera¸c˜ao e
consumo de energia ´e a busca pelo uso de energias alternativas, bem como a utiliza¸c˜ao de dispositivos altamente eficientes.
Por um lado, a energia el´etrica obtida a partir da convers˜ao de energia solar vem ganhando destaque, no contexto atual em que os problemas ambientais se agravam, tendo
1.3 Dispositivos semicondutores: nanoestruturas 8
Figura 1.6: Fotos de alguns dispositivos constitu´ıdos de nanoestruturas semicondutoras e aplica¸c˜oes. Retirada do site http://www.intel.com (´ultimo acesso em junho de 2006).
que apresenta vantagens como f´acil armazenamento, baixo custo de instala¸c˜ao, baixo n´ıvel de agress˜ao ambiental e n˜ao necessita de linhas de transmiss˜ao que agridem o meio em que ´e instalado.
Por outro lado, uma forma de contornarmos o quadro ´e a busca de consumo econˆomico
da energia el´etrica, o que pode ser realizado atrav´es do desenvolvimento de dispositivos eletrˆonicos emissores de luz (lˆampadas para ilumina¸c˜ao, etc) e equipamentos eletrˆonicos constitu´ıdos de circuitos integrados altamente eficientes e econˆomicos (Fig. 1.6).
A produ¸c˜ao de dispositivos fotovoltaicos e dispositivos emissores de luz tem in´ıcio
invariavelmente na investiga¸c˜ao das propriedades ´opticas e eletrˆonicas dos materiais a serem empregados para cria¸c˜ao destes dispositivos, que se constituem de nanoestruturas semicondutoras. O seu entendimento te´orico requer a aplica¸c˜ao de teorias quˆanticas para o c´alculo das propriedades de confinamento, ´opticas e de transporte de portadores em
po¸cos, fios e pontos quˆanticos, em conjunto com as teorias do eletromagnetismo cl´assico.
1.3
Dispositivos semicondutores: nanoestruturas
1.3 Dispositivos semicondutores: nanoestruturas 9
provenientes de pesquisas multidisciplinares (que estabelecem um relacionamento entre as ´areas da f´ısica, qu´ımica, matem´atica, biociˆencias, ciˆencias de materiais, engenharia eletrˆonica e engenharia da computa¸c˜ao) e pelo desenvolvimento de novos conceitos sobre
dispositivos.
1.3.1
Bandas de energia
Algumas propriedades de el´etrons em cristais s˜ao fundamentais para a compreens˜ao
dos mecanismos respons´aveis pela corrente el´etrica no material semicondutor e, portanto, por sua aplica¸c˜ao na nanotecnologia. El´etrons em um ´atomo isolado ocupam estados quˆanticos estacion´arios, distribu´ıdos em n´ıveis de energia discretos e quantizados, corres-pondendo aos orbitais atˆomicos 1s, 2s, 3s, 3p,..., obedecendo ao Princ´ıpio de Exclus˜ao
de Pauli. Se trouxermos um ´atomo isolado para pr´oximo de outro, os n´ıveis de energia de cada ´atomo ser˜ao levemente perturbados devido `a presen¸ca do ´atomo vizinho. Al´em disso, um el´etron que est´a no n´ıvel 1s de um desses ´atomos tamb´em pode ocupar o n´ıvel 1s do outro ´atomo, possuindo duas fun¸c˜oes de onda distintas com a mesma energia, ou
degenerescˆencia dupla.
Se aproximarmos um grande n´umero de ´atomos, teremos tamb´em um grande n´umero de n´ıveis pr´oximos uns dos outros, e a intera¸c˜ao entre eles ocasionar´a uma quebra de degenerescˆencia, formando uma banda de energia quase cont´ınua. Em um sistema de
trˆes ´atomos, todos os n´ıveis s˜ao triplamente degenerados; com quatro ´atomos os n´ıveis apresentam degenerescˆencia de ordem quatro, e assim por diante. Se considerarmos N ´atomos pr´oximos, cada n´ıvel atˆomico ser´a expandido em N n´ıveis distintos.
Como conseq¨uˆencia do grande n´umero de ´atomos presentes em um cristal (N ∼1023)
e do arranjo peri´odico destes ´atomos formando a rede cristalina, os estados energ´eticos que descrevem o cristal se organizam de forma peculiar atrav´es do surgimento de faixas cont´ınuas destes estados, por´em limitadas e separadas umas das outras por faixas de energias proibidas. As faixas de energias permitidas s˜ao as chamadas bandas de energia.
`
As faixas de energias proibidas d´a-se o nome de gap, ver Fig. 1.7(a). Em um cristal, semicondutor apenas na temperatura T = 0 K, a ´ultima banda de energia, denominada
banda de valˆencia, est´a completamente cheia. Quando a temperatura aumenta, os el´etrons da banda de valˆencia ganham energia suficiente para passar `a banda seguinte,
1.3 Dispositivos semicondutores: nanoestruturas 10
Bandas de Energia
Gap Níveis
Discretos
Distânciarentre os átomos
Energ
ia
0
E
k
Banda de condução
Banda de valência
Eg
Ec
Ev
(a) (b)
EF
el
lh hh
Figura 1.7: (a) Forma¸c˜ao de bandas de n´ıveis de energia devido `a aproxima¸c˜ao dos ´atomos em um s´olido. (b) Bandas de valˆencia e condu¸c˜ao em semicondutores (as regi˜oes hachuriadas representam a ocupa¸c˜ao de el´etrons emT >0 K).
um material semicondutor, representado pelo gr´afico da energiaE versus o vetor de onda k. Isso ´e facilmente verificado, em primeira aproxima¸c˜ao, se utilizarmos como exemplo a energia de um el´etron livre, a qual ´e dada por
E = ~
2
2m0
k2, (1.1)
onde m0 ´e a massa do el´etron livre.
Os el´etrons na banda de condu¸c˜ao e os buracos na banda de valˆencia produzem cor-rente el´etrica sob a a¸c˜ao de um campo externo. A condutividade do material depende do n´umero de el´etrons que passa para a banda de condu¸c˜ao. Esse n´umero ´e tanto maior
1.3 Dispositivos semicondutores: nanoestruturas 11
1.3.2
Teoria da massa efetiva
Para entender as propriedades el´etricas de um material semicondutor ´e necess´ario estudar o comportamento de el´etrons dentro do material quando este ´e submetido a um campo el´etrico externo. O el´etron, descrito por um pacote de onda, movimenta-se em um cristal com velocidade de grupo vg = ∂ω/∂k e energia E = ~ω. Sendo assim, podemos
escrever4
∂E
∂k =~vg. (1.2)
Na presen¸ca do campo el´etrico, o el´etron ´e submetido a uma for¸ca F que realiza trabalho dE =F dx, variando a energia do el´etron de dE durante um percursodx. Logo, da Eq. 1.2, a velocidade do el´etron est´a relacionada `a for¸ca do campo el´etrico por
F dx=~vgdk, (1.3)
ou, aplicando a defini¸c˜ao dx=vgdt,
F =~dk
dt. (1.4)
Sendo ~k o momento do el´etron, a Eq. 1.4 representa o princ´ıpio fundamental da
dinˆamica:
F =m∗a =m∗dvg dt ,
F =m∗ µ
1
~
∂2E
∂k∂t ¶
=m∗ µ
1
~
∂2E
∂k2
¶ dk dt =m
∗
µ
1
~2
∂2E
∂k2
¶ F,
1 m∗ =
1
~2
∂2E
∂k2. (1.5)
As equa¸c˜oes acima mostram que o potencial da rede cristalina n˜ao afeta a forma da
equa¸c˜ao da varia¸c˜ao do momento. De fato, em lugar disto a rede altera a dependˆencia da energia com o momento, o que corresponde a mudar a massa do el´etron. Desta forma, sob
4Este item da tese foi baseado nas Referˆencias [10] e [12], sendo a primeira publicada em l´ıngua
1.3 Dispositivos semicondutores: nanoestruturas 12
a a¸c˜ao de uma for¸ca externa o el´etron no cristal age de forma semelhante a um el´etron livre, por´em com uma massa efetiva m∗ definida pela Eq. 1.5. Este resultado ´e v´alido
tamb´em para o el´etron livre, o que pode ser demonstrado atrav´es das Eqs. 1.1 e 1.5, onde
obtemosm∗ =m, ou seja, a massa efetiva ´e a pr´opria massa do el´etron livre.
Expandindo esse pensamento a uma estrutura de banda em um material, podemos definir a massa de um dado portador como uma fun¸c˜ao da curvatura da banda. Quanto mais cˆoncava for a banda, menor a massa associada a ela. Por outro lado, essas bandas
de energia em semicondutores freq¨uentemente exibem uma rela¸c˜ao anisotr´opica entre a energia e o vetor de onda, tal que a energia n˜ao ´e apenas uma fun¸c˜ao da magnitude do vetork, mas depende separadamente das dire¸c˜oes kx, ky ekz. Isto significa que a massa
efetiva depende da dire¸c˜aok. Na defini¸c˜ao mais geral, a massa efetiva n˜ao ´e uma grandeza
escalar e sim uma grandeza tensorial representada por uma matriz, cujo elementoµν para a banda n ´e determinado por:
µ
1 m∗
n
¶
µν
= 1
~2
∂2E nk ∂kµ∂kν
. (1.6)
Em geral, estes elementos n˜ao s˜ao constantes, mas fun¸c˜oes de kx, ky e kz. A massa
efetiva varia de um material para outro, j´a que o seu valor depende da curvatura das
bandas de energias do material.
A banda de valˆencia de alguns materiais semicondutores ´e formada por duas bandas de energia, cada qual associada a uma massa efetiva (buraco leve e pesado). A banda do buraco leve (light hole - lh) ´e a banda mais curva entre as duas e a banda do buraco pesado (heavy hole - hh) ´e a banda menos curva. Como os valores das massas efetivas est˜ao associados `a curvatura da banda, a massa associada ao buraco pesado ´e maior do que a massa associada ao buraco leve, originando os nomes leve e pesado, ver Fig. 1.7(b).
1.3.3
Confinamento de portadores
Em um semicondutor cristalino tridimensional, a estrutura eletrˆonica ´e caracterizada por estados eletrˆonicos deslocados e um espectro de energia quase-cont´ınuo nas bandas de condu¸c˜ao e valˆencia. Em nanoestruturas semicondutoras, quando os el´etrons est˜ao
1.3 Dispositivos semicondutores: nanoestruturas 13
Eg1
DEh
DEe
Eg2
Eg1
Eg2
(b)
(a)
DEe
DEh
z
r,
r
Figura 1.8: Perfis de potenciais de confinamento de portadores em nanoestruturas. Em (a) perfil de confinamento de um po¸co quˆantico e em (b) perfil do potencial de confinamento de um fio ou ponto quˆantico.
e formam mini-bandas em sistemas 1D e 2D5.
O efeito de confinamento quˆantico est´a presente em muitos sistemas de baixa dimen-sionalidade, como po¸cos, fios e pontos quˆanticos, os quais s˜ao crescidos por avan¸cadas t´ecnicas epitaxiais em nanocristais produzidos por m´etodos qu´ımicos ou por implanta¸c˜ao
iˆonica, ou nanodispositivos produzidos por t´ecnicas de litografia. A escala de compri-mento desses dispositivos ´e da ordem do compricompri-mento de onda de Broglie do portador [16], que assume um comportamento ondulat´orio. Por isso, a equa¸c˜ao de Schr¨odinger pode ser aplicada para descrever suas propriedades eletrˆonicas e ondulat´orias no dispositivo.
Quando o potencial de confinamento (∆E(r)) for maior que a energia En do portador,
ent˜ao estas energiasEn do portador ser˜ao confinadas e quantizadas. O potencial ∆E(r)
pode confinar o portador em uma, duas ou trˆes dimens˜oes, correspondendo aos sistemas po¸cos, fios ou pontos quˆanticos, respectivamente. A quantiza¸c˜ao da energia ´e
acompa-nhada pela limita¸c˜ao do movimento do portador na dire¸c˜ao em que o mesmo ´e confinado. Desta forma, os portadores est˜ao limitados a mover-se no plano de um po¸co quˆantico, na linha de um fio quˆantico ou em ilhas em pontos quˆanticos. Fios quˆanticos tamb´em s˜ao chamados de nanofios, e pontos quˆanticos s˜ao comumente denominados ´atomos artificiais,
pois tais como ´atomos, as energias dos el´etrons s˜ao quantizadas e a carga total ´e restrita a um pequeno n´umero inteiro de el´etrons [16].
O potencial de confinamento origina-se a partir da fra¸c˜ao da diferen¸ca entre os gaps de energia dos materiais semicondutores que formam a heterojun¸c˜ao. A grandeza desta
fra¸c˜ao denomina-se band-off-set e sua determina¸c˜ao ´e um dos problemas importantes da
1.3 Dispositivos semicondutores: nanoestruturas 14
f´ısica de sistemas semicondutores de dimensionalidade reduzida6. A Fig. 1.8 ilustra dois
perfis de confinamento de portadores para po¸co, fio e ponto quˆantico. A diferen¸ca entre o gapEg1 e o gapEg2 ´e igual `a soma dos potenciais:
Eg1−Eg2 = ∆Ee+ ∆Eh, (1.7)
onde ∆Ee´e o potencial de confinamento de el´etrons, que surge devido ao n˜ao alinhamento
das bandas de condu¸c˜ao dos materiais que constituem a heterojun¸c˜ao, e ∆Eh´e o potencial
de confinamento de buracos, que surge devido ao n˜ao alinhamento das bandas de valˆencia. Para obter os valores de ∆Ee e ∆Eh pode-se usar a rela¸c˜ao:
∆Ee+ ∆Eh
∆Ee+ ∆Eh
= ∆Ee
∆Ee+ ∆Eh
+ ∆Eh
∆Ee+ ∆Eh
= 1. (1.8)
A soma ∆Ee+ ∆Eh ´e dada pela Eq. 1.7. O band-off-set pode ser definido por
Qe=
∆Ee
Eg1−Eg2
, (1.9)
Qh =
∆Eh
Eg1−Eg2
, (1.10)
ondeQe e Qh representam oband-off-set de condu¸c˜ao e valˆencia, respectivamente. Desta
forma, obtemos os potenciais de confinamento de el´etrons e buracos isolando ∆Eee ∆Eh:
∆Ee =Qe(Eg1 −Eg2), (1.11)
∆Eh =Qh(Eg1−Eg2). (1.12)
Se a nanoestrutura for constitu´ıda de uma fina camada de semicondutor, crescida por epitaxia entre duas camadas de ´oxido (ou um outro semicondutor com propriedades f´ısicas diferentes), conforme ilustra a Fig. 1.9, ent˜ao o potencial ∆Ei(z) confina o portador i
(i = e, h) em apenas uma dire¸c˜ao (dire¸c˜ao z da figura), e a nanoestrutura formada ´e
1.3 Dispositivos semicondutores: nanoestruturas 15
y
z x
kxy
GaN
HfO2
2 2 2
xy x y
k =k +k
Figura 1.9: Estrutura f´ısica de um po¸co quˆantico deGaN/Hf O2 e representa¸c˜ao do movimento de um portador no plano do po¸co. Figura reproduzida a partir da Referˆencia [15].
chamada de po¸co quˆantico. No po¸co quˆantico o portador tem movimento restrito na dire¸c˜ao de crescimento, dire¸c˜ao z da Fig. 1.9, mas pode-se mover no plano do po¸co. Neste caso, o movimento do portador pode ser descrito pela equa¸c˜ao de Schr¨odinger
independente do tempo
− ~
2
2m µ
∂2
∂x2 +
∂2
∂y2 +
∂2
∂z2
¶
ψ(x, y, z) + ∆E(r)ψ(x, y, z) = Eψ(x, y, z). (1.13)
O potencial de confinamento ∆E(r) pode ser representado por uma soma de fun¸c˜oes independentes, ou seja, ∆E(r) = ∆E(x) + ∆E(y) + ∆E(z), sendo que a condi¸c˜ao para forma¸c˜ao de um po¸co quˆantico estabelece que podemos considerar ∆E(x) = ∆E(y) = 0,
e que auto-fun¸c˜ao do sistema seja escrita como o produto:
ψ(x, y, z) = ψ(x)ψ(y)ψ(z). (1.14)
Usando a Eq. 1.14 para reescrever a equa¸c˜ao de Schr¨odinger (Eq. 1.13), ent˜ao:
− ~
2
2m µ
∂2ψ(x)
∂x2 ψ(y)ψ(z) +
∂2ψ(y)
∂y2 ψ(x)ψ(z) +
∂2ψ(z)
∂z2 ψ(x)ψ(y)
¶
+∆E(z)ψ(x)ψ(y)ψ(z) =Eψ(x)ψ(y)ψ(z). (1.15)
Desta forma ´e poss´ıvel identificar trˆes contribui¸c˜oes distintas para a energia cin´etica total E do portador, uma para cada dire¸c˜ao perpendicular dos eixos x, y e z, isto ´e,
1.3 Dispositivos semicondutores: nanoestruturas 16
de movimento para cada um dos eixos:
− ~
2
2m
∂2ψ(x)
∂x2 ψ(y)ψ(z) = Exψ(x)ψ(y)ψ(z), (1.16)
−~
2
2m
∂2ψ(y)
∂y2 ψ(x)ψ(z) =Eyψ(x)ψ(y)ψ(z), (1.17)
−~
2
2m
∂2ψ(z)
∂z2 ψ(x)ψ(y) + ∆E(z)ψ(x)ψ(y)ψ(z) =Ezψ(x)ψ(y)ψ(z), (1.18)
ou, ap´os uma divis˜ao:
−~
2
2m
∂2ψ(x)
∂x2 =Exψ(x), (1.19)
−~
2
2m
∂2ψ(y)
∂y2 =Eyψ(y), (1.20)
−~
2
2m
∂2ψ(z)
∂z2 + ∆E(z)ψ(z) =Ezψ(z). (1.21)
A Eq. 1.21 ´e a equa¸c˜ao de Schr¨odinger que descreve o movimento unidimensional de um portador confinado em um potencial ∆E(z). As demais equa¸c˜oes, Eq. 1.19 e Eq. 1.20, descrevem o movimento unidimensional, na dire¸c˜ao de cada coordenada (x e y),
respectivamente. A solu¸c˜ao para estas duas equa¸c˜oes ´e do tipo exp(ikxx), ent˜ao:
ψ(x) = exp(ikxx), (1.22)
com
~2kx2
2m∗ =Ex, (1.23)
1.3 Dispositivos semicondutores: nanoestruturas 17
E
z
n = 1
n = 2
2 2 ,
2 *
x y
k
E En
m
= +h
2 2 2
xy x y
k =k +k
Figura 1.10: Diagrama esquem´atico das curvas de dispers˜ao (kx,y) no plano xy e estrutura subbanda. Figura reproduzida a partir da Referˆencia [15].
do eixo x. Uma equa¸c˜ao similar a esta ´ultima representa a energia cin´etica do portador na dire¸c˜ao do eixo y e, desta forma, o movimento no plano de um portador confinado,
devido a um potencial unidimensional, pode ser escrito na forma
ψx,y(x, y) =
1
Aexp [i(kxx+kyy)], (1.24)
e
Ex,y =
~2¯¯kx2+k2y¯¯
2m∗ . (1.25)
Logo, enquanto a solu¸c˜ao da equa¸c˜ao de Schr¨odinger ao longo do eixo de confinamento produz estados de energia discretos Ez = En, no plano do po¸co quˆantico semicondutor
existe uma extens˜ao cont´ınua de energias permitidas, conforme ilustra a Fig. 1.10.
Em um material cristalino tridimensional os portadores est˜ao distribu´ıdos em bandas de energia, ao passo que em um po¸co quˆantico os portadores ocupam n´ıveis confinados em subbandas de energia. Portanto, o efeito de confinamento unidimensional produz uma redu¸c˜ao no grau de liberdade, restringindo o momento do portador de trˆes para duas
dimens˜oes. Por esta raz˜ao, os estados em um po¸co quˆantico s˜ao geralmente referidos como bidimensionais. Em resumo, em um po¸co quˆantico, a energia total do el´etron ou buraco de massam∗ ´e igual a E
z+Ex,y, a qual ´e definida por:
E =En+
~2¯¯kx2+k2y¯¯
1.4 Excitons em nanoestruturas 18
A descri¸c˜ao do movimento de portadores em fios e pontos quˆanticos foge ao obje-tivo do presente trabalho. Portanto, n˜ao ser´a abordada nesta tese tal descri¸c˜ao, a qual pode ser encontrada no trabalho proposto na disserta¸c˜ao de mestrado apresentada ao
Departamento de F´ısica da Universidade Federal do Cear´a no ano de 2005, ver Ref. [17].
1.4
Excitons em nanoestruturas
A caracteriza¸c˜ao ´optica de um semicondutor nos fornece informa¸c˜oes importantes
so-bre suas propriedades eletrˆonicas. Em muitos semicondutores, os f´otons7 podem interagir
com a vibra¸c˜ao da rede cristalina, fˆonons8, e/ou com el´etrons localizados em impurezas.
Esta intera¸c˜ao faz das caracteriza¸c˜oes ´opticas uma ferramenta importante para estudar
excita¸c˜oes e forma a base de muitas aplica¸c˜oes tecnol´ogicas como lasers, diodos emissores de luz e fotodetectores [15, 18, 19].
Se um f´oton incide sobre um semicondutor tridimensional, de gap Eg da mesma ordem de grandeza da energia do f´oton hω ∼ Eg, ent˜ao o f´oton pode ser absorvido por
um el´etron, o qual poder´a mover-se no corpo do cristal semicondutor. Se a energia do f´oton for maior que a energia do gap, ent˜ao ´e criado um el´etron na banda de condu¸c˜ao, e um estado vazio ´e deixado na banda de valˆencia. Este estado vazio, denominado de buraco, comporta-se como uma part´ıcula de carga positiva e, conseq¨uentemente, produz
uma intera¸c˜ao coulombiana atrativa com o el´etron na banda de condu¸c˜ao. O potencial atrativo reduz a energia total do el´etron e do buraco na ordem deEb (energia de liga¸c˜ao
entre o el´etron e o buraco). A este par el´etron-buraco d´a-se a denomina¸c˜ao deexciton, ver Fig. 1.11.
A massa do buraco ´e geralmente maior que a massa do el´etron, de forma que o sistema de dois corpos, no material tridimensional, assemelha-se ao ´atomo de hidrogˆenio, com a carga negativa orbitando a carga positiva. Tipicamente, os excitons s˜ao estudados em dois casos limite, que se caracterizam atrav´es da forma de intera¸c˜ao entre o el´etron e o
buraco. Para uma atra¸c˜ao forte entre o par el´etron-buraco, como encontrado em cristais iˆonicos, el´etron e buraco est˜ao firmemente ligados um ao outro. Esta forma de excita¸c˜ao ´e denominada de exciton de Frenkel [20, 21]. Por outro lado, existe uma outra forma de intera¸c˜ao el´etron-buraco do tipo fraca, como encontrado em semicondutores, em que a
intera¸c˜ao coulombiana ´e blindada por el´etrons de valˆencia, via uma constante diel´etrica
7Part´ıcula elementar associada ao campo eletromagn´etico, com massa nula,spin1, carga el´etrica nula,
est´avel, e cuja energia ´e igual ao produto da constante de Planck pela freq¨uˆencia do campo (hω); quantum de luz.
8Part´ıcula hipot´etica, importante no tratamento te´orico da condutividade t´ermica nos s´olidos, e que
1.4 Excitons em nanoestruturas 19
Excitação de alta energia
Formação de exciton Excitação resonante
E
bFigura 1.11: Representa¸c˜ao esquem´atica de gera¸c˜ao de excitons. Figura reproduzida a partir da Referˆencia [15].
elevada. Esta forma de excita¸c˜ao ´e denominada de exciton de Wannier-Mott9 [22, 23],
ver Fig. 1.12.
O exciton ´e relativamente est´avel, e pode ter um tempo de vida m´edia relativa-mente longo, da ordem de centenas de ps a ns. A recombina¸c˜ao de excitons ´e um efeito importante para fotoluminescˆencia a baixa temperatura, embora as energias de liga¸c˜ao sejam relativamente baixas, da ordem de algumas unidades de meV a dezenas de meV.
Quando submetidos a altas temperaturas os excitons tendem a dissociar-se.
Em heteroestruturas (po¸co, fio e pontos quˆanticos), assim como em materiais tri-dimensionais, a forma¸c˜ao de excitons pode ocorrer por meio de excita¸c˜oes ressonantes. Considerando que a energia total do exciton em um semicondutor cristalino
tridimensio-nal ´e simplesmente a energia de liga¸c˜aoEb do par el´etron-buraco, mais a energia do gap
Eg, em uma heteroestrutura existem duas componentes adicionais devido `as energias de confinamento do el´etron e do buraco, ou seja:
E =Eg−Eb, (1.27)
´e a energia total de um exciton em um cristal semicondutor tridimensional, e
E =Eg+Ee+Eh− |Eb|, (1.28)
´e a energia total de um exciton confinado em uma heteroestrutura.
A energia total do exciton ´e claramente uma fun¸c˜ao da estrutura quˆantica. Isto se
1.5 Impurezas em nanoestruturas 20
h e
Exciton de Wannier-Mott
(a)
Exciton de Frenkel
(b)
Figura 1.12: (a) Representa¸c˜ao esquem´atica de um par el´etron-buraco, firmemente ligado, formando um exciton de Frenkel. (b) Representa¸c˜ao esquem´atica de um par el´etron-buraco, fracamente ligado, formando um exciton de Wannier-Mott. Figura reproduzida a partir da Referˆencia [19].
deve ao fato de que a energia total do exciton depende da energia de confinamento, a qual varia de acordo com o grau de liberdade dos portadores. A energia de liga¸c˜ao, devido `a
intera¸c˜ao Coulombiana do par el´etron-buraco, tamb´em depende do grau de liberdade dos portadores, ou seja, do tipo da estrutura confinante.
1.5
Impurezas em nanoestruturas
A habilidade de introduzir impurezas em uma rede cristalina foi o avan¸co tecnol´ogico mais importante no desenvolvimento dos semicondutores como mat´eria prima para a ind´ustria eletrˆonica. Isto permitiu que as propriedades eletrˆonicas dos semicondutores
servissem `as necessidades da engenharia. ´Atomos que s˜ao introduzidos em uma rede cris-talina com um el´etron a mais do que o requerido para a liga¸c˜ao qu´ımica com os ´atomos vizinhos da rede s˜ao facilmente ionizados, doando el´etrons para rede cristalina. Tais ´atomos recebem a denomina¸c˜ao deimpurezas doadoras, Fig. 1.13(a). ´Atomos que s˜ao
introduzidos na rede cristalina com um el´etron a menos do que ´e requerido para liga¸c˜ao qu´ımica com os ´atomos vizinhos geram estados vazios na banda de valˆencia (buracos). Tais ´atomos foram denominados deimpurezas aceitadoras, Fig. 1.13(b). Estes buracos movem-se na rede cristalina e podem contribuir para a condutividade el´etrica do
1.5 Impurezas em nanoestruturas 21 As+ Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si e -Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si
Banda de Valência
Banda de Condução
E
cE
v Eg Ga -Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si h+ Si Si Si Si Si Si Si Si Si Si Si Si Si Si Si SiBanda de Valência
Banda de Condução
E
cE
vEg
(a) Impurezas doadoras
(b) Impurezas aceitadoras
Figura 1.13: Esquerda: modelo esquem´atico de um Cristal de Si dopado com impurezas substitucionais Ga (aceitador) e As (doador). Direita: representa¸c˜ao esquem´atica dos n´ıveis de impurezas no gap de semicondutores dopados. Ec e Ev representam as energias m´ınimas e m´aximas das bandas de condu¸c˜ao e valˆencia, respectivamente. Figura reproduzida a partir da Referˆencia [10].
aceitadoras leva `a constru¸c˜ao de uma jun¸c˜aop−n, a qual foi a base do primeiro transistor a ser fabricado: o Transistor de Jun¸c˜ao Bipolar (TJB).
Impurezas num cristal modificam o potencial eletrost´atico nas suas vizinhan¸cas, que-brando a simetria de transla¸c˜ao do potencial peri´odico. Essa perturba¸c˜ao pode produzir
fun¸c˜oes de onda eletrˆonicas que s˜ao localizadas nas proximidades da impureza, deixando de ser propagantes em todo o cristal. As energias dessas fun¸c˜oes de onda s˜ao obtidas atrav´es da equa¸c˜ao de Schr¨odinger, resolvida para o potencial da impureza. Essas ener-gias aparecem na forma de n´ıveis discretos que podem estar situados entre as bandas do
cristal perfeito.
1.5 Impurezas em nanoestruturas 22
D
e
-e
-D
D
e
-(a)
e
-D D
e
-D
e
-(b)
Figura 1.14: (a) Representa¸c˜ao esquem´atica do efeito da largura do po¸co quˆantico sobre a fun¸c˜ao de onda do portador. (b) Representa¸c˜ao esquem´atica do efeito da posi¸c˜ao de impureza sobre a fun¸c˜ao de onda do portador. Figura reproduzida a partir da Referˆencia [15].
complexa que o caso sem confinamento, devido `a limita¸c˜ao no movimento do portador, em dois graus de liberdade, imposta pela barreira de potencial. Primeiro porque a energia de liga¸c˜ao do portador (el´etron-impureza) depende do potencial de confinamento do po¸co
quˆantico. Na forma mais simples, isto pode ser representado atrav´es do efeito que a largura do po¸co causa sobre a fun¸c˜ao de onda do portador (Fig. 1.14(a)). A energia de liga¸c˜ao do portador ser´a diferente em um po¸co quˆantico duplo e em uma superrede. Em segundo lugar, a energia de liga¸c˜ao e a fun¸c˜ao de onda do portador dependem da
posi¸c˜ao que a impureza ocupa dentro do po¸co quˆantico. Quando a impureza ocupa a posi¸c˜ao central do po¸co quˆantico, a energia de liga¸c˜ao e a fun¸c˜ao de onda do portador s˜ao diferentes da energia de liga¸c˜ao e da fun¸c˜ao de onda do portador quando a impureza ocupa uma posi¸c˜ao pr´oxima a uma das interfaces do po¸co quˆantico, conforme ilustra a
Fig. 1.14(b).
O entendimento te´orico de nanoestruturas com uma impureza inserida requer a aplica-¸c˜ao de teorias quˆanticas para o c´alculo das propriedades eletrˆonicas, ´opticas e de trans-porte de po¸cos, fios e pontos quˆanticos, em conjunto com as teorias do eletromagnetismo
cl´assico. Em alguns casos, se faz necess´ario o uso de m´etodos computacionais sofisticados para solu¸c˜ao das equa¸c˜oes de Schr¨odinger e Poisson atrav´es de m´etodos auto-consistentes, como foi mostrado em disserta¸c˜ao de mestrado apresentada ao Departamento de F´ısica da Universidade Federal do Cear´a, ver Ref. [24]. Em outros casos, necessita apenas ser
1.6 Diel´etricos em nanoestruturas 23
um termo coulombiano adicional que represente o potencial da impureza. O Hamilto-niano para um el´etron confinado em uma nanoestrutura, consistente com a aproxima¸c˜ao da massa efetiva e a fun¸c˜ao envelope, na presen¸ca de uma impureza, ´e o Hamiltoniano
padr˜ao para um el´etron confinado em um po¸co quˆantico simples mais o termo devido `a intera¸c˜ao coulombiana, ou seja:
H =− ~
2
2m∗∇
2+ ∆E(z)
− e
2
4πεr, (1.29)
onde e representa a carga do el´etron e r ´e a posi¸c˜ao do el´etron com rela¸c˜ao `a impureza, definida por:
r2 =x2+y2+ (z−rd)2, (1.30)
onde rd representa a posi¸c˜ao da impureza ao longo da dire¸c˜ao z de crescimento do po¸co
quˆantico. Por conveniˆencia, ´e considerado nesta equa¸c˜ao que a posi¸c˜ao da impureza coincide com a origem do plano xy. Note-se tamb´em que a massa efetiva ´e considerada constante na Eq. 1.21 para simplificar a an´alise do sistema.
M´etodos de solu¸c˜ao da equa¸c˜ao de Schr¨odinger tˆem focado basicamente dois tipos de
aproxima¸c˜oes. A primeira destas aproxima¸c˜oes baseia-se na expans˜ao da fun¸c˜ao de onda do el´etron como uma combina¸c˜ao linear de fun¸c˜oes Gaussianas [25, 26]. Esta t´ecnica pos-sui uma boa aproxima¸c˜ao para calcular propriedades de impurezas em po¸cos quˆanticos simples. A generaliza¸c˜ao desta t´ecnica para estruturas mais complexas n˜ao ´e,
entre-tanto, trivial. A segunda aproxima¸c˜ao baseia-se no princ´ıpio variacional. Neste m´etodo ´e escolhida uma fun¸c˜ao de onda cuja forma funcional possa conter um ou mais parˆametros, que s˜ao obtidos minimizando a energia do n´ıvel eletrˆonico. Embora estes sejam os m´etodos comumente usados na literatura, neste trabalho ser´a aplicado um m´etodo para solucionar
a equa¸c˜ao de Schr¨odinger dependente do tempo que se baseia em propaga¸c˜ao no tempo imagin´ario.
1.6
Diel´
etricos em nanoestruturas
A fabrica¸c˜ao de nanodispositivos requer usualmente a combina¸c˜ao de semicondutores com metais, isolantes e mol´eculas em um pequena regi˜ao do espa¸co. O comportamento destes sistemas depende fortemente de aplica¸c˜ao de campo el´etrico, e muitos problemas
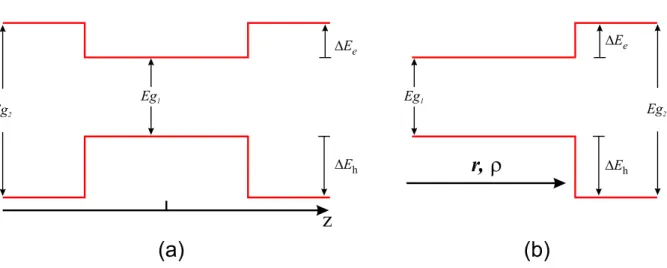
![Figura 1.11: Representa¸c˜ ao esquem´atica de gera¸c˜ ao de excitons. Figura reproduzida a partir da Referˆencia [15].](https://thumb-eu.123doks.com/thumbv2/123dok_br/15346034.560865/36.892.215.722.138.348/figura-representa-esquem-excitons-figura-reproduzida-partir-referˆencia.webp)