Dissertação de Mestrado
“
Produção de filmes de Silício por evaporação
reativa assistida por Plasma
”
Autor: Diego Oliveira Miranda
Orientador: Prof. José Roberto Tavares Branco
Diego Oliveira Miranda
“Produção de filmes de Silício por evaporação reativa
assistida por Plasma”
Dissertação de Mestrado apresentada ao Programa de Pós-Graduação em Engenharia de Materiais da REDEMAT, como parte integrante dos requisitos para a obtenção do título de Mestre em Engenharia de Materiais.
Área de concentração: Engenharia de Superfícies
Orientador: Prof. José Roberto Tavares Branco
II
Miranda, Diego Oliveira Miranda
S586a Produção de filmes de Silício por evaporação reativa assistida por Plasma/
Diego Oliveira Miranda. – Ouro Preto: UFOP, 2011. 86p. : il., grafs., tabs., fotos.
Dissertação (Mestrado) – Universidade Federal de Ouro Preto. Rede Temática em Engenharia de Mate- rias.
a-Si:H.2.nc-Si:H. 3. Evaporação Reativa. 3. Espectroscopia de emissão óptica. 4. Propriedades estruturais e ópticas. I. Universidade Federal de Ouro Preto. Rede Temática em Engenharia de Materiais. II. Título. CDU: 620.1
IV
AGRADECIMENTO
Em primeiro lugar a Deus princípio e autor da vida;
A minha esposa Desirée pela paciência nas ausências e apoio constante. Aos meus pais e irmã;
Ao meu orientador José Roberto T. Branco;
A todos os amigos do centro cultural Mangabeiras;
Ao amigo Thiago Daniel de Oliveira Moura pelas discussões e noites sem dormir; Pelos incentivos dos colegas do Instituto Federal Minas Gerais.
A Eng. Milena Emerenciano Luz Sabino e a Profa. Vivienne Denise Falcão.
A todos que contribuíram de alguma forma para minha formação neste caminho: Professores da graduação, de orientação nas iniciações científicas e do mestrado, pelos cursos realizados no âmbito de formação da RECONPLASMA – CETEC – ITA – UFRN;
V
SUMÁRIO
AGRADECIMENTO ... iv
SUMÁRIO ... v
LISTA DE FIGURAS ... vii
LISTA DE TABELA ... x
LISTA DE SÍMBOLOS ... xi
RESUMO ... xii
1 INTRODUÇÃO ... 14
2 OBJETIVOS ... 17
2.1 Objetivo Geral ... 17
2.2 Objetivos Específicos ... 17
3 Revisão Bibliográfica ... 18
3.1 Células Solares ... 18
3.2 Células tipo HSJ (Heterojunção de Silício) ... 19
3.3 Células polimórficas ... 20
3.4 Filmes Amorfos aplicados a Células Solares ... 22
3.5 Defeitos em materiais amorfos ... 24
3.6 Filmes nanocristalinos aplicados a Células Solares ... 25
3.7 Defeitos em materiais nanocristalinos ... 26
3.8 Propriedades Ópticas de filmes amorfos e nanocristalinos... 27
3.9 Composição ... 30
3.10 Propriedades estruturais ... 33
3.11 Evaporação reativa assistida por plasma ... 36
4 MATERIAIS E MÉTODOS ... 39
4.1 Sistema de deposição BAI 640 R ... 39
4.2 Caracterização dos filmes ... 41
4.2.1 Medidas de espessura ... 41
4.2.2 Caracterização de Filme de Silício por FTIR (composição) ... 42
4.2.3 Raman ... 43
4.2.4 Espectroscopia do Uv-Visível ... 44
5 RESULTADOS E DISCUSSÃO ... 46
VI
5.2 Efeito da temperatura e porcentagem de Hidrogênio na composição dos filmes ... 54
5.3 Influência da composição e da estrutura nas propriedades ópticas ... 59
6 CONCLUSÕES ... 69
7 SUGESTÕES DE TRABALHOS FUTUROS ... 70
8 REFERÊNCIAS ... 71
VII
LISTA DE FIGURAS
Figura 3-1 Esquema das partes básicas de uma célula mostrando os movimentos das cargas na
junção [11]. ... 18
Figura 3-2(a) Movimento dos portadores de cargas na junção exposta à luz. (b) Geração corrente da corrente de curto circuito no dispositivo [12]. ... 19
Figura 3-3 Esquema de uma célula HIT[14]. ... 19
Figura 3-4 Imagem de uma célula HSJ feita por microscopia de transmissão. HRTEM [16]. ... 20
Figura 3-5 Esquema de uma célula “polimórfica” que utiliza tanto filme amorfo quanto microcristalino (a) Resposta espectral da célula com a contribuição distinta de a-Si:H e µc-Si:H (b) [18]. ... 21
Figura 3-6 Evolução da eficiência de células com o tempo de exposição à luz utilizando exclusivamente filmes amorfos ou microcristalino [20]... 22
Figura 3-7 a) Absorção de fóton em um semicondutor com band gap direto b) Absorção de fóton em um semicondutor com band gap indireto assistido por absorção de fônon e c) Absorção de fóton em um semicondutor com band gap indireto assistido por emissão de fônon.[10]. ... 23
Figura 3-8 Representação esquemática do diagrama de bandas para um semicondutor amorfo[25]. .. 24
Figura 3-9 Curvas do coeficiente de absorção para a-Si:H, nc-Si:H e c-Si[38]. ... 27
Figura 3-10 Curva típica para cálculo do band gap de Tauc para material amorfo (a), e para filmes com alguma fração cristalina (b)[40]. ... 29
Figura 3-11 Coeficiente de absorção em função da energia com a indicação da região que indica a densidade de estados[15]. ... 29
Figura 3-12 Exemplo de espectro de infravermelho para filmes de silício hidrogenado (a) -PACVD) e (b) -HWCVD[42]. ... 31
Figura 3-13 Espectros Raman para diferentes quantidades de hidrogênio em um processo PACVD [25] ... 33
Figura 3-14 Esquema representativo do modelo de recozimento Químico para crescimento de filmes de Silício[51]. ... 35
Figura 3-15 Representação do crescimento de cristalitos em filmes de silício e o aumento da rugosidade[61] ... 35
Figura 3-16 Esquema de um reator de evaporação por e-beam assistido por plasma. ... 36
Figura 3-17 Curvas de absorção para filmes produzidos por evaporação reativa na presença de diferentes porcentagens de Hidrogênio[69]. ... 38
Figura 4-1 Esquema geral do reator BAI 640 R. ... 39
4-2 Esquema da câmara de ionização do reator BAI 640. ... 40
Figura 4-3(a) Foto do interior do reator BAI 640. (b) Detalhe do cadinho envolto em plasma durante o processo de deposição. ... 40
Figura 4-4 Perfilômetro Taylor Hobson. ... 42
Figura 4-5 FTIR Bomen FTLA 2000. ... 43
Figura 4-6 RENISHAW série inVia. ... 43
VIII Figura 5-1 Espectro Raman para filmes produzidos a temperatura de 180°C e variação de hidrogênio de 20,40 e 60 %. ... 47 Figura 5-2 Espectro Raman para filmes produzidos a temperatura de 220°C e variação de hidrogênio de 20,30,40 e 60 % além do espectro de um c-Si. ... 47 Figura 5-3 Espectro Raman para filmes produzidos a temperatura de 300°C e variação de hidrogênio de 20,40 e 60 % além do espectro de um c-Si. ... 48 Figura 5-4- Deconvolução dos espectros Raman para os filmes produzidos a 180°C com 20,40 e 60 % de Hidrogênio no reator... 49 Figura 5-5- Deconvolução dos espectros Raman para os filmes produzidos a 220°C com 20,30,40 e 60 % de Hidrogênio no reator ... 50 Figura 5-6 Deconvolução dos espectros Raman para os filmes produzidos a 300°C com 20, 40 e 60 % de Hidrogênio no reator... 51 Figura 5-7 Fração Cristalina em função da temperatura para 20,30 e 40 % de hidrogênio na câmara51 Figura 5-8 Tamanho médio de grão em função da porcentagem de hidrogênio para 220 °C e 300°C 53 Figura 5-9 Tamanho médio de grão em função da fração cristalina ... 53 Figura 5-10 Espectro de infravermelho na região indicativa das ligações Si-H para amostras produzidas a 180°C e porcentagens de hidrogênio de 20, 40 e 60 %. ... 54 Figura 5-11 Deconvolução dos espectros de Infravermelho para os filmes produzidos a 180°C com 20, 40 e 60 % de Hidrogênio no reator. ... 55 Figura 5-12 Espectro de infravermelho na região indicativa das ligações Si-H para filmes produzidos a 220°C e porcentagens de hidrogênio de 20, 30,40 e 60 %. ... 56 Figura 5-13 Deconvolução dos espectros de infravermelho para os filmes produzidos a 220°C com 20,30, 40 e 60 % de Hidrogênio no reator. ... 57 Figura 5-14 Espectro de infravermelho na região indicativa das ligações Si-H para filmes produzidos a 300°C e porcentagens de hidrogênio de 20,40 e 60 %. ... 58 Figura 5-15 Efeito da temperatura na incorporação de hidrogênio em filmes produzidos a 20,40 e 60 % de hidrogênio na câmara... 58 Figura 5-16 Efeito da temperatura no fator de microestrutura para 20,30 e 40 % de Hidrogênio na câmara. ... 59
Figura 5-17 Coeficiente de absorção em função da energia do fóton das amostras produzidas a 180°C e porcentagens de hidrogênio de 20, 40 e 60 %. ... 60
Figura 5-18 Densidade de estados em função da porcentagem de hidrogênio incorporada ao filme (%Hf). ... 61
Figura 5-19 Curvas (αE)1/2x E para filmes produzidos a 180°C com as respectivas estrapolações da região linear. ... 62 Figura 5-20 – Efeito do hidrogênio incorporado ao filme no valor do band gap óptico (Eg). ... 63
Figura 5-21 Coeficiente de absorção em função da energia do fóton das amostras produzidas a 220°C e porcentagens de hidrogênio de 20, 30, 40 e 60 % ... 64 Figura 5-22 Efeito do hidrogênio incorporado ao filme no valor da densidade de defeitos. ... 65
IX Figura 5-24 Efeito do hidrogênio incorporado ao filme no valor do band gap. ... 66 Figura 5-25 Coeficiente de absorção em função da energia do fóton das amostras produzidas a 300°C e porcentagens de hidrogênio de 20, 40 e 60 %. ... 67 Figura 5-26 Curvas (αE)1/2 x Energia para filmes produzidos a 300°C com as respectivas
X
LISTA DE TABELA
Tabela 4-I Parâmetros mantidos constantes no processo. ... 41 Tabela 4-II Parâmetros Utilizados nas medidas Raman ... 43 Tabela 5-I Valores das temperaturas e porcentagens de hidrogênio (%H2) injetadas no reator ... 46
Tabela 5-II Valores de Xc para as diferentes temperaturas e composições da atmosfera do reator. .. 52 Tabela 5-III Valores de %Hf e R*para os filmes depositados a 180°C e as diferentes composições da
atmosfera do reator. ... 55 Tabela 5-IV Tabela com porcentagem de Hidrogênio e fator de microestrutura ... 57 Tabela 5-V Valores de %Hf, Ns e band gap para filmes depositados a 180°C e as diferentes
composições da atmosfera do reator. ... 63 Tabela 5-VI Valores de Xc,Ns e band gap para filmes depositados a 220°C e as diferentes composições da atmosfera do reator. ... 67 Tabela 5-VII Valores de %Hf, Xc e band gap para filmes depositados a 300°C e as diferentes
XI
LISTA DE SÍMBOLOS
CETEC - Fundação Centro Tecnológico do Estado de Minas Gerais ANEEL - Agência Nacional de Energia Elétrica
ITA - Instituto de Tecnologia Aeronáutica
UFRN - Universidade Federal do Rio Grande do Norte UDESC - Universidade do Estado de Santa Catarina
RECONPLASMA - Rede Nacional em Engenharia de Plasma OES - espectroscopia de emissão óptica
NREL - National Renewable Energy Laboratory NMS - Núcleo de Materiais Solares
TCO – Transparent Conductive Oxide Voc – Tensão de circuito aberto
CVD - Deposição Química de Vapor (Chemical Vapor Deposition) PVD - Deposição Física de Vapor (Physical Vapor Deposition) PECVD - Plasma Enhanced CVD
PACVD - Plasma Assisted CVD
HIT – Hetero junction with Intrinsic Thin layer DC – Direct Current
RF – Radio Frequência
Sccm – Standard cubic centimeter per minute Ns - Densidade de Estados (cm-1)
%Hf -Porcentagem de Hidrogênio atômico incorporada ao filme %H2- Porcentagem do gás Hidrogênio na câmara de processo R*- Fator de microestrutura
Eg- Energia do Gap
XII
RESUMO
XIII
ABSTRACT
14
1
INTRODUÇÃO
As pesquisas na busca de fontes alternativas de energia possuem um papel de grande relevância diante da crescente demanda energética mundial e evidencias do aquecimento global. Na última conferência da ONU para mudanças climáticas em Copenhague (COP 15), os países ratificaram que existe a real necessidade de cortes profundos das emissões globais de monóxido de carbono e outros gases do efeito estufa. Esta questão está de acordo com o quarto relatório de avaliação do IPCC (Intergovernamental Panel on Climate Change) [1], com o objetivo de manter a elevação da temperatura global abaixo de 2°C [2]. Com o objetivo de cumprir essa meta, 100 bilhões de dólares até 2020 estão previstos em investimentos nos países em desenvolvimento, inclusive voltados às pesquisas de fontes de energia renovável, como a solar [2,3].
Os custos de construção típica para novas usinas de energia renovável são elevados, emas em lugares adequados podem gerar energia competitiva, graças à operação de baixo custo [4]. Existem novas tecnologias que vão de encontro a essas tendências e seus custos continuam a diminuir devido ao aumento da experiência de aprendizagem como exemplificado pela energia eólica, e através do etanol.
Em se tratando de energia solar que é o foco deste trabalho, já se tem um negócio que movimenta em torno de 10 bilhões de dólares por ano, e cresce a uma taxa de 30 % [5]. Boa parte deste crescimento se dá pelos incentivos governamentais em países como Alemanha e Japão [5]. Os investimentos para a energia fotovoltaica tendem a crescer juntamente com o aumento da pressão sobre os países para a redução das emissões de CO2 e outros gases de efeito estufa.
Inserido na categoria de novas tecnologias de fabricação de células solares, se encontram àquelas produzidas utilizando filmes finos. Desde 2003 este segmento vem aumentando sua participação no mercado, chegando em 2007 a 80% de crescimento, respondendo por 10% da produção de energia solar. A previsão é que este mercado chegue entre 25 e 30 % do mercado em 2010[6].
15 quantidade reduzida de material semicondutor. Neste sentido a comissão responsável pelo setor de fotovoltaicos da União Europeia[6] apontam algumas alternativas para manter o crescimento do setor sem que haja uma pressão sobre os preços das matérias primas, o que inviabilizaria os custos.
Primeiramente faz necessário o aumento drástico na capacidade da produção de Silício grau solar, segundo a redução do consumo de matéria prima na produção das células solares, além do aumento da eficiência dos dispositivos utilizando lâminas mais finas. Por fim o relatório aponta a importância de uma introdução acelerada da tecnologia de filmes finos em células solares para o mercado.
Este trabalho vai ao encontro das alternativas acima citadas, de forma a reduzir custos pela utilização de técnicas baseadas em plasmas frios e utilização de filmes finos. São descritos nestes estudos a dinâmica de crescimento de filmes amorfos e nanocristalinos produzidos pela técnica de Deposição Física de Vapores (PVD) denominada Evaporação Reativa Assistida por Plasma.
Atualmente o Silício amorfo hidrogenado (a-Si:H) cumpre um papel importante na produção de células solares fotovoltaicas. A utilização deste material como camada emissora nas células fotovoltaicas permite a redução do custo de produção, visto que o mesmo pode ser produzido em temperaturas mais baixas, comparadas ao silício cristalino (c-Si). A quantidade de material utilizada é menor e seu uso permite uma melhoria na eficiência [7]. Pode-se obter a fase nanocristalina nestes filmes com a alteração dos parâmetros de processo [8] de forma a usá-los como camada absorvedora depositadas em substratos de baixo custo, como estudadas pelo Instituto Fraunhofer [9].
Faz-se necessário aqui o estudo da influência dos parâmetros de processo de modo a alcançar os requisitos de qualidade adequados à aplicação destes materiais em células solares tipo heterojunção de Silício (SHJ), já que suas propriedades são fortemente dependentes desses parâmetros [10].
17
2
OBJETIVOS
2.1 Objetivo Geral
Estudar o efeito da composição da atmosfera e temperatura do substrato nas propriedades ópticas e estruturais de filmes de silício, depositados pela técnica de evaporação por feixe de elétrons com a assistência de plasma.
2.2 Objetivos Específicos
Produzir filmes de Silício amorfo hidrogenado (a-Si:H) com porcentagens adequadas de hidrogênio para o uso como camada emissora em células solares tipo heterojunção de silício (SHJ).
Produzir utilizando a mesma técnica filmes de silício nanocristalinos (nc:Si:H) para o uso como camada absorvedora de células solares.
Mostrar o efeito de cristalização de filmes de silício induzido pelo aumento da presença de Hidrogênio no plasma de processo.
18
3 REVISÃO BIBLIOGRÁFICA
3.1 Células Solares
A célula solar é um dispositivo capaz de converter energia luminosa em eletricidade de forma direta (Efeito Fotovoltaico) devido à incidência da radiação em uma junção de semicondutores (11), como mostrado na figura abaixo.
Figura 3-1 Esquema das partes básicas de uma célula mostrando os movimentos das cargas na junção [11].
19
Figura 3-2(a) Movimento dos portadores de cargas na junção exposta à luz. (b) Geração corrente da corrente de curto circuito no dispositivo [12].
3.2 Células tipo HSJ (Heterojunção de Silício)
Essa célula é composta de uma lamina de silício cristalino dopado (c-Si), chamada de camada absorvedora. Sobre esta é depositado alguns nanômetros de silício amorfo intrínseco (a-Si:H) e por último, um filme de silício amorfo extrínseco (a-Si:H n-p) chamado camada emissora.
Figura 3-3 Esquema de uma célula HIT[14].
Esse dispositivo possui bom rendimento e custo reduzido, devido ao menor uso de material e baixa temperatura de produção[15]. Outras melhorias são normalmente integradas, como camadas anti-refletoras, texturização e o uso de óxidos transparentes e condutores (TCO). A imagem abaixo mostra uma microscopia de transmissão deste dispositivo.
20
Figura 3-4 Imagem de uma célula HSJ feita por microscopia de transmissão. HRTEM
[16].
Em comparação com a célula de silício monocristalino tipo homojunção, a eficiência da célula HSJ é superior, o que aliado à baixa temperatura de produção, possibilita a redução de custos com a utilização de silício de menor qualidade, bem como seu bom desempenho em altas temperaturas. A empresa Sanyo que é a maior produtora deste tipo de dispositivo reporta uma eficiência de 21,6% [17].
3.3 Células polimórficas
21 materiais. Neste texto usa-se o nome nc-Si:H devido a presença de grãos nanométricos nos recobrimentos.
Para este tipo de células o transporte de carga é governado pelo potencial de barreira dos contornos de grão do filmes, sendo necessário tratamento específico dos mesmos para passivar os defeitos [19]. Com o uso desse material pode-se ter um acréscimo na eficiência quântica se comparado ao uso exclusivo de filmes amorfos como demonstrado na figura 3.5. As células que utilizam os dois materiais são denominadas “polimórficas” [18].
Figura 3-5 Esquema de uma célula “polimórfica” que utiliza tanto filme amorfo quanto
microcristalino (a) Resposta espectral da célula com a contribuição distinta de a-Si:H e µc-Si:H (b) [18].
Outra vantagem apontada na literatura para o uso de filmes finos de Silício nanocristalinos (nc–Si:H) é a menor tendência de perda de eficiência no decorrer da vida do dispositivo como mostrado na figura 3.6.
Contato Inferior
22
Figura 3-6 Evolução da eficiência de células com o tempo de exposição à luz utilizando exclusivamente filmes amorfos ou microcristalino [20].
3.4 Filmes Amorfos aplicados a Células Solares
Os desenvolvimentos de semicondutores amorfos (a-Si) iniciaram na década de 50 com foco nos elementos do grupo VI (enxofre, selênio e telúrio). O particular interesse estava na relação entre desordem na estrutura e propriedades elétricas, mas essas questões não estão totalmente respondidas até hoje [8]. Recobrimentos de a-Si eram depositados por evaporação térmica e sputtering sendo considerados materiais com alta densidade de defeitos o que inibiu
seu uso como um bom semicondutor. Os desenvolvimentos feitos a partir da década de 60 na incorporação de hidrogênio como elemento passivador em sistemas de pulverização catódica mostraram melhorias nas propriedades elétricas [21, 22].
Em 1965 foi descoberto que a deposição de Silício amorfo hidrogenado (a-Si:H) via descarga luminescente (Glow discharge) produzia materiais com melhores propriedades [8] . Já a partir
23 A utilização do silício amorfo (a-Si:H) como camada emissora nas células fotovoltaicas permite a redução do custo de produção visto que o mesmo pode ser produzido em temperaturas mais baixas comparadas ao silício cristalino (c-Si). Também permite uma melhoria na eficiência, de heterojunções já que se consegue diminuir a densidade de defeitos das superfícies. O hidrogênio exerce um papel fundamental na redução destes defeitos, e a busca pelo entendimento da sua incorporação e estabilidade em a-Si:H tem levado a intensas pesquisas.
Algumas características relacionadas ao a-Si:H são listadas abaixo:
• Produzido a baixa temperatura < 300°C;
• Maior absorção no visível que o cristalino devido à transição direta entre a banda de valência e condução, diferente do cristalino que é indireta (depende de fônons) como
demonstrado na figura 3.7;
• O coeficiente de absorção é em geral uma ordem de grandeza maior do que o cristalino, podendo ser aumentado pelo processo de hidrogenação que eleva o seu valor absorção na região do visível.
Figura 3-7 a) Absorção de fóton em um semicondutor com band gap direto b) Absorção
de fóton em um semicondutor com band gap indireto assistido por absorção de fônon e c) Absorção de fóton em um semicondutor com band gap indireto assistido por emissão
24
3.5 Defeitos em materiais amorfos
No silício amorfo existem dois tipos de defeitos os primeiros são denominados dangling bonds, que são ligações faltantes entre Si-Si. Este promove a recombinação dos portadores
gerados no dispositivo fotovoltaico degradando fortemente suas propriedades elétricas [10]. A figura 3.8 mostra que os dangling bonds dão origem a níveis de energia perto do centro do bandgap [24] chamados também de defeitos de estados profundos.
A falta de ordem no material também provoca efeitos danosos, como a ampliação das bandas de valência e condução formando calda de estados estendidos (Fig. 3.8). Ele é considerado menos danoso, pela menor energia necessária para se alcançar uma das bandas principais. São chamados de defeitos de estados rasos.
Figura 3-8 Representação esquemática do diagrama de bandas para um semicondutor amorfo[25].
A presença desta maior densidade de estados no material resulta em uma baixa mobilidade de cargas no a-Si devido a alta probabilidade de recombinação [25]. Por isso se faz necessária a eliminação ou minimização destes dangling bonds, a fim de, melhorar as características
elétricas do material. Nesse sentido, ligações pendentes podem ser passivadas pela adição de hidrogênio durante o processo de deposição, levando a formação dos filmes de a-Si:H
Calda de banda
D
en
sidad
e de
estado
s
25 cujas propriedades elétricas permitem seu uso em tecnologia de células solares [25-26].
Um fenômeno muito crítico tem sido relacionado a-Si:H desde os primeiros estudos e é denominado efeito Staebler-Wronski [27].Consistindo na deterioração das propriedades
do material hidrogenado, depois de prolongada exposição à luz. Os mecanismos por trás desta degradação não foram totalmente esclarecidos, embora diferentes modelos tenham sido propostos ao longo dos anos [25]. De qualquer forma, o hidrogênio tem sido aceito como aquele que desempenha um papel muito importante no processo.
3.6 Filmes nanocristalinos aplicados a Células Solares
Em meados da década de 90, muitos grupos de pesquisa começaram a olhar para o primeiros estágios de cristalização de seus filmes a-Si: H[10]. O primeiro progresso foi a produção de células solares “micromórficas”que são uma combinação de a-Si:H/μc-Si:H[28]. Inicialmente tinham eficiências de 7,7%, mas com a introdução de camadas de ZnO e anti-refletoras elevaram os valores para até 13%[29].
Recentemente nc- Si: H tem atraído um grande interesse como um candidato para fabricação em larga escala de células solares, devido à melhor resposta espectral com a melhoria na corrente de curto circuito do dispositivo [30-32]. Esse material tem sido o foco de inúmeras pesquisas, onde se buscam relacionar a influência da sua estrutura com o rendimento da célula solar [33]. Alguns autores apontam a tecnologia dos filmes nanocristalinos como a evolução da tecnologia de filmes amorfos.
Devido a sua maior absorção óptica efetiva, estes filmes têm sido usados como a camada absorvedora, permitindo redução na espessura de laminas ou o uso de substratos de baixo custo como aço, Silício grau metalúrgico ou mesmo polímeros.
26 A baixa temperatura de deposição é uma grande vantagem em relação aos policristalinos que são preparados em temperaturas maiores que 650°C não possuindo por isso conteúdo significativo de hidrogênio capaz de passivar defeitos. O crescimento de cristalitos em baixas temperaturas é conseguido pelo efeito do Hidrogênio atômico que aumenta a mobilidade dos átomos de silício provenientes do plasma que chegam ao substrato [34]. Podem, portanto, serem produzidos a temperaturas menores que 250°C sendo completamente compatível com a tecnologia de a-Si:H[11].
A maior limitação ao seu uso é a baixa taxa de deposição devido aos altos índices de diluição de hidrogênio utilizando sistemas de PACVD [35]. Esta baixa taxa de deposição pode ser contornada pela introdução de novas técnicas de produção e melhorias nas tradicionais já usadas.
3.7 Defeitos em materiais nanocristalinos
Os materiais nanocristalinos apresentam variações em suas propriedades dependendo da fração cristalina presente na estrutura. Geralmente demonstram transição indireta quando possuem cristalinidade maior que 80%, podendo assim ser tratados como material cristalino com uma fonte extra de recombinação nos contornos de grão e na matriz amorfa residual [34]. O transporte de carga, portanto é regido pelo potencial de barreira nesses contornos e na matriz [32] que é depende da densidade de defeitos nos mesmos e da densidade de dopagem dentro do grão [19]. Fato que deve ser considerado é a tendência de se segregar as impurezas para essas regiões o que pode criar altos níveis de defeitos eletricamente ativos.
27
3.8 Propriedades Ópticas de filmes amorfos e nanocristalinos
As propriedades ópticas de a-Si:H e nc-Si:H são caracterizadas normalmente pelo coeficiente de absorção, o índice de refração, e o valor do bandgap óptico. O coeficiente de absorção é
determinado pela transição elétrica envolvendo todos os pares de estados eletrônicos ocupados e não ocupados que estão separados pela mesma energia dos fótons incidentes. Por esta razão, estas medidas são largamente usadas para determinar a densidade de distribuição de estados [37]. Uma curva típica de absorção em função da energia dos fótons, para filmes de Silício nanocristalinos e amorfo, são mostradas na figura abaixo juntamente com a de um
wafer monocristalino (c-Si) [38].
Figura 3-9 Curvas do coeficiente de absorção para a-Si:H, nc-Si:H e c-Si[38].
A curva para filmes de a-Si:H mostrada na figura acima apresenta valores de absorção óptica superiores aos do c-Si e o nc-Si:H na região do visível (2-3eV). Isso se dá pela ausência de
Energia (eV)
α
(cm
28 ordem de longo alcance em a-Si:H provocar uma alteração na transição inter-bandas do material, passando a apresentar gap direto com valores entre 1,6 e 1,8eV [16]. Estes valores
podem se elevar com a introdução de hidrogênio que promoverá relaxação da estrutura e passivação de defeitos.
As curvas de absorção para os filmes nc-Si:H acompanham o comportamento do c-Si, com um deslocamento para maiores valores do coeficiente de absorção. Essa mudança se deve principalmente ao espalhamento da luz na superfície mais rugosa do filme e também devido à absorção adicional pela presença da fração amorfa, especialmente em energias maiores que 1,8 eV[38].
Para o cálculo do bandgap óptico podem ser construídas curvas fazendo-se um gráfico de
(αhv)1/2 versus hv, onde hv é a energia dos fótons e α é o coeficiente de absorção. O
comportamento linear após a banda é observado para muitos semicondutores amorfos. Sendo a intercessão desta reta com o eixo x chamado de bandgap de Tauc[39]. A lei de Tauc é
deduzida baseada na premissa de uma matriz do material com transição eletrônica constante e uma dependência da raiz quadrada da densidade de estados próximos a condução e a banda de valência [25]. Mas seu uso em filmes de Silício que apresentam duas fases tem sido usado desde que seja possível um bom ajuste na região linear[40].
A relação linear vem da equação de Tauc [39]:
(3.1)
Na figuras 3.11 abaixo são mostradas as curvas para o cálculo de do band gap ótico (Eg)
29
Figura 3-10 Curva típica para cálculo do band gap de Tauc para material amorfo (a), e para filmes com alguma fração cristalina (b)[40].
Podemos obter informações sobre as propriedades elétricas do material a partir das medidas de absorção ótica na região do sub bandgap. Um exemplo deste espectro está na figura 3.11
abaixo.
Figura 3-11 Coeficiente de absorção em função da energia com a indicação da região que indica a densidade de estados[15].
Absorção por defeitos
30 Foi demonstrado que o aumento da absorção óptica no infravermelho e ultravioleta próximo são indicativos de defeitos nos filmes[38]devido à absorção de fótons entre as bandas condução e valência ou mesmo abaixo da condução ou acima da valência. Além disso o efeito da passivação com hidrogênio é também demonstrado nestes gráficos pela redução da área abaixo da curva do sub band gap.
Para determinar a natureza dos estados profundos, foi relacionada à variação da densidade de spin (Ns) com o coeficiente de absorção em 1,2eV (41). Uma correlação linear pode ser estabelecida entre ambos no intervalo das medidas: onde α é o coeficiente de absorção em 1,2eV e é expressa em cm-1. A correlação entre estas duas quantidades mostra que a absorção em baixa energia é devida principalmente a centros paramagnéticos (spins). Obtém-se então a correlação 3.2 sendo osresultados são dados em cm-1:
(3.2)
3.9 COMPOSIÇÃO
31
Figura 3-12 Exemplo de espectro de infravermelho para filmes de silício hidrogenado (a)
-PACVD) e (b) -HWCVD[42].
Para filmes de a-Si:H e nc-Si: H as bandas de absorção centradas ao redor 2100 cm-1 indicam a presença de polihidretos (SiH2 ou SiH3) ou ainda monohidretos em uma estrutura porosa. Filmes com esta configuração apresentam propriedades elétricas pobres devido a excesso de defeitos. Já os recobrimentos com absorção em 2000 cm-1 possuem em sua maioria ligações na forma de monohidretos (SiH) o que corresponde a uma estrutura mais compacta onde poucas ligações entre Si-Si precisaram ser passivadas pelo hidrogênio[19,28]. Em relação aos filmes nc-Si:H a maioria dos átomos de hidrogênio estão nos contornos de grão ou na superfície dos cristalitos diante de vazios intergranulares [19].
O fator de microestrutura (R *) [43] mede a razão entre a banda de polihidretos e a soma entre o montante de polihidretos e monohidretos. Quanto menor o valor de R*, melhor a configuração das ligações Si-H. Alguns autores indicam valores menores que 0,1, como um requisito de qualidade para estes filmes[28].
(3.3)
Um importante parâmetro de deposição que interfere no fator de microestrutura é a temperatura do substrato, podendo favorecer o crescimento de material altamente
N° de onda (cm-1)
A
bs
orbâ
nc
ia
(u.a
32 hidrogenado ou não, devido à efusão menos hidrogênio a partir do substrato ou a difusão de hidrogênio para o interior da estrutura [44-46].
Importante notar que a transição do regime amorfo para o cristalino é acompanhada pela redução do conteúdo de hidrogênio que no caso dos filmes microcriastalinos estão ligados preferencialmente nas superfícies dos grãos [47].
A literatura [48-50] apresenta um método de cálculo do percentual de hidrogênio considerando os picos de absorção nas faixas do número de onda correspondente as ligações e integrados na região de interesse:
(3.4)
Sendo S é a intensidade integrada na banda de absorção, o coeficiente de absorção e o número de onda da luz incidente. O coeficiente de absorção pode ser determinado pela equação representada abaixo:
(3.5)
Sendo d a espessura da amostra (em cm). Sabendo o valor de S, com a equação 3.6, determina-se a densidade da amostra no substrato com a seguinte equação:
(3.6)
Onde: Nx – densidade da amostra no substrato
Aw – constante de proporcionalidade (Aw2000= 9,1x1019cm-2 e Aw2000=1x1020cm-2)
Com isso, chega-se a percentagem através de [49]:
(3.7)
33
3.10 Propriedades estruturais
A estrutura do filme de silício pode ser caracterizada pontualmente como cristalina e/ou amorfa através da espectroscopia micro-Raman. Esta técnica tem como base o espalhamento provocado por um material quando uma radiação incide no mesmo.
Este fenômeno acontece, na maioria das vezes, elasticamente (os fônons espalhados têm a mesma energia que os incidentes). Contudo, uma pequena parte da luz (aproximadamente 1 em cada 107 fótons) é espalhada com diferentes frequências ópticas dos fótons incidentes. O processo conduzido para este espalhamento inelástico é chamado de efeito Raman. Isto pode acontecer com uma mudança na energia vibracional.
A diferença de energia entre o fóton incidente e o fóton espalhado é igual à energia de vibração da estrutura. Ao relacionar a diferença da intensidade da luz espalhada com o deslocamento da frequência, obtém-se um espectro Raman. Na figura abaixo são mostrados alguns espectros típicos para Filmes de Silício produzidos com diferentes porcentagens de hidrogênio em um processo PACVD [25].
Figura 3-13 Espectros Raman para diferentes quantidades de hidrogênio em um
processo PACVD [25]
Int
en
s
ida
de
(
u.
a)
Deslocamento Raman (cm-1)
Aumento do H2 na
34 O espectro pode ser deconvoluido em três picos localizados em 480 cm-1, 510 cm-1e 520 -1 correspondendo respectivamente a fase amorfa, contorno de grão e fase cristalina. O volume cristalino é estimado pela relação:
(3.8)
Onde Ic, Icg e Ia são as áreas abaixo da curva correspondentes a fase cristalina, contorno de grão e amorfa. [50-51]
É sabido que a presença de uma longa calda no sentido de menores energias indicam a presença de grãos menores que 15 nm como demonstrado no gráfico (52)
Além das frações cristalinas e amorfas dos filmes o tamanho dos cristalitos podem ser determinados utilizando o espectro Ramam (53-56) . O pico correspondente ao c-Si tende a se deslocar para menores energias quando há redução no tamanho de grão (52) de forma que o valor deste deslocamento (Δω) em relação a posição ideal de 522 cm-1, possibilita calculo do tamanho médio dos cristais pela expressão (58).
(3.9)
Onde: D = o diâmetro médio do cristalito em nanômetros B= 2.2 cm-1nm2
Independente da técnica utilizada para a produção de filmes de Silício hidrogenado um fenômeno não pode ser deixado de lado quando se trata de um ambiente onde estão presentes Silício e Hidrogênio atômico. O termo utilizado na literatura é o “chemical annealing” ou
traduzido recozimento químico. Este fenômeno consiste no fato experimental de que há formação de cristais em filmes de a-Si durante o tratamento ou deposição em presença de plasmas de hidrogênio a partir de uma concentração de H e temperatura do substrato[59-60]. Durante o tratamento na presença de plasmas de hidrogênio, os íons difundem para a região sub-superfícial (chamado de zona de crescimento). Com uma quantidade suficiente de hidrogênio atômico nesta região, acontece a formação de uma rede flexível, capaz de se reorganizar na forma cristalina [61].
35
Figura 3-14 Esquema representativo do modelo de recozimento Químico para crescimento de filmes de Silício[51].
Por fim é esperado que com o aumento da fração cristalina (Xc) haja a elevação da rugosidade superficial como demonstrado na ilustração na figura [61] este fato deve ser considerado ao se usar espectroscopias que sejam sensíveis ao espalhamento da radiação na superfície.
Figura 3-15 Representação do crescimento de cristalitos em filmes de silício e o aumento da rugosidade[61]
Rugosidade superficial por AFM
36
3.11 Evaporação reativa assistida por plasma
Uma variedade de técnicas tem sido utilizada para a deposição de ligas amorfas de Silício, incluindo as em presença de descarga luminescente, como a pulverização catódica, deposição química de vapores e evaporação reativa [62].
O processo de produção de recobrimentos via PVD, Physical Vapour Deposition ou Deposição Física de Vapores, consiste na vaporização do material a ser depositado e sua subsequente condensação sobre a superfície do substrato, formando uma camada, que pode variar de poucos angstroms até dezenas de micrometros. A figura abaixo mostra o esquema básico de uma evaporadora por feixe de elétrons com assistência de plasma.
Figura 3-16 Esquema de um reator de evaporação por e-beam assistido por plasma.
De uma forma simplificada, pode-se dividir o processo de PVD em três etapas [63]:
a) Criação da fase vapor do material que será depositado sobre o substrato. Isto é feito termicamente ou por bombardeamento de elétrons
b) Transporte do material da fonte de vapor até o substrato. Este transporte pode dar-se
37 um transporte difusivo, com um grande número de colisões entre átomos e moléculas (ultra alto vácuo, 10-11, é usado em casos especiais na indústria de semicondutores). A atmosfera presente na câmara pode ser inerte ou reativa. Neste último caso, o filme depositado será um produto da reação entre os vapores e gases presentes na câmara. Os gases e vapores presentes na câmara podem ainda ser ionizados, estabelecendo-se um plasma, que acelera as reações químicas. Os íons do plasma podem ser acelerados em direção ao substrato por um campo elétrico (tensão de Bias).
c) Crescimento do revestimento sobre o substrato. Este processo envolve a condensação
do vapor, ou do produto da reação deste com gases presentes na câmara, sobre o substrato e a subsequente formação do revestimento pelo processo de nucleação e crescimento. Os processos de nucleação e crescimento podem ser muito influenciados por bombardeamento iônico do revestimento em formação, resultando em mudanças na microestrutura, composição e tensões residuais.
As descargas luminescentes são usadas em variados processos de tratamentos superficiais de materiais, incluindo a deposição de filmes finos. Entre esses processos podem ser citados a pulverização catódica (sputtering), a implantação iônica, a deposição química de vapores assistida por plasma (PACVD), a nitretação iônica e outros processos onde suas propriedades são usadas em conjunto com outras técnicas como a evaporação reativa assistida por Plasmas[64]. Sua grande vantagem é promover reações que pela termodinâmica clássica não poderiam ocorrer em temperaturas baixas, como a dissociação de Silanos e difusão atômica[63] Já foi citado anteriormente que a passivação das ligações pendentes de silício pelo hidrogênio reduz a densidade de estados eletrônicos no gap do silício amorfo tornando o material
adequado para aplicações eletrônicas. Como o hidrogênio molecular é relativamente estável, para se formas as ligações Si-H é necessário a produção de hidrogênio atômico [64-65].
38 Espectros de absorção óptica de filmes de a-Si: H produzidos por evaporação reativa são apresentados na figura 3.18. As mudanças dos espectros devido à mudança da pressão de hidrogênio na câmara mostram a mudança trazida pelo hidrogênio na formação dos recobrimentos. O deslocamento da borda de absorção para energias mais elevadas indica uma ampliação do gap óptico. A queda da absorção a baixas energias sugere a redução de defeitos de estados profundos.
Figura 3-17 Curvas de absorção para filmes produzidos por evaporação reativa na presença de diferentes porcentagens de Hidrogênio[69].
Energia (eV)
39
4 MATERIAIS E MÉTODOS
4.1 Sistema de deposição BAI 640 R
Para a obtenção dos filmes de Si empregou-se a técnicas de evaporação por feixe de elétrons assistida por plasma de argônio e Hidrogênio.
As deposições realizaram-se em um sistema BALZERS BAI 640 R, disponível no Laboratório de Engenharia e Modificação de Superfícies – LEMS do CETEC. Um esquema geral do reator é mostrado na figura 4.1.
Figura 4-1 Esquema geral do reator BAI 640 R.
40
4-2 Esquema da câmara de ionização do reator BAI 640.
Inicialmente os gases a serem ionizados são injetados sobre um filamento de Tungstênio incandescente (Fig. 4.3). Uma diferença de potência positiva é aplicada as paredes da câmara a fim de forçar a abertura do plasma pela passagem de elétrons provenientes deste filamento. O plasma gerado fica inicialmente confinado na câmara de ionização até que é expulso pela ação de um campo magnético gerado por uma bobina que o envolve.
Durante o processo de deposição é aplicado no cadinho uma tensão positiva (30V) que atrai os elétrons contidos no plasma, gerando uma corrente, que é chamada de corrente de arco. Fotos do reator são mostradas a seguir.
Figura 4-3(a) Foto do interior do reator BAI 640. (b) Detalhe do cadinho envolto em plasma durante o processo de deposição.
Utilizando-se o reator BAI640 cresceram-se os filmes em dois tipos de substrato: Filamento aquecido
Saída do canhão de plasma
41 a) Vidro tipo soda cal para as análises de Raman, UV-Visível e perfilometria.
b) Wafer de Silício monocristalino, previamente limpo pela técnica RCA, para análises
de infravermelho.
Serão avaliados os efeitos da porcentagem do gás hidrogênio injetado no processo e da temperatura do substrato, serão mantidas constantes os outros parâmetros inclusive a espessura do filme, padronizada nos experimentos em aproximadamente 200nm. Os parâmetros mantidos constantes estão colocados na tabela abaixo:
Tabela 4-I Parâmetros mantidos constantes no processo.
Parâmetros do processo:
Taxa de deposição 12nm/m
Corrente do feixe de elétrons 0,07A
Corrente do arco 20A
Corrente do filamento do plasma 200A Pressão de trabalho 3x10-3mbar
Pressão base 7x10-7mbar
Gás de processo Argônio
Gás reativo Hidrogênio
4.2 Caracterização dos filmes
4.2.1 Medidas de espessura
42 As medidas foram feitas obtendo-se as diferenças de altura em um degrau definido na amostra depositada. Esse degrau pode ser definido durante a deposição por meio de uma máscara mecânica ou posteriormente à deposição, atacando quimicamente o filme numa certa região. No caso dos filmes obtidos neste trabalho o degrau é feito aplicando-se uma gota de solução de nitrato de boro sobre o substrato, a qual após secagem forma uma máscara sobre o mesmo durante a deposição.
O perfilômetro utilizado nesse trabalho é um “Form Talysurf Series”, do fabricante Taylor
Hobson Limited, (Laboratório de Engenharia e Modificações de Superfícies – LEMS, do CETEC), figura 4.4.
Figura 4-4 Perfilômetro Taylor Hobson.
4.2.2 Caracterização de Filme de Silício por FTIR (composição)
Os filmes depositados sobre wafers de Silício foram analisados por espectroscopia de
transmissão no infravermelho utilizando-se o Espectrofotômetro FTIR Bomen FTLA 2000, figura 4.5. Antes das medidas são usados wafer que passaram pelas mesmas condições
43
Figura 4-5 FTIR Bomen FTLA 2000.
4.2.3 Raman
Os espectros Raman foram obtidos no equipamento da fabricante RENISHAW série inVia Raman (Figura 4.6)utilizando os seguintes parâmetros:
Tabela 4-II Parâmetros Utilizados nas medidas Raman
Parâmetros Utilizados nas medidas Raman
Laser 514nm (modo regular)
Grating 2400 l/mm
Tempo de exposição 10s
Potência do laser 10%
Objetiva 50x
44
4.2.4 Espectroscopia do Uv-Visível
Utilizou-se um espectrofotômetro ótico de UV-Visível da Analytikjena Specord 210 (figura 4.7), disponível no Setor de Análises Químicas - STQ do CETEC. As medidas feitas tomaram o vidro como referência.
As análises dos espectros de transmitância obtidos na região de absorção do filme permitiram a obtenção do coeficiente de absorção e da energia da banda proibida.
Figura 4-7 Espectrofotômetro ótico UV-VIS-IV da Analytikjena Specord 210.
A partir de valores de transmitância do filme e do substrato, determinou-se o coeficiente de absorção (α) de acordo com a equação 4.1:
= -ln(T)/ e (4.1)
Em que T é a transmitância do filme e e é a espessura. A energia do fóton foi determinada pela
equação 4.2:
E= h. (4.2)
45 (4.3) Assim, através do gráfico αh1/2 versus energia do fóton (E) é possível obter a energia da banda proibida (Eg) de cada filme a partir da extrapolação da região linear do gráfico até o valor de ordenado zero[40].
Para filmes com band gap menores que 2,5eV a absorção óptica do vidro não é
46
5 RESULTADOS E DISCUSSÃO
Os resultados das caracterizações apresentados a seguir são referentes a filmes crescidos no reator BAI 640. A posição das amostras foi fixada no reator logo acima do cadinho a 20cm do mesmo.
5.1 Efeito da temperatura e da porcentagem de Hidrogênio na estrutura dos filmes.
Realizaram-se deposições sobre vidro com o intuito de observar as regiões de predominância da fase amorfa e cristalina em função da temperatura e porcentagem de hidrogênio injetado no reator. Devido ao calor proveniente do cadinho contendo o material fundido e a dissipação de calor dos elementos geradores do plasma, a faixa atual de temperatura possui um mínimo de 180°C. A tabela mostra os valores e parâmetros variados nesses experimentos.
Tabela 5-I Valores das temperaturas e porcentagens de hidrogênio (%H2) injetadas no
reator
Temperatura (°C) %H2
180 20 40 60
220 20 30 40 60
300 20 40 60
47
300 320 340 360 380 400 420 440 460 480 500 520 540 560 580 600 0,0 0,2 0,4 0,6 0,8 1,0 In te n si d a d e
Deslocamento Raman (cm-1)
20 % 40 % 60 %
Figura 5-1 Espectro Raman para filmes produzidos a temperatura de 180°C e variação de hidrogênio de 20,40 e 60 %.
Já na figura 5.2 estão colocados os espectros Raman dos filmes produzidos a 220 °C. Inseriu-se neste experimento mais uma condição de Hidrogênio na atmosfera (30%) e percebeu-Inseriu-se que acima de 40 % inicia-se a formação da fase cristalina com o aparecimento de sinais em 510 e 520 cm-1, correspondendo respectivamente a contornos de grão, cristalitos e matriz amorfa.
360 380 400 420 440 460 480 500 520 540 560 580 600
0,0 0,2 0,4 0,6 0,8 1,0 In te n si d a d e
Deslocamento Raman (cm-1)
20% 30% 40% 60% c-Si
48 Em estudos recentes [63] foi confirmado que este fenômeno de recristalização apenas ocorre a 570°C sem a presença do hidrogênio atômico. Este dado constitui um indício da ocorrência do fenômeno de recozimento químico pela presença do hidrogênio no plasma.
Para a temperatura de 300 °C temos a presença da fase cristalina em todas as porcentagens de Hidrogênio testadas, fato demonstrado pela presença de bandas cada vez mais próximas de 520 cm-1.
460 480 500 520 540 560
0,0 0,2 0,4 0,6 0,8 1,0
In
te
n
si
d
a
d
e
Deslocamento Raman (cm-1)
c-Si 20% 40% 60 %
Figura 5-3 Espectro Raman para filmes produzidos a temperatura de 300°C e variação de hidrogênio de 20,40 e 60 % além do espectro de um c-Si.
Observando o comportamento dos espectros Raman para as condições estudadas, pode-se concluir que o aumento da presença de hidrogênio no plasma reduziu a temperatura de cristalização para este tempo de deposição indicando o fenômeno de recozimento químico citado no item 3.10.
49 Primeiramente foram tratadas as curvas das amostras produzidas a 180°C. Nestas curvas o uso dos picos referentes à fração cristalina (520 cm-1) e contorno de grão (510 cm-1) não propiciou um ajuste adequado, sendo portando consideradas 100% amorfas. Os gráficos e os ajustes são mostrados na figura abaixo.
380 400 420 440 460 480 500 520 540 560 580 600 620 -0,1 0,0 0,1 0,2 0,3 0,4 0,5 0,6 0,7
380 400 420 440 460 480 500 520 540 560 580 600 620 -0,1 0,0 0,1 0,2 0,3 0,4 0,5 0,6 0,7
380 400 420 440 460 480 500 520 540 560 580 600 620 -0,1 0,0 0,1 0,2 0,3 0,4 0,5 0,6 0,7 0,8 In te n s id a d e (u .a )
Deslocamento Raman (cm-1) 40 % Ajuste In te n s id a d e (u .a )
Deslocamento Raman (cm-1) 20 % Ajuste In te n s id a d e (u .a )
Deslocamento Raman (cm-1) 60 % Ajuste
Figura 5-4- Deconvolução dos espectros Raman para os filmes produzidos a 180°C com 20,40 e 60 % de Hidrogênio no reator
50
380 400 420 440 460 480 500 520 540 560 580
-0,02 0,00 0,02 0,04 0,06 0,08 0,10 0,12 0,14 0,16 0,18 0,20 0,22
390 400 410 420 430 440 450 460 470 480 490 500 510 520 530 540 550 -0,1 0,0 0,1 0,2 0,3 0,4 0,5 0,6 0,7
410 420 430 440 450 460 470 480 490 500 510 520 530 540 550 560 570 -0,05 0,00 0,05 0,10 0,15 0,20 0,25 0,30 0,35 0,40 0,45 0,50
410 420 430 440 450 460 470 480 490 500 510 520 530 540 550 560 570 -0,05 0,00 0,05 0,10 0,15 0,20 0,25 0,30 0,35 0,40 0,45 0,50 In te n s id a d e (u .a )
Deslocamento Raman (cm-1) 20 % Ajuste In te n s id a d e (u .a )
Deslocamento Raman (cm-1) 30 % Ajuste In te n s id a d e (u .a )
Deslocamento Raman (cm-1) --- 40 %
480 cm-1
510 cm-1
520 cm-1
Ajuste In te n s id a d e (u .a )
Deslocamento Raman (cm-1) 60%
480 cm-1
510cm-1
520 cm-1
Ajuste
Figura 5-5- Deconvolução dos espectros Raman para os filmes produzidos a 220°C com 20,30,40 e 60 % de Hidrogênio no reator
51
380 400 420 440 460 480 500 520 540 560 580 600 620
0,00 0,05 0,10 0,15 0,20 0,25 0,30 0,35 0,40 0,45 0,50 0,55
380 400 420 440 460 480 500 520 540 560 580 600 620
0,0 0,1 0,2 0,3 0,4 0,5 0,6 0,7
380 400 420 440 460 480 500 520 540 560 580 600 620
0,0 0,2 0,4 0,6 0,8 In s te n s id a d e (a .u )
Deslocamento Raman (cm-1) 40 %
480 cm-1
510 cm-1
520 cm-1
Ajuste In s te n s id a d e (a .u )
Deslocamento Raman (cm-1) 60 %
480 cm-1
510 cm-1
520 cm-1
Ajuste In s te n s id a d e (a .u )
Deslocamento Raman (cm-1) 20 %
480 cm-1
510 cm-1
520 cm-1
Ajuste
Figura 5-6 Deconvolução dos espectros Raman para os filmes produzidos a 300°C com 20, 40 e 60 % de Hidrogênio no reator.
O gráfico da figura 5.7 inclui todos esses valores e pode-se notar o efeito tanto do hidrogênio quando da temperatura na cristalização.
180 200 220 240 260 280 300
-10 0 10 20 30 40 50 60 70 80 90 20 % 40 % 60 % Xc (% ) Temperatura (°C)
52 Vê-se, portanto que existe uma influência significativa da composição da atmosfera na cristalização do filme pelo fenômeno de recozimento químico, como indicado na literatura. Este modelo prevê que átomos de hidrogênio atômico envolvem os átomos de Silício que chegam ao substrato e os já estruturados, de forma promover uma rede mais flexível capaz de se organizar na forma cristalina. Esta constatação também nos leva a presumir que o sistema de ionização do gás é capaz de gerar hidrogênio atômico e que o mesmo consegue chegar à região de deposição sem haver recombinação total do mesmo. A tabela 5.II sumariza os dados da deposição e a fração cristalina calculada.
.
Tabela 5-II Valores de Xc para as diferentes temperaturas e composições da atmosfera do reator.
Temperatura (°C)
% H2 Fração Cristalina (Xc)
180 20 0
40 0
60 0
220 20 0
30 0
40 19,9
60 68,0
300 20 51,4
40 55,5
60 83,1
A presença do pico em torno do pico característico de c-Si, juntamente com uma larga calda no sentido de menores energias são indícios da presença de grãos menores que 15 nm como já citado no tópico 3.10.
53
15 20 25 30 35 40 45 50 55 60 65
3 4 5 6 7
8 220°C
300°C
D
(n
m)
% H2
Figura 5-8 Tamanho médio de grão em função da porcentagem de hidrogênio para 220 °C e 300°C
Percebe-se que tanto o aumento da temperatura quanto a maior quantidade de Hidrogênio injetada no reator, aumentam o diâmetro médio dos grãos, como é esperado devido a maior mobilidade atômica para o crescimento e maior organização atômica na fase amorfa promovendo a nucleação dos grãos.
Outra constatação é a tendência de grãos maiores quando há o aumento da fração cristalina (Xc) como pode ser visto na figura 5-9 semelhante a literatura [57] .
10 20 30 40 50 60 70 80 90
3 4 5 6 7 8
D
(n
m)
Xc (%)
54
5.2 Efeito da temperatura e porcentagem de Hidrogênio na composição dos filmes
Analisaram–se os filmes depositados sobre wafer de Silício por espectroscopia do
infravermelho de forma a quantificar a incorporação de Hidrogênio e determinar qualitativamente a presença de outros elementos relevantes. A figura 5.10 mostra o espectro completo entre 1950 e 2225 cm -1 para os filmes depositados a 180°C e as respectivas composições da atmosfera. Incluiu-se nestes experimentos uma amostra de wafer replicando
as condições para 40 % da atmosfera de forma a avaliar a confiabilidade dos resultados.
1950 2000 2050 2100 2150 2200
-0,002 0,000 0,002 0,004 0,006 0,008 0,010 0,012 0,014 0,016 0,018 0,020 0,022 0,024
Ab
so
rvâ
n
ci
a
(%
)
Nْ de onda (cm-1
)
20 % 40 % 60 % 40 % R
Figura 5-10 Espectro de infravermelho na região indicativa das ligações Si-H para amostras produzidas a 180°C e porcentagens de hidrogênio de 20, 40 e 60 %.
55
2000 2100 2200
0,000 0,003 0,006 0,009
2000 2100 2200
-0,002 0,000 0,002 0,004 0,006 0,008 0,010 0,012 0,014 0,016
2000 2100 2200
0,000 0,004 0,008 0,012 0,016
2000 2100 2200
-0,002 0,000 0,002 0,004 0,006 0,008 0,010 0,012 0,014 0,016 0,018 Ab s o rv â n c ia
N° de onda (cm-1) 20 % 2000 cm-1 2100 cm-1 Ajuste Ab s o rv â n c ia
N° de onda (cm-1)
40 % 2000 cm-1 2100 cm-1
Ajuste Ab s o rv â n c ia
N° de onda (cm-1)
40% R 2000 cm-1 2100 cm-1 Ajuste Ab s o rv â n c ia
N° de onda (cm-1)
60 % 2000 cm-1 2100 cm-1 Ajuste
Figura 5-11 Deconvolução dos espectros de Infravermelho para os filmes produzidos a 180°C com 20, 40 e 60 % de Hidrogênio no reator.
Utilizando o método mostrado anteriormente na seção 3.9 equação 3.3 foram calculadas as quantidades percentuais de incorporação de Hidrogênio (Hf) e o fator de microestrutura (R*) os quais são apresentados na tabela 5.III.
Tabela 5-III Valores de %Hf e R*para os filmes depositados a 180°C e as diferentes
composições da atmosfera do reator.
Temperatura (°C) % H2 %Hf R*
180
20 8,51 0,65 40 14,82 0,81 40R 13,98 0,79 60 16,25 0,90
56 ligações SiH1,2,n que não são desejadas em filmes para aplicação fotovoltaica, devido a serem mais suscetíveis a sofrer efeito Staebler -Wronski [27] o que degrada as propriedades elétricas do material.
Este alto valor para os fatores de microestrutura tende a ocorrer em materiais de maior porosidade, onde há vazios saturados de ligações de Hidrogênio [36].
Por outro lado, ao se tratar da região de ligações Si-H percebemos uma alteração no comportamento em relação ao experimento anterior como pode ser visto no gráfico da figura 5.12.
1950 2000 2050 2100 2150 2200 2250
0,000 0,001 0,002 0,003 0,004 0,005 0,006 0,007 0,008
Ab
so
rvâ
n
ci
a
(%
)
Nْ de onda (cm-1
)
20 % 30 % 40 % 60 %
Figura 5-12 Espectro de infravermelho na região indicativa das ligações Si-H para filmes produzidos a 220°C e porcentagens de hidrogênio de 20, 30,40 e 60 %.
57
1950 2000 2050 2100 2150 2200 2250
0.000 0.001 0.002 0.003 0.004
1950 2000 2050 2100 2150 2200 2250
0.000 0.001 0.002 0.003 0.004 0.005 0.006 0.007 0.008
1950 2000 2050 2100 2150 2200 2250
0.0000 0.0005 0.0010 0.0015 0.0020 0.0025 0.0030 0.0035 0.0040
1950 2000 2050 2100 2150 2200 2250
0.000 0.001 0.002 0.003 0.004 Ab s o rb a n c ia
N° de onda (cm-1)
20 %
2000 cm-1
2100 cm-1
Ajuste Ab s o rb a n c ia
N° de onda (cm-1)
30 %
2000 cm-1
2100 cm-1
Ajuste Ab s o rb a n c ia
N° de onda (cm-1)
40 %
2000 cm-1
2100 cm-1
Ajuste Ab s o rb a n c ia
N° de onda (cm-1)
60 %
2000 cm-1
2100 cm-1
Ajuste
Figura 5-13 Deconvolução dos espectros de infravermelho para os filmes produzidos a 220°C com 20,30, 40 e 60 % de Hidrogênio no reator.
Nestas temperaturas o fator de microestrutura R* se manteve em valores próximos a 0,9 indicando ainda a formação de polihidretos. A redução geral na incorporação de hidrogênio é devido à maior efusão do mesmo pela estrutura, em temperaturas mais elevadas se tornando maior que promoção da difusão e fixação do elemento [45-47]. No caso dos filmes produzidos em 40 e 60 % de Hidrogênio esta redução é ainda mais significativa, pois como já foi citado, a transição do regime microcristalino é acompanhado pela redução do conteúdo de hidrogênio pela formação de ligações termodinamicamente mais estáveis entre Si-Si [48]. Uma fração residual do elemento está ligada preferencialmente a superfícies dos grãos cristalinos o que pode promover a passivação destes defeitos. A tabela 5.IV mostra os resultados discutidos acima.
Tabela 5-IV Tabela com porcentagem de Hidrogênio e fator de microestrutura
Temperatura (°C) % H2 % Hf R*
220
58 Por fim foram analisados os recobrimentos depositados a 300°C. Os espectros no infravermelho (figura 5.14) não indicaram sinal significativo de absorção dos hidretos de silício.
1700 1800 1900 2000 2100
-0,005 0,000 0,005 0,010 Ab so rvâ n ci a (% )
Nْ de onda (cm -1
)
20 % 40 % 60 %
Figura 5-14 Espectro de infravermelho na região indicativa das ligações Si-H para filmes produzidos a 300°C e porcentagens de hidrogênio de 20,40 e 60 %.
Nestas condições a efusão do hidrogênio é completa, sendo seu papel exclusivamente de catalisar a reorganização da estrutura do Silício em uma sua forma cristalina, este comportamento se enquadra no modelo proposto por Matsuda (52).
Os gráficos 5.15 sumariza os resultados da influência da temperatura e da porcentagem de hidrogênio na incorporação do mesmo na estrutura do Silício.
180 200 220 240 260 280 300
0 2 4 6 8 10 12 14 16 18 20 % 40 % 60 % Hf (% ) Temperatura (°C)
59 Resultados publicados indicam que há um máximo de incorporação de hidrogênio e uma queda posterior quando se trata da influência da temperatura, nas condições permitidas pelo reator pode-se ver que estamos em uma janela de processo onde o aumento da temperatura promove maior efusão de Hidrogênio do que a difusão do mesmo [70]. O fator de microestrutura em função dos parâmetros de deposição é mostrado na figura 5.16.
180 200 220 240 260 280 300
0,00 0,05 0,10 0,15 0,20 0,25 0,30 0,35 0,40 0,45 0,50 0,55 0,60 0,65 0,70 0,75 0,80 0,85 0,90
20 % 40 % 60 %
R*
Temperatura (°C)
Figura 5-16 Efeito da temperatura no fator de microestrutura para 20,30 e 40 % de Hidrogênio na câmara.
Percebe-se que seus valores indicam a predominância de ligações SiHn em todos os experimentos onde há a presença de hidrogênio no filme, inferimos que estes filmes estão sendo depositados em uma condição de alto nível de defeitos e nano-poros. Este resultado é uma tendência deste processamento como citado na revisão bibliográfica (item 3.11). Tende, portanto, a apresentar uma banda acentuada no infravermelho centrada em 2080-2090 cm-1, atribuída aos modos de estiramento SiH2, SiH3 ou de SiH localizado em superfícies internas ou micro-vazios [61].
5.3 Influência da composição e da estrutura nas propriedades ópticas
60 fóton para as três composições de atmosferas e os respectivos níveis de hidrogenação do filme.
1,0 1,5 2,0 2,5 3,0
104 105
H2 na câmara | H no Filme 20 % 8,51 % 40 % 14,83 % 60 % 16,35 %
C
oe
fici
en
te
d
e
ab
so
rçم
o
(cm
-1 )
Energia (eV) Nd
Figura 5-17 Coeficiente de absorção em função da energia do fóton das amostras produzidas a 180°C e porcentagens de hidrogênio de 20, 40 e 60 %.
61
8 9 10 11 12 13 14 15 16 17
5,00E+020 6,00E+020 7,00E+020 8,00E+020 9,00E+020 1,00E+021 1,10E+021 1,20E+021
N
s
(cm
-3 )
Hf (%)
180°C
Figura 5-18 Densidade de estados em função da porcentagem de hidrogênio incorporada ao filme (%Hf).
Percebeu-se a redução nos níveis de densidade de estados, mas ao se comparar com experiências semelhantes esperavam-se reduções de até três ordens de grandeza nos valores, tanto da absorção quando da densidade de estados. Este resultado demonstra juntamente com os altos valore de R* que existe um estado inicial com um excessivo número de defeitos ligados a nano poros o que dificulta que o processo de hidrogenação seja realmente efetivo na melhoria das propriedades eletro-ópticas.
62
0,8 1,0 1,2 1,4 1,6 1,8 2,0 2,2 2,4 2,6 2,8 3,0 3,2 3,4 3,6 3,8 4,0 0 200 400 600 800 1000 1200
0,8 1,0 1,2 1,4 1,6 1,8 2,0 2,2 2,4 2,6 2,8 3,0 3,2 3,4 3,6 3,8 4,0 0 100 200 300 400 500 600 700 800 900 1000 1100
0,8 1,0 1,2 1,4 1,6 1,8 2,0 2,2 2,4 2,6 2,8 3,0 3,2 3,4 3,6 3,8 4,0 0 100 200 300 400 500 600 700 800 900 1000 1100 1200
0,8 1,0 1,2 1,4 1,6 1,8 2,0 2,2 2,4 2,6 2,8 3,0 3,2 3,4 3,6 3,8 4,0 0 100 200 300 400 500 600 700 800 900 1000 ( E) 1 /2 Energia (eV) 20 % Rg Linear ( E) 1 /2 Energia (eV) 40 % Rg Linear ( E) 1 /2 Energia (eV) ( E) 1 /2 Energia (eV) 60 % Rg Linear
Figura 5-19 Curvas (αE)1/2x E para filmes produzidos a 180°C com as respectivas
estrapolações da região linear.
![Figura 3-1 Esquema das partes básicas de uma célula mostrando os movimentos das cargas na junção [11]](https://thumb-eu.123doks.com/thumbv2/123dok_br/15708717.630386/19.892.223.672.332.652/figura-esquema-partes-básicas-célula-mostrando-movimentos-junção.webp)
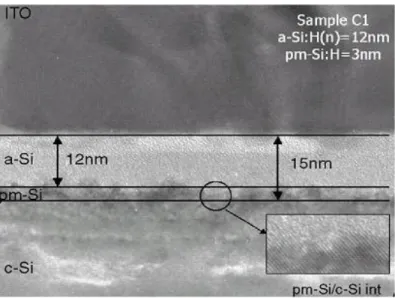
![Figura 3-6 Evolução da eficiência de células com o tempo de exposição à luz utilizando exclusivamente filmes amorfos ou microcristalino [20]](https://thumb-eu.123doks.com/thumbv2/123dok_br/15708717.630386/23.892.197.700.96.504/figura-evolução-eficiência-células-exposição-utilizando-exclusivamente-microcristalino.webp)
![Figura 3-9 Curvas do coeficiente de absorção para a-Si:H, nc-Si:H e c-Si [38] .](https://thumb-eu.123doks.com/thumbv2/123dok_br/15708717.630386/28.892.200.674.473.921/figura-curvas-coeficiente-absorção-para-si-si-si.webp)
![Figura 3-10 Curva típica para cálculo do band gap de Tauc para material amorfo (a), e para filmes com alguma fração cristalina (b) [40]](https://thumb-eu.123doks.com/thumbv2/123dok_br/15708717.630386/30.892.121.781.112.351/figura-curva-típica-cálculo-material-amorfo-fração-cristalina.webp)
![Figura 3-12 Exemplo de espectro de infravermelho para filmes de silício hidrogenado (a) -PACVD) e (b) -HWCVD [42]](https://thumb-eu.123doks.com/thumbv2/123dok_br/15708717.630386/32.892.224.679.111.450/figura-exemplo-espectro-infravermelho-filmes-silício-hidrogenado-pacvd.webp)
![Figura 3-13 Espectros Raman para diferentes quantidades de hidrogênio em um processo PACVD [25]](https://thumb-eu.123doks.com/thumbv2/123dok_br/15708717.630386/34.892.198.672.667.1038/figura-espectros-raman-diferentes-quantidades-hidrogênio-processo-pacvd.webp)
![Figura 3-14 Esquema representativo do modelo de recozimento Químico para crescimento de filmes de Silício [51]](https://thumb-eu.123doks.com/thumbv2/123dok_br/15708717.630386/36.892.142.762.101.486/figura-esquema-representativo-modelo-recozimento-químico-crescimento-silício.webp)